|
|
"ЖУРНАЛ РАДИОЭЛЕКТРОНИКИ" N 4, 2003 |
|
Электрополевой гистерезис в гетеросистеме
n-AlGaAs/GaAs с 2D электронами
В.И. Кадушкин, e-mail: kadush@ttc.ryazan.ru
Рязанский государственный педагогический университет.
Получена 02 апреля 2003 г.
Обнаружено явление электрополевого гистерезиса вольтамперной характеристики (ВАХ) латеральной проводимости одиночного гетероперехода AlxGa1-xAs(Si)/GaAs при фиксированных температурах 4.2 и 77 К. Петля гистерезиса при циклировании вырождается в обратимую ветвь ВАХ существенно различным образом для указанных температур. Эффект гистерезиса восстанавливается при отогревании до комнатной температуры. Качественное объяснение наблюдаемому явлению было дано в предположении несимметричности электрополевой активизации DX – центров границы раздела гетероперехода. Выполнены оценки некоторых параметров DX – центров.
1. Основным элементом полупроводниковых наноструктур является граница раздела составляющих их компонентов. Физические свойства реальных элементов прикладной полупроводниковой наноэлектроники в сильнейшей степени определяются совершенством гетерограницы. Дефекты гетерограницы не только искажают потенциальный рельеф, но и привносят элемент флуктуаций осевых и латеральных кинетических и динамических параметров и характеристик. В качестве таких дефектов следует отметить (на примере соединения AlxGa1-xAs(Si)/GaAs) ионизированные доноры легирующей примеси, акцепторы, как правило, из остаточной атмосферы ростовой камеры, островки роста на гетерогранице, колебания мольной доли тройного соединения. Несовершенства (дефектность) гетерограниц проявляется в экспериментах в виде аномалий известных явлений переноса.
Одна из особенностей полупроводниковых двумерных систем – это эффект памяти на внешние воздействия. Известны явления замороженной (долгоживущей) фотопроводимости [1-3], эффекты бистабильности в системах с квантовыми ямами [4-7] и нелинейности (с гистерезисом) вольтамперных (ВАХ) и вольттемпературных (ВТХ) характеристик проводимости [8-11]. Хотя условия проявления нелинейностей (интервалы температур Т, величины электрических полей Е, интенсивности и спектральный состав излучения) в опытах различаются значительно, но интерпретируются особенности экспериментов с единых позиций. Вся совокупность опытов однозначно свидетельствует, что определяющую роль в эффектах памяти играет возбуждение тем или иным способом DX – центров и пространственно-энергетическая релаксация неравновесных 2D электронов. Косвенным указанием на последнее является восстановление эффектов при термоциклировании образцов до комнатной температуры.
Следует отметить, что различные температурные интервалы и величины электрических полей, в которых имеют место быть аномалии, указывают на сложный спектр DX – центров. Это согласуется с известными представлениями [12-14] о спектре легирующей примеси, например Si, в (AlAs)x(GaAs)1-x. Механизм встраивания заряда, природа ловушек, аккумулирующих пространственный заряд, в [4-7] не обсуждалась, но параметрическая близость эффектов в одиночных квантовых ямах, двойных барьерах и системах множественных квантовых ям с учетом особенностей технологии синтеза гетероструктур [4,7] в сопоставлении с [12,14] необходимо связать наблюдаемое с проявлением DX –центров.
Представляется актуальным исследовать динамику проявления DХ – фактора в явлениях переноса в параметрической связи с
температурой. В настоящей работе сообщаются результаты исследований
гетероструктуры, содержащей одиночный гетеропереход с буферным слоем i-GaAs (0.4 мкм) на GaAs(Cr), спейсером i-AlxGa1-xAs (70 ![]() ), 500
), 500 ![]() легированного Si до NSi
легированного Si до NSi![]() 1018
см-3 тройного соединения (с х=0.30). Структура заканчивается
контактным слоем GaAs(Si)
толщиной 100
1018
см-3 тройного соединения (с х=0.30). Структура заканчивается
контактным слоем GaAs(Si)
толщиной 100 ![]() .
Техника и методика эксперимента подобны описанным ранее в [10].
.
Техника и методика эксперимента подобны описанным ранее в [10].
Рис. 1. Электрополевой гистерезис структуры № 388 при Т=4.2 К (I) и Т=77 К (II): ![]() - прямая ветвь ВАХ,
- прямая ветвь ВАХ, ![]() - циклирование
ВАХ электрическим полем. II – циклирование ВАХ
электрическим полем трансформирует гистерезис на штриховую траекторию.
Гистерезис восстанавливается отогревом образца до комнатной температуры.
- циклирование
ВАХ электрическим полем. II – циклирование ВАХ
электрическим полем трансформирует гистерезис на штриховую траекторию.
Гистерезис восстанавливается отогревом образца до комнатной температуры.
На
рис.1 представлены ВАХ с гистерезисом при Т=4.2 К (I)
и 77 К (II) для образца с поверхностной концентрацией
электронов ns=8.9∙1011 см-2
и подвижностью ![]() =7.2∙104 см2/В∙с
(Т=4.2 К). Опишем характерные признаки эксперимента. Семейство кривых I имеет первый цикл гистерезиса по ветви
=7.2∙104 см2/В∙с
(Т=4.2 К). Опишем характерные признаки эксперимента. Семейство кривых I имеет первый цикл гистерезиса по ветви ![]() . При повторном
прохождении ВАХ гистерезис исчезает и ВАХ воспроизводится по траектории
. При повторном
прохождении ВАХ гистерезис исчезает и ВАХ воспроизводится по траектории ![]() (показано
стрелками
(показано
стрелками ![]() ).
Отогрев образца до 300 К и последующее охлаждение до 4.2 К приводит к полному
восстановлению описанного цикла ВАХ с выходом на кривую
).
Отогрев образца до 300 К и последующее охлаждение до 4.2 К приводит к полному
восстановлению описанного цикла ВАХ с выходом на кривую![]() . ВАХ этой структуры при
77 К (II) имеет также гистерезис, но прямая (
. ВАХ этой структуры при
77 К (II) имеет также гистерезис, но прямая (![]() ) и обратная (
) и обратная (![]() ) ветви при
повторном Е-полевом цикле имеют тенденцию к сближению, и на 4-5 цикле
гистерезис вырождается в линию (она показана штрихами). Ветви 1(
) ветви при
повторном Е-полевом цикле имеют тенденцию к сближению, и на 4-5 цикле
гистерезис вырождается в линию (она показана штрихами). Ветви 1(![]() ) и 2(
) и 2(![]() ) ВАХ (I) нелинейны, но есть существенная деталь: циклы и первый (
) ВАХ (I) нелинейны, но есть существенная деталь: циклы и первый (![]() ), и
последующие (
), и
последующие (![]() ) заканчиваются не по начальной траектории,
то есть в предельно слабом электрическом поле конечное и начальное
сопротивления образца не совпадают. Начальные участки омической проводимости на
семействе ВАХ I (Т=4.2 К) даны штриховыми линиями 10
и 20.
) заканчиваются не по начальной траектории,
то есть в предельно слабом электрическом поле конечное и начальное
сопротивления образца не совпадают. Начальные участки омической проводимости на
семействе ВАХ I (Т=4.2 К) даны штриховыми линиями 10
и 20.
2. Какие механизмы можно привлечь к объяснению наблюдаемых явлений? Прежде всего, это перегрев образца за счет джоулева тепла, переброс горячих электронов за барьер через границу гетероперехода в тройное соединение, непосредственно нагрев 2D электронов и, наконец, термоактивация DX – центров как в тройном соединении, так и в GaAs.
Перегрев образца за счет джоулева тепла контролируется скоростью отвода
последнего на границу раздела кристалл – криоагент. Нагретые электрическим
полем электроны создают поток фононов от гетерограницы к границам образца, до
того, как последние срелаксируют в равновесное состояние, их перенос имеет
баллистический характер. Этому режиму соответствует поток фононов от 2D электронного канала на верхнюю (В) и нижнюю (Н) грани
образца. Время достижения границ ![]() , где LB=670
, где LB=670
![]() и LH=0.5 мм для данного образца, S=5∙105
см5/с – скорость звука. Так что
и LH=0.5 мм для данного образца, S=5∙105
см5/с – скорость звука. Так что ![]() , а
, а ![]() .
.
В
[15] показано, что при гелиевых температурах для объемного арсенида
галлия с концентрацией примесей и параметрами, близкими к нашим, имеет место
диффузионный перенос тепла. В этом предположении оценим, аналогично
[16],
перегрев образца. Мощность в 2D электронном канале PE=I∙U полностью идет на нагрев образца от
температуры Т до ![]() :
:
где ![]() =5.3 г/см2
– плотность GaAs, V=2∙10-2
см3 – объем нижней по отношению к проводящему каналу части образца,
С(Т) – удельная теплоемкость: при гелиевых температурах С(Т)=0.66Т3∙10-3
Дж/(г∙град) [16,17]. Приравнивая РЕ и
=5.3 г/см2
– плотность GaAs, V=2∙10-2
см3 – объем нижней по отношению к проводящему каналу части образца,
С(Т) – удельная теплоемкость: при гелиевых температурах С(Т)=0.66Т3∙10-3
Дж/(г∙град) [16,17]. Приравнивая РЕ и ![]() , получим соотношение
для оценки
, получим соотношение
для оценки ![]() по
ВАХ. С учетом данных рис. 1 имеем
по
ВАХ. С учетом данных рис. 1 имеем ![]() <10-3 K
для Т=4.2 К и
<10-3 K
для Т=4.2 К и ![]() <8 K для Т=77 К.
Таким образом, перегрев образца не существенен:
<8 K для Т=77 К.
Таким образом, перегрев образца не существенен: ![]() <Т. При величинах поля Е,
соответствующих выходу ВАХ на S-образность, разогрев 2D электронов недостаточен, чтобы имело место заметное
туннелирование за барьер (в тройное соединение).
<Т. При величинах поля Е,
соответствующих выходу ВАХ на S-образность, разогрев 2D электронов недостаточен, чтобы имело место заметное
туннелирование за барьер (в тройное соединение).
Известно, что оптическая перезарядка DX-центров
сопровождается увеличением ns и ![]() и
температурным гистерезисом концентрации [11]. В нашем случае мы имеем дело
скорее всего с термоактивацией DX-центров горячими
электронами, разогретыми электрическим полем в двумерном канале до температуры
Те>Т. Можно оценить из уравнения баланса мощности и данных ВАХ
подобно [18] величину электронной температуры: для Т=4.2 К реальная электронная
температура Те несколько больше оценочной (Те
и
температурным гистерезисом концентрации [11]. В нашем случае мы имеем дело
скорее всего с термоактивацией DX-центров горячими
электронами, разогретыми электрическим полем в двумерном канале до температуры
Те>Т. Можно оценить из уравнения баланса мощности и данных ВАХ
подобно [18] величину электронной температуры: для Т=4.2 К реальная электронная
температура Те несколько больше оценочной (Те![]() 12 К для V=0.6 В), так как на энергетическом расстоянии 2 meV над уровнем Ферми располагается второй возбужденный уровень
размерного квантования Е1 (см. ниже рис. 2). При незначительной
концентрации электронов на этом уровне (из-за термического подвозбуждения) следует
ожидать увеличения подвижности, так как они пространственно удалены от
гетерограницы и, соответственно, от рассеивающих центров. Для случая реального
заполнения 2D электронами второй подзоны размерного
квантования интегральная подвижность уменьшается [19]. Следовательно,
термическое подвозбуждение 2D электронов во вторую
подзону размерного квантования приведет к увеличению электронной температуры.
12 К для V=0.6 В), так как на энергетическом расстоянии 2 meV над уровнем Ферми располагается второй возбужденный уровень
размерного квантования Е1 (см. ниже рис. 2). При незначительной
концентрации электронов на этом уровне (из-за термического подвозбуждения) следует
ожидать увеличения подвижности, так как они пространственно удалены от
гетерограницы и, соответственно, от рассеивающих центров. Для случая реального
заполнения 2D электронами второй подзоны размерного
квантования интегральная подвижность уменьшается [19]. Следовательно,
термическое подвозбуждение 2D электронов во вторую
подзону размерного квантования приведет к увеличению электронной температуры.
Исходное зарядовое состояние DX – центров может быть положительно, отрицательно заряженным и нейтральным (DX+,DX- и DX0 соответственно), что достигается обменом электронными состояниями между DX – центрами и 2D каналом при понижении температуры и стабилизации равновесного состояния.
Единственное подходящее для объяснения особенностей ВАХ зарядовое
состояние – положительное (DX+). Ионизация DX – центров возникает при опустошении потенциальных ям с понижением
температуры. В электрическом поле Е из-за разогрева 2D
электронов энергия последних достигает kTe,
и возможна термическая перезарядка DХ – центров (на DX0 и/или DX-).
Эффективная концентрация DX – центров
как рассеивающих центров уменьшается, сопротивление падает и ВАХ(I) с ветви ![]() переходит на ветвь
переходит на ветвь ![]() . Энергетически DX – центры могут располагаться как выше уровня Ферми, так и
ниже, но их состояние метастабильно с достаточно большим временем жизни
[3,9].
Уменьшение поля Е приводит к возвратной траектории ВАХ по
. Энергетически DX – центры могут располагаться как выше уровня Ферми, так и
ниже, но их состояние метастабильно с достаточно большим временем жизни
[3,9].
Уменьшение поля Е приводит к возвратной траектории ВАХ по ![]() . В новом цикле исходное
состояние соответствует меньшей концентрации DX+
– центров, и реализуется ветвь
. В новом цикле исходное
состояние соответствует меньшей концентрации DX+
– центров, и реализуется ветвь ![]() траектория ВАХ (I).
Исходное состояние DХ – центров DX+
может быть восстановлено лишь отогревом образца [2], что и наблюдается на
опыте.
траектория ВАХ (I).
Исходное состояние DХ – центров DX+
может быть восстановлено лишь отогревом образца [2], что и наблюдается на
опыте.
Эта модель объясняет (качественно) и особенности ВАХ(II) при Т=77 К. Отличие от ситуации по отношению к условиям Т = 4.2 К состоит в отсутствии заметной доли DX –центров в метастабильном состоянии, компенсированных захваченными электронами. Электрическое поле, разогревая электроны, изменяет с каждым циклом концентрацию DX+ – центров , и состояние термодинамического равновесия в условиях Т=77 К, характеризующееся определенным соотношением между концентрацией DX+,DX- и DX0 центров, достигается за счет релаксации электронов на оптических фононах.
В принципе не исключено существование DХ – центров с исходным отрицательным зарядом, которые могут возникнуть при захвате электронов при понижении температуры. Электрическое поле Е может лишь увеличить концентрацию DX- центров, что вызовет лишь увеличение сопротивления, что не соответствует опыту.
3. Остановимся на возможной природе DX – центров и их локализации. В сильнолегированном AlGaAs соединении кремний в окружении алюминия образует четыре глубоких уровня [12-14].
Рис. 2. Вид зонной диаграммы ЕС(Z) одиночного гетероперехода (структура № 388). dsp и ddepl – размеры спейсера и области обеднения. Еi=0-3 – уровни энергий DX – центров, Е0, Е1 и ЕF – уровни размерного квантования и энергия Ферми. На вставке – профиль DX – центра (из [12]).
На
рис.2 показана структура зоны проводимости гетероперехода.
Зависимость Ес(z) рассчитана путем решения
уравнений Шредингера и Пуассона с параметрами данной конкретной системы: ns=8.9∙1011 см-2, ![]() =7.2 м2/В∙с,
dsp=70
=7.2 м2/В∙с,
dsp=70 ![]() - ширина спейсера, ЕF-Е0=31 meV, N(Si)=1018 см-3
– уровень легирования, уровень фонового (непреднамеренного) подлегирования NА
- ширина спейсера, ЕF-Е0=31 meV, N(Si)=1018 см-3
– уровень легирования, уровень фонового (непреднамеренного) подлегирования NА![]() 8×1016
см-3, ddepl=89
8×1016
см-3, ddepl=89 ![]() - ширина
области обеднения. Решения, найденные для самосогласованной волновой функции
- ширина
области обеднения. Решения, найденные для самосогласованной волновой функции ![]() : Е0=72
meV, Е1=107 meV –
уровни размерного квантования, отсчитанные от дна зоны проводимости. Расчеты
выполнены для разрыва зон
: Е0=72
meV, Е1=107 meV –
уровни размерного квантования, отсчитанные от дна зоны проводимости. Расчеты
выполнены для разрыва зон ![]() (см. по этому поводу [20,21] ).
Энергетическое положение уровней DX – центров для i=0, 1, 2 и 3 рассчитано согласно [13] и показано на
рис.2 (в
масштабе), предположив, что DX-центры локализованы на
границе раздела i-Al0.3Ga0.7As и Al0.3Ga0.7As(Si), на вставке (слева вверху)
представлена структура DX – центра для случая
расположения его ниже уровня Ферми [14]. Состояние DX – центра с i=0 расположено в
континууме, а состояния с i=1, 2 и 3 локализованы в
барьерном слое.
(см. по этому поводу [20,21] ).
Энергетическое положение уровней DX – центров для i=0, 1, 2 и 3 рассчитано согласно [13] и показано на
рис.2 (в
масштабе), предположив, что DX-центры локализованы на
границе раздела i-Al0.3Ga0.7As и Al0.3Ga0.7As(Si), на вставке (слева вверху)
представлена структура DX – центра для случая
расположения его ниже уровня Ферми [14]. Состояние DX – центра с i=0 расположено в
континууме, а состояния с i=1, 2 и 3 локализованы в
барьерном слое.
Что касается локализации DX – центров, то
необходимо заметить, что известное явление диффузии кремния в спейсер во время
роста структуры приводит к делокализации DX-центров и
их размытию в некоторую полосу ![]() от границы dsp.
Это сопровождается и энергетическим смещением i-уровней
из-за кривизны Ec(z)
и ее смещения относительно EF.
от границы dsp.
Это сопровождается и энергетическим смещением i-уровней
из-за кривизны Ec(z)
и ее смещения относительно EF.
Эксперименты позволяют выполнить некоторые оценки параметров DX=центров. По величине подвижности ![]() =7.4 м2/В∙с,
ns=8.9∙1011 см-2
и ТD=5.1 К найдем поверхностную плотность DX – центров NDX=2∙109
см-2. Их объемную концентрацию оценим по температуре Дингла ТD=5.1 К, концентрации легирующей примеси 1018
см-3 и 2D электронов ns=8.9∙1011
см-2: NDX=1.4∙1016
см-3. Следовательно, DХ – центры локализованы
в области шириной
=7.4 м2/В∙с,
ns=8.9∙1011 см-2
и ТD=5.1 К найдем поверхностную плотность DX – центров NDX=2∙109
см-2. Их объемную концентрацию оценим по температуре Дингла ТD=5.1 К, концентрации легирующей примеси 1018
см-3 и 2D электронов ns=8.9∙1011
см-2: NDX=1.4∙1016
см-3. Следовательно, DХ – центры локализованы
в области шириной ![]() 20
20 ![]() на границе спейсера и области обеднения.
на границе спейсера и области обеднения.
Концентрации DX – центров
существенно ниже уровня легирования, и поэтому перезарядка их электронами из 2D-канала не сопровождается убылью ns.
Об этом свидетельствуют измерения квантовых осцилляций Шубникова – де Гааза как
в сильном электрическом поле, так и при температурах до Т![]() 20 К.
20 К.
Следует заметить, что эффект гистерезиса ВАХ проводимости типа описанных выше наблюдался на большом числе исследованных нами образцов структуры AlGaAs/GaAs. При этом в зависимости от концентрации 2D электронов (различный уровень легирования тройного соединения) эффекты высокотемпературного (77 К) и низкотемпературного гистерезиса проявлялись с большей или меньшей степенью контрастности. И лишь на данном образце эти эффекты гистерезиса одновременно при Т=77 К и 4.2 К оказались столь выразительными. Видимо, изменение концентрации ns 2D электронов в потенциальной яме гетероперехода сопровождается сканированием уровнем Ферми энергетического спектра DX – центров, включая или выключая их активность в явлениях переноса.
Таким образом, наблюдаемые особенности ВАХ структуры при 4.2 и 77 К, а именно гистерезис с вырождением в одну траекторию при циклировании электрического поля и восстановление исходного состояния при отогреве образца до комнатной температуры, несомненно, свидетельствуют о вкладе механизма термоактивации DX – центров горячими электронами.
Работа выполнена при финансовой поддержке Минпромнауки и технологий РФ (Госконтракт № 40.012.1.1.1153 Программы «Исследования и разработки по приоритетным направлениям развития науки и техники», раздел «Фундаментальные исследования в области физических наук») и Минобразования РФ (Программа «Фундаментальные исследования в области естественных и точных наук», гранты № Е00-3.4-75 и № Е02-3.4-319).
Литература.
-
X.L. Lei, N.J.M. Horing. Int. J. Mod. Phys. B, 6, 805 (1992).
-
G. Brunthaler, M. Seto, G. Stoger, K. Kohler. Appl. Phys. Lett.,65(No24), 3084(1994).
-
I. Rudnev, V.F. Elesin, V. Kadushkin, E. Shangina. Czechoslovak Journal of Physics, 46(S5), 1511(1996).
-
С.А. Стоклицкий, В.Н. Мурзин, Ю.А. Митягин, В.И. Кадушкин, Ю.А. Ефимов, Г.К. Расулова. Тезисы докладов Int. Conf. “Microelectr.-94”, Swenigorod, Moskow, 1994, part I, p. 187; Краткие сообщения по физике ФИАН, 9/10, 10(1994).
-
J. Goldman, D.C. Tsui, J.E. Cunningham. Phys. Lett., 58(12), 1256(1987).
-
E.S. Alves et al. Electr. Lett., 24, 1190(1988): Semicond. Sci. Technol., 3 1060(1988).
-
G.K. Rasulova, M.V. Yakimov, V.I. Kadushkin. Superllat. and Microstruct., 24(5), 313(1998).
-
M. Keever, H. Morkoc, B.G. Shichigo. Appl. Phys. Lett., 35, 469(1979).
-
В.А. Кульбачинский, Р.А. Лунин, Е.В. Богданов, В.Г. Кытин, А.П. Сеничкин, В.И. Кадушкин. Письма в ЖЭТФ, 63(5), 326(1996).
-
В.И. Кадушкин, А.А. Денисов, А.П. Сеничкин. ФТП, 23, 1199(1989).
-
P. Jeanjean, J. Sicart, JL. Robert, F. Mollot, R. Planel. Supperlatt. and Microstruct., 8(3), 345(1990).
-
Z. Willamowski, T. Suski, W.J. Jantson. Acta Physica Polonica, 82, 561(1992).
-
Z. Willamowski, J. Kossut, W. Jantch, G. Ostermayer. Semicond. Sci. Technol., 6, B. 38(1991).
-
J.R. Kirtley, T.N. Theis, P.M. Mooney, S.L. Wrught. J. Appl. Phys., 63, 1541(1988).
-
A. Dragys, J. Kundrotas. Handbook on Physical Properties of Ge, Si, GaAs and InP, Vilnius, Science and Encyclopedia Publishers, 1994, 264.
-
Ж.И. Алферов, С.В. Иванов, П.С. Копьев и др. ФТП, 19, 1199(1985).
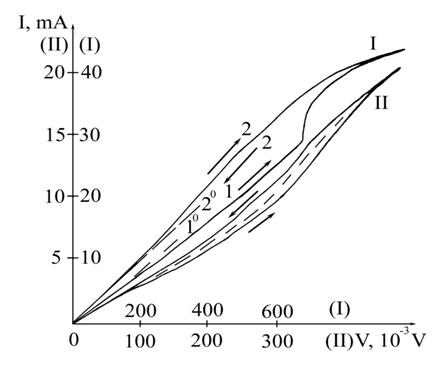
 ,
(1)
,
(1)