Дисперсия диэлектрических коэффициентов и
ac-проводимости монокристаллов TlGa1–хСохS2 в радиочастотном диапазоне
С.
Н. Мустафаева
Институт физики Национальной академии наук Азербайджана, Баку
Получена 27 марта 2009 г.
В слоистых
монокристаллах TlGa1–хСохS2 (х = 0.005; 0.01) изучены частотные зависимости
диэлектрических характеристик и ac-проводимости
(sac)
поперек слоев в частотном диапазоне f = 5×104¸3.4×107 Гц. Установлено, что в TlGa1–хСохS2
наряду с потерями на электропроводность имеют место также релаксационные
потери. Обнаружено, что в частотной области 5×104¸2.107
Гц в монокристаллах TlGa1–хСохS2 имеет место прыжковый механизм переноса заряда
по локализованным вблизи уровня Ферми состояниям. Оценены плотность (NF) и энергетический разброс (ΔE) этих состояний, среднее время (τ) и расстояние (R) прыжков. Изучено влияние состава кристаллов TlGa1–хСохS2
на их диэлектрические коэффициенты. Установлено, что с ростом содержания
кобальта в кристаллах NF и ΔE возрастают, а τ и R уменьшаются.
Ключевые слова: электродинамика конденсированных сред, слоистые монокристаллы.
ВВЕДЕНИЕ
Слоистые монокристаллы TlGaS2 характеризуются довольно высокой плотностью локализованных вблизи уровня Ферми состояний (NF). Значения NF, вычисленные на основе экспериментальных результатов измерения dc и ac-проводимости монокристаллов TlGaS2, составляли ~ 2.0×1018эВ–1см–3 [1,2]. Легирование этих монокристаллов позволяет управлять их физическими свойствами. Так, например, в [3] было показано, что частичное замещение галлия в TlGaS2 марганцем приводит к значительному уменьшению диэлектрической проницаемости, среднего времени и расстояния прыжков, а также увеличению плотности состояний на уровне Ферми.
Целью настоящей работы явилось изучение влияния частичного замещения галлия кобальтом в TlGaS2 на диэлектрические свойства полученных кристаллов.
ЭКСПЕРИМЕНТАЛЬНАЯ
ЧАСТЬ
Характер взаимодействия в системе TlGaS2 – TlCoS2 был изучен [4] методами физико-химического анализа. Исходные соединения TlGaS2 и TlCoS2 были синтезированы в вакууме (10–3 Па) в кварцевых ампулах прямым сплавлением высокочистых (≥ 99.999%) элементов (Tl, Ga, S, Co), взятых в стехиометрическом соотношении. Синтезированные образцы для гомогенизации были подвергнуты отжигу в вакууме при температуре 440 К в течение 20 суток. Установлено, что при комнатной температуре на основе TlGaS2 образуются твердые растворы TlGa1–хСохS2 вплоть до 15 мол.% TlCoS2. Методом Бриджмена были выращены образцы монокристаллов TlGa1–хСохS2 (х = 0.005 и 0.01). Указанные составы кристаллизовались в тетрагональной сингонии с параметрами кристаллической решетки а = 7.29; с = 29.90 Å.
Измерения диэлектрических свойств монокристаллов TlGa1–хСохS2 (х = 0.005 и 0.01) на переменном токе произведены резонансным методом с помощью куметра TESLA BM560. Диапазон частот переменного электрического поля составлял 5×104 ¸ 3.4×107 Гц.
Монокристаллические образцы из TlGa1–хСохS2 для электрических измерений были изготовлены в виде плоских конденсаторов, плоскость которых была перпендикулярна кристаллографической C-оси кристалла. В качестве электродного материала использована серебряная паста. Толщина образцов из TlGa1–хСохS2 составляла 100 – 140 мкм, а площадь обкладок –7.6·10–2 cм2. Все диэлектрические измерения монокристаллических образцов были проведены при 300 К. Воспроизводимость положения резонанса составляла по емкости ± 0.2 пкФ, а по добротности (Q = 1/tgd) ± 1.0 ¸1.5 деления шкалы. При этом наибольшие отклонения от средних значений составляли 3 – 4% для ε и 7% для tgd.
РЕЗУЛЬТАТЫ
И ИХ ОБСУЖДЕНИЕ
На рис. 1 приведены результаты измерения тангенса угла диэлектрических потерь tgd при частотах 5×104 ¸ 3.4×107 Гц в монокристаллах TlGa1–хСохS2 (х = 0; 0.005 и 0.01).
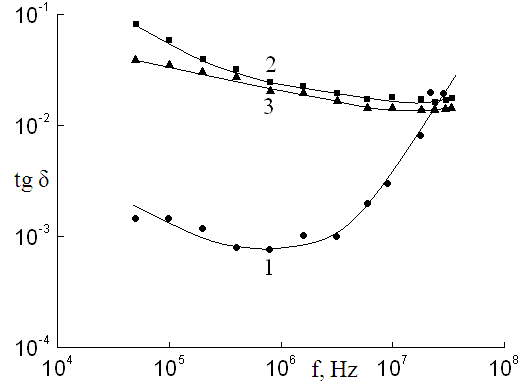
Рис. 1. Частотные зависимости тангенса угла диэлектрических потерь для монокристаллов TlGaS2 (1); TlGa0.995Со0.005S2 (2) и TlGa0.99Со0.01S2 (3) при Т = 300 К.
Из рис. 1 видно, что все приведенные частотные зависимости tgd имеют монотонно спадающую ветвь. Уменьшение tgd с частотой по гиперболическому закону свидетельствует о том, что при этих частотах основным видом диэлектрических потерь в монокристаллах TlGa1–хСохS2 являются потери на электропроводность. В кристалле TlGaS2 при f >106 Гц наблюдалось существенное возрастание tgd с увеличением частоты вплоть до 3·107 Гц. Наличие возрастающей ветви на зависимости tgd (f) позволяет сделать вывод о том, что наряду с потерями на электропроводность вносят свой вклад и релаксационные потери. В отличие от монокристалла TlGaS2 в образцах TlGa1–хСохS2 (х = 0.005; 0.01) после спада tgd наблюдалось незначительное его возрастание при f > 2·107 Гц. Как видно из рис. 1 частота, при которой начинают проявляться релаксационные потери, смещается в сторону более высоких частот при частичном замещении галлия в TlGaS2 кобальтом.
В области частот 5×104 ¸ 3.4×107 Гц измерена также электрическая емкость образцов TlGa1–хСохS2. По значениям емкости (С) образцов при различных частотах рассчитаны значения диэлектрической проницаемости (e = C·L/ε0S; L – толщина кристалла; S – площадь обкладок конденсатора; ε0 – диэлектрическая постоянная). На рис. 2 представлены частотные зависимости e для образцов TlGa1–хСохS2 различного состава (кривые 1 – 3). Видно, что при введении кобальта в кристаллы TlGaS2 диэлектрическая проницаемость значительно уменьшается при всех указанных частотах. Из рис. 2 видно, что в образцах TlGaS2 и TlGa0.995Со0.005S2 не наблюдается ощутимое изменение e с изменением частоты. А в образце TlGa0.99Со0.01S2 диэлектрическая проницаемость монотонно уменьшалась с ростом частоты, что свидетельствует о релаксационной дисперсии.
На рис. 3 приведены дисперсионные кривые коэффициента диэлектрических потерь (e″ = e·tgd) в монокристаллах TlGa1–хСохS2 различного состава. Видно, что при введении кобальта в кристаллы TlGaS2 характер дисперсионных кривых e″(f) существенно изменяется. Если для TlGaS2 кривая e″(f) имеет две ветви: слабо спадающую и резко возрастающую при f >106 Гц, то в случае TlGa1–хСохS2 кривые e″(f) характеризуются довольно ощутимым спадом вплоть до 2·107 Гц, после чего значения e″ проявляют тенденцию к увеличению.
Рис. 2. Частотная дисперсия диэлектрической проницаемости для монокристаллов TlGaS2 (1); TlGa0.995Со0.005S2 (2) и TlGa0.99Со0.01S2 (3).
Нами изучены также частотные зависимости ac-проводимости монокристаллов TlGa1–хСохS2 при Т = 300 К (рис. 4). В области частот f = 5×104¸106 Гц ac-проводимость монокристалла TlGaS2 (кривая 1) изменялась по закону sac~ f 0.8, а при f = 106 ¸ 3×107 Гц – по квадратичному закону sac~ f 2. В [5] показано, что проводимость, пропорциональная f 2, обусловлена оптическими переходами в полупроводниках и вносит преобладающий вклад при высоких частотах. Дисперсионные кривые sac(f) образцов TlGa1–хСохS2 (рис. 4, кривые 2 и 3) характеризуются зависимостью sac~ f 0.8 в более широкой области частот Δf: при х = 0.005 Δf = (5·104 ¸107) Гц, а при х = 0.01 значение Δf = (5·104 ¸2·107) Гц, т.е. увеличение содержания кобальта в кристаллах приводит к удлинению участка f 0.8. При дальнейшем увеличении частоты зависимость sac от f становилась суперлинейной.
Рис. 3. Дисперсионные кривые коэффициента диэлектрических потерь в монокристаллах TlGaS2 (1); TlGa0.995Со0.005S2 (2) и TlGa0.99Со0.01S2 (3).
Наблюдение участка sac~ f 0.8 на кривых sac(f) свидетельствует о том, что в указанном диапазоне
частот проводимость монокристаллов TlGa1–хСохS2 обусловлена прыжками носителей заряда между локализованными
вблизи уровня Ферми состояниями. В [6] для такого механизма переноса заряда было
получено следующее выражение:
sac(f) = (p3 / 96)× е2
к Т N2F a5
f [ln (nph / f)]4, (1)
где е –
заряд электрона, к – постоянная Больцмана, NF – плотность локализованных состояний вблизи уровня Ферми, а
= 1/a – радиус локализации, a – постоянная спада волновой функции
локализованного носителя заряда Y~е–ar, nph – фононная частота.
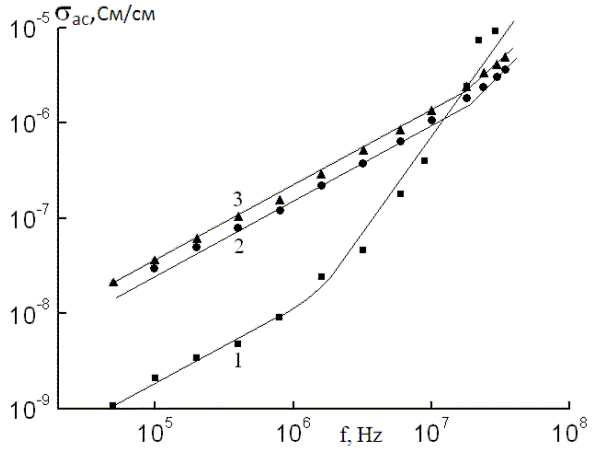
Рис. 4. Частотные зависимости ас-проводимости монокристаллов TlGaS2 (1); TlGa0.995Со0.005S2 (2) и TlGa0.99Со0.01S2 (3).
По экспериментально найденным значениям sac(f) и с помощью формулы (1) вычислили плотность состояний на уровне Ферми. Для монокристаллических образцов TlGa1–хСохS2 (х = 0.005; 0.01) значения NF составляли соответственно 7.9×1018 и 9.1×1018 эВ–1×cм–3. Для образца TlGaS2 NF = 2.1×1018 эВ–1×cм–3 [2]. При вычислении NF для радиуса локализации образцов TlGa1–хСохS2 брали значение а = 14 Å по аналогии с моносульфидом галлия [7], являющимся бинарным аналогом TlGaS2. Значение nph для TlGaS2 – порядка 1012 Гц [8].
Теория прыжковой проводимости на переменном токе позволяет по формуле [5]:
определить среднее расстояние прыжков. В формуле (2) 1/f = τ – среднее время прыжков. Значение τ–1 находится как средняя частота, при которой для sac наблюдается f 0.8 – закон. В монокристаллах TlGa1–хСохS2 значения τ составляли 0.2 мкс для х = 0.005 и 0.1 мкс для х = 0.01. Среднее время прыжков в монокристаллических образцах TlGa1–хСохS2 было значительно меньше, чем в TlGaS2 (в TlGaS2 τ = 2.0 мкс [2]). Вычисленные по формуле (2) значения R для монокристаллов TlGa1–хСохS2 с составами х = 0.005 и 0.01 составили 86 и 81Å, соответственно. Для монокристалла TlGaS2 R = 103Å [2]. Значения R примерно в 6 раз превышают среднее расстояние между центрами локализации носителей заряда в изученных монокристаллах (в TlGaS2 R/a = 7.3 [2]).
По формуле [5]:
оценили энергетический разброс локализованных в окрестности уровня Ферми состояний. Значения ΔЕ, полученные для TlGa1–хСохS2, составили 9×10–2 эВ при х = 0.005 и 9.7×10–2 эВ при х = 0.01. Концентрация глубоких ловушек, ответственных за ac-проводимость, определенная по формуле: Nt = NF×ΔЕ, составляла 7.1×1017 cм–3 в TlGa0.995Со0.005S2 и 8.8×1017 cм–3 в TlGa0.99Со0.01S2.
На рис. 5 представлены для сравнения зависимости NF, τ и R от состава монокристаллов TlGa1–хСохS2. Из этих зависимостей видно, что с ростом содержания кобальта в кристаллах плотность состояний, локализованных вблизи уровня Ферми, возрастает, а среднее время и расстояние прыжков уменьшаются.
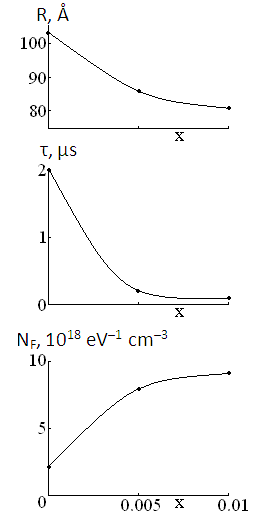
Рис. 5. Зависимость параметров NF, τ и R от состава монокристаллов TlGa1–хСохS2.
ЗАКЛЮЧЕНИЕ
Таким образом, изучена частотная дисперсия диэлектрических свойств монокристаллов TlGa1–хСохS2 различного состава. Установлена природа диэлектрических потерь, механизм переноса заряда и оценены: плотность состояний вблизи уровня Ферми, их энергетический разброс, среднее время и расстояние прыжков, а также концентрация глубоких ловушек, ответственных за ac-проводимость. Обнаружено, что частичное замещение галлия кобальтом в монокристаллах TlGaS2 позволяет управлять диэлектрическими характеристиками полученных кристаллов.
СПИСОК ЛИТЕРАТУРЫ
1. Мустафаева С.Н., Алиев В.А., Асадов М.М. Прыжковая проводимость на постоянном токе в монокристаллах TlGaS2 и TlInS2 // ФТТ. 1998. Т. 40. № 4. С. 612 – 615.
2. Мустафаева С.Н. Частотная дисперсия диэлектрических коэффициентов слоистых монокристаллов TlGaS2 // ФТТ. 2004. Т. 46. № 6. C. 979 – 981.
3. Мустафаева С.Н. Диэлектрические свойства монокристаллов TlGa1–xMnxS2 (0 £ x < 0.03) // Изв. РАН. Неорганические материалы. 2006. Т. 42. № 5. С. 530 – 533.
4. Mustafaeva S.N., KerimovaE.M., Seidov F.M., Jabbarly A.I. Novel Thermoelectric Materials on the Base of TlGaS2 – TlCoS2 // Book of Abstracts of 13-th International Conference on Ternary and Multinary Compounds (ICTMC 13). Paris. France. October 14 – 18. 2002. P. 125.
5. Мотт Н., Девис Э. Электронные процессы в некристаллических веществах. М.: Мир. 1974. 472 с.
6. Pollak M. Frequency dependence of conductivity in amorphous solids // Philos. Mag. 1971. V. 23. P. 519 – 542.
7. Augelli V., Manfredotti C., Murri R. et al. Anomalous impurity conductivity in n-GaSe and n-GaS // L. Nuovo Cimento. B. 1977. V. 38. No 2. P. 327 – 336.
8. Аллахвердиев К.Р., Виноградов Е.А., Нани Р.Х. и др. Колебательный спектр кристаллов TlGaS2, TlGaSe2 и β-TlInS2 // Физические свойства сложных полупроводников. Баку: Элм. 1982. С. 55 – 63.