УДК 621.38-022.532
ИСПОЛЬЗОВАНИЕ ПОЛИЭФИРСУЛЬФОНА (PES) ДЛЯ ЭЛЕКТРОННО-ЛУЧЕВОЙ ЛИТОГРАФИИ
А. С. Ильин, А. А. Кузьмин, А. Г. Коваленко
Институт Радиотехники и Электроники им. В.А.Котельникова РАН
Получена 10 августа 2011 г.
Аннотация: Исследована возможность применения нового технологического процесса изготовления микроструктур методом электронно-лучевой литографии с использованием негативного резиста, основанного на промышленном полимере полиэфирсульфоне (PES). PES является термостабильным и относительно инертным полимером, что позволяет использовать его при магнетронном распылении тугоплавких металлов, в частности титана, молибдена или ниобия, не опасаясь загрязнения образцов вследствие дегазации резиста при высокой температуре. Это свойство данного материала позволяет успешно использовать его в области сверхпроводниковой микроэлектроники, когда чистота сверхпроводника является одной из приоритетных задач технологических процессов.
Ключевые слова: электронно-лучевая литография, полиэфирсульфон, PES, термостабильный резист, технология микронных, субмикронных и нанометровых сверхпроводниковых структур.
Abstract: The possibility of a new technological process of manufacturing of microstructures by electron-beam lithography with negative resist based on an industrial polymer poly(ether sulfone) (PES) is investigated. PES is thermostable and relatively inert polymer, which makes it suitable for magnetron sputtering of refractory metals, such as titanium, molybdenum or niobium without fear of contamination of samples by degassing of resist at high temperatures. This property of the material can be successfully used in the field of superconducting microelectronics, where the purity of a superconductor is one of the priorities of processes.
Keywords: electron-beam lithography, poly(ether sulfone), PES, thermostable resist, technology of micron, submicron and nanometer-scale superconducting structures.
Введение
Одним из определяющих этапов при производстве практически любых микро- и наноприборов является литография. Основной ее задачей является создание на подложке рисунка заданной геометрии, который отличается по химическим свойствам от материала подложки. Для создания такого рисунка применяются методики с использованием полимерных материалов – резистов, которые изменяют свои свойства при воздействии на них – светом (оптическая литография) или электронным лучом (электронно-лучевая литография).
На данный момент наиболее широко в электронно-лучевой литографии применяется резист на основе полиметилметакрилата (PMMA), или двухслойные системы PMMA/MMA, где MMA – мономер метакриловой кислоты. Использование этих резистов позволяет создавать на подложке структуры высокой степени сложности с хорошим разрешением [1][2].
Однако применение масок из резиста на основе PMMA при магнетронном распылении сверхпроводников, таких как титан, молибден или ниобий, которые являются тугоплавкими, приводит к загрязнению металла из-за возникающей дегазации резиста, что ухудшает электронные свойства металла. А сверхпроводящие свойства ниобия или титана чрезвычайно чувствительны к небольшому количеству кислородного загрязнения [3]. Для создания высокочувствительных сверхпроводниковых приборов, в частности, матриц сенсоров на краю сверхпроводникового перехода для радиоастрономии, чистота материалов крайне важна [4].
Нами был исследована возможность применения нового процесса, основанного на термостабильном полимере полиэфирсульфоне (PES), который значительно улучшает качество литографии.
Свойства полиэфирсульфона
В исследовании использовался полиэфирсульфон (PES) марки Ultrason от BASF, который в настоящее время используется в качестве термостойкого органического материала для промышленного использования при температуре 180°C. Химическая формула PES – последовательность ароматических групп, соединенных атомом серы – этим обеспечивается высокая термическая стабильность данного материала.
Также этот полимер показывает хорошую совместимость с органическими растворителями, используемыми в последующих шагах многослойного процесса литографии. Он инертен по отношению к растворителям PMMA – хлорбензену или метилизобутилкетону (MIBK), и является нерастворимым в изопропиловом спирте. Самые подходящие для него растворители – диметилацетамид (DMAc), диметилсульфоксид (DMSO) и N-метилпирролидон (NMP). Последний намного менее опасен и летуч, чем хлорбензен, который является стандартным растворителем PMMA, или же диметилацетамид, однако, растворенный в NMP PES показывает меньшую адгезию к кремнию, нежели растворенный в DMAc.
Также полимер PES показывает хорошую стойкость при промывании в плавиковой кислоте (HF). Это позволяет производить подготовку поверхности подложки из кремния через маску перед напылением металла. Промывание в HF используется, чтобы удалить естественную окись кремния. Это уменьшает количество углеводородных загрязнителей и химически пассивирует поверхность кремния. Главным результатом является хорошая адгезия тонких литографических структур после заключительного этапа литографии. Кроме того, возможно использовать HF для химического травления металлов (например, титана) через маску из полиэфирсульфона.
Технология изготовления
Для исследования толщин пленок были изготовлены растворы полиэфирсульфона в диметилацетамиде (DMAc) с массовыми долями 14%, 30% и 40%. Подложки из кремния с нанесенным резистом были подвергнуты раскрутке на центрифуге при скоростях 2000-6000 об./мин. с шагом в 1000 об./мин. Таким образом были получены 3 серии по 5 образцов в каждой. Образцы были засушены на хот-плэйте при температуре 160 °C в течение 5 мин. После этого были произведены измерения толщин полученных пленок с использованием профилометра KLA-Tencor Alfa-Step IQ.
Для лучшей адгезии резиста к кремнию, непосредственно перед раскруткой подложка прогревалась в течение 20-30 секунд на хот-плэйте при температуре 160°C.
Необходимо подчеркнуть значительное влияние паров воды на раствор полиэфирсульфона. Контроль окружающей влажности крайне важен как при приготовлении раствора PES, так и при его раскрутке в центрифуге. При уровне влажности в чистой комнате более ~30% после раскрутки пленка резиста имеет неоднородную фазовую структуру. При хранении же раствора полиэфирсульфона без специальных мер предосторожности в нем растворяется вода из воздуха, и, спустя некоторое время, резист становится непригодным к использованию. Таким образом, раствор PES должен быть использован в течение не более 2-х месяцев с момента изготовления, если относительная влажность в помещении превышает 30%..
В качестве мер предосторожности при получении раствора полиэфирсульфона применялись такие приемы, как прогрев гранул PES в вентилируемой печи при 80 °C в течение 10 минут, растворение PES в DMAc в этой же печи при температуре 70 °C в течение 25 минут. Перед раскруткой центрифуга накрывалась специальным герметичным колпаком с рукавами для доступа внутрь него, в который в замкнутом цикле прогонялся воздух через емкость с гранулированным силикагелем, предварительно активированным при 160 °C. Относительная влажность в камере центрифуги, согласно показаниям термогигрометра, составляла 40-60% до внесения в рабочую зону силикагеля и 26% непосредственно перед раскруткой резиста.
Для анализа чувствительности резиста к электронному облучению была исследована серия образцов, представляющих собой островки из резиста размерами 40x40 мкм, полученных при разном токе на единицу площади – от 200 мкКл/см2 до 800 мкКл/см2. Измерения толщин полученных островков также были произведены при помощи вышеупомянутого профилометра.
Результаты
Чувствительность резиста к электронному облучению: согласно полученным результатам, наиболее полное экспонирование пленки резиста при толщине 1,1 мкм происходит при дозе облучения 800 мкКл/см2. Параметры коррекции дозы для резиста из полиэфирсульфона совпадают с параметрами для резиста из полиметилметакрилата.
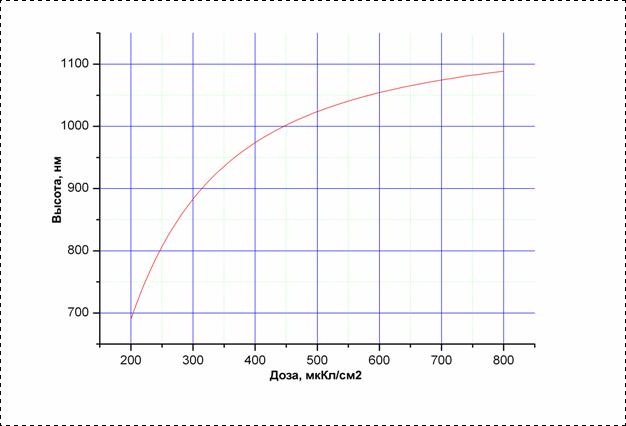
Рис.1. Чувствительность резиста к облучению электронами.
Зависимость толщин пленок от концентрации PES и скорости раскрутки: в зависимости от концентрации раствора полученные образцы пленок имеют толщины порядка 10 мкм (массовая доля PES 40%), 1 мкм (массовая доля PES 30%) и сотен нанометров (массовая доля PES 14%).
Внутри серий одинаковой концентрации зависимость толщины пленки от угловой скорости раскрутки имеет вид Aω-0,5, где ω – угловая скорость, A – коэффициент пропорциональности, за исключением серии с массовой долей PES 40%, зависимость для которой имеет вид Aω-0,7, что может быть объяснено значительной вязкостью данного раствора.

Рис.2. Зависимость толщины пленки PES от скорости раскрутки при концентрации раствора 14%.
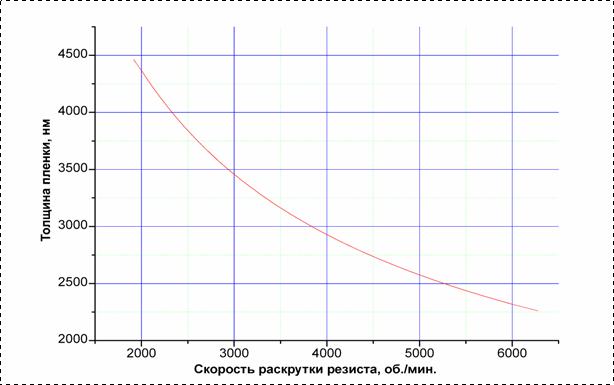
Рис.3. Зависимость толщины пленки PES от скорости раскрутки при концентрации раствора 30%.

Рис.4. Зависимость толщины пленки PES от скорости раскрутки при концентрации раствора 40%.
Заключение
Таким образом, собраны необходимые сведения для разработки процесса взрывной литографии, позволяющего получать образцы малых (порядка сотен нанометров) размеров для сверхпроводниковой электроники, используя такие тугоплавкие металлы, как титан, молибден, ниобий и другие, с высокой степенью чистоты. Это крайне важно для создания высокочувствительных сверхпроводниковых приборов, в частности, матриц сенсоров на краю сверхпроводникового перехода для радиоастрономии. Кроме того, возможно использование резиста на основе полиэфирсульфона для химического травления некоторых металлов, а также оксида кремния, в плавиковой кислоте.
Литература