УДК 621.382.2
МОДЕЛИРОВАНИЕ ВОЛЬТ-АМПЕРНЫХ ХАРАКТЕРИСТИК ДИОДА ШОТТКИ НА ОСНОВЕ КАРБИДА КРЕМНИЯ Ti/4H-SiC
П. В. Панченко, А. А. Малаханов, С. Б. Рыбалка, А. В. Радьков
Брянский государственный технический университет
Статья поступила в редакцию 20 июля 2016 г.
Аннотация. Проведено моделирование вольт-амперных характеристик диода Шоттки на карбиде кремния 4H-SiC c контактом Шоттки из титана (Ti), с использованием программы TCAD. Полученные вольт-амперные характеристики проанализированы и сравнены с теоретическими и экспериментальными данными. Установлено, что рассчитанные параметры диода Шоттки (прямой ток, коэффициент идеальности, высота барьера Шоттки, пробивное напряжение) предсказываются предложенной моделью с хорошим приближением.
Ключевые слова: диод Шоттки, карбид кремния, моделирование, теория термоэлектронная эмиссия.
Abstract. The simulation of 4H-SiC Schottky diode with Ti Schottky contact has been carried out with used of TCAD program. Obtained current-voltage characteristics has been analyzed and compared with theoretical and experimental results. It is established that the Schottky diode parameters (forward current, ideality coefficient, Schottky barrier height, breakdown voltage) predicts proposed with good approximation.
Key words: Schottky diode, silicon carbide, simulation, thermionic theory.
1. Введение
Карбид кремния активно используется для создания мощных полупроводниковых приборов в силовой электронике [1]. Этот широкозонный материал обладает значительными преимуществами относительно кремния, такими, как большая напряженность электрического поля пробоя, теплопроводность, устойчивость работы приборов в жестких условиях эксплуатации.
Несмотря на бурный рост производства полупроводниковых приборов на карбиде кремния, этот материал по-прежнему имеет относительно высокую стоимость, что влечет за собой ограничения на возможности экспериментального исследования новых приборов. Поэтому на этапе проектирования удобно и выгодно использовать инструменты математического моделирования полупроводниковых структур.
Математическое моделирование позволяет предсказывать и анализировать характеристики новых приборов еще до их производства, тем самым значительно сокращая затраты на их разработку. Более того, оно предоставляет возможность визуализировать многие физические явления и процессы в объеме полупроводника, измерение и оценка которых составляет определенные трудности при работе с реальным кристаллом.
К примеру, системы 2D и 3D моделирования позволяют на схематичном изображении отобразить распределение токов и эквипотенциальных линий электрического поля в структуре исследуемого прибора, что фактически невозможно осуществить на уже изготовленном кристалле. Таким образом, это может существенно ускорить процессы оптимизации полупроводниковых приборов, но имеются определенные нюансы.
Если требуется моделирование принципиально новых структур или структур с использованием новых материалов, то необходимо согласовывать модель с имеющимися экспериментальными данными и теориями. Все это делается для того, чтобы проверить адекватность получаемых результатов и, при несоответствии, подобрать оптимальные параметры математической модели. Проводится своего рода «калибровка» модели, чтобы в дальнейшем ее можно было использовать для оценки всей линейки подобных структур.
Целью настоящего исследования является получение вольтамперных характеристик модели диода Шоттки (ДШ) на карбиде кремния (4H-SiC) в программе TCAD, сравнение этих данных с результатами, описываемыми классической диодной теорией (теорией термоэлектронной эмиссии), а также с экспериментальными данными, полученными, например, при исследованиях на подобных структурах [2, 3] диодов Шоттки.
2. Описание параметров моделирования
В качестве исходных данных для моделирования в программе TCAD используются параметры геометрии и материалов диода Шоттки. Геометрические параметры структуры представлены на рис. 1, размеры указаны в микрометрах. Концентрация доноров (азот) в эпитаксиальном слое (4H-SiC) 8×1015, в подложке 1018. Материал анода – Ti (титан).
Моделирование проводилось в цилиндрических координатах, где начальная координата служит осью симметрии вращения. В итоге, проведено 1D моделирование «цилиндрического» ДШ с диаметром анода 400 мкм.

Рис. 1. Геометрические параметры структуры.
Для расчета прямой ветви вольтамперной характеристики (ВАХ) в программе TCAD решалось уравнение Пуассона в цилиндрических координатах (1) и уравнения непрерывности для электронов (2) и дырок (3):
 , (1)
, (1)
 , (2)
, (2)
 , (3)
, (3)
где ![]() – относительная
диэлектрическая проницаемость полупроводникового материала,
– относительная
диэлектрическая проницаемость полупроводникового материала, ![]() – потенциал электростатического поля,
– потенциал электростатического поля, ![]() – концентрация электронов,
– концентрация электронов, ![]() – концентрация дырок,
– концентрация дырок, ![]() – концентрация донорной примеси,
– концентрация донорной примеси, ![]() и
и ![]() –
плотность потока носителей n и p-типа,
–
плотность потока носителей n и p-типа, ![]() и
и ![]() – генерационная и рекомбинационная
составляющая тока соответственно. Для расчета в TCAD
температуры структуры составляли 300 K,
400 K, 500 K
и 600 K.
– генерационная и рекомбинационная
составляющая тока соответственно. Для расчета в TCAD
температуры структуры составляли 300 K,
400 K, 500 K
и 600 K.
При моделировании в TCAD была учтена зависимость подвижности носителей заряда от концентрации и напряженности электрического поля (рекомбинационная модель Шокли-Рида-Холла, а также модель Оже рекомбинации). Потенциал на катоде задавался равным нулю. Потенциал на аноде изменялся от 0 до 1 В. При расчете обратной ветви ВАХ использовались уравнения и модели аналогичные тем, что были описаны при вычислении прямой ветви. Единственное отличие заключалось в том, что в расчетах TCAD учитывалась генерация носителей заряда за счет ударной ионизации. Потенциал на аноде задавался равным нулю. Потенциал на катоде изменялся от 0 до 2100 В.
3. Анализ и обсуждение результатов
3.1. Прямые вольт-амперные характеристики
Результаты расчета в программе TCAD прямых участков вольт-амперных характеристик диода Шоттки Ti/4H-SiC при разных температурах представлены на рис.2. Помимо этого, результаты моделирования в TCAD сравнивались с данными, рассчитанными согласно теории термоэлектронной эмиссии.
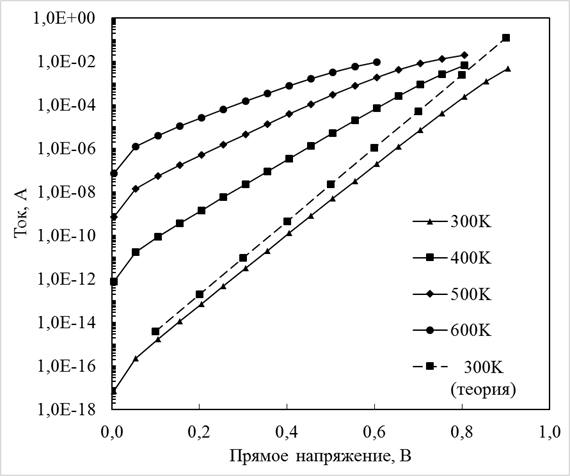
Рис. 2 Прямые ВАХ Ti/4H-SiC диода Шоттки.
В соответствии с
теорией термоэлектронной эмиссии для диода Шоттки, зависимость тока ![]() от напряжения
от напряжения ![]() может
быть записана [4]:
может
быть записана [4]:
 , (4)
, (4)
где ![]() – элементарный
заряд,
– элементарный
заряд, ![]() - постоянная Ричардсона,
- постоянная Ричардсона, ![]() – площадь контакта Шоттки,
– площадь контакта Шоттки, ![]() – высота барьера (в классической теории
она считается неизменной),
– высота барьера (в классической теории
она считается неизменной), ![]() – приложенное
напряжение (положительное для прямого и отрицательное для обратного),
– приложенное
напряжение (положительное для прямого и отрицательное для обратного), ![]() – абсолютная температура,
– абсолютная температура, ![]() – постоянная Больцмана. Прямую ВАХ
– постоянная Больцмана. Прямую ВАХ ![]() можно описать эмпирической формулой
можно описать эмпирической формулой
 , (5)
, (5)
в которой фигурируют следующие
эмпирические величины: ток «насыщения» ![]() и
коэффициент идеальности
и
коэффициент идеальности ![]() диода.
диода.
На рис. 2 также представлена
расчетная ВАХ, полученная на основе теории термоэлектронной эмиссии из
уравнения (4) при температуре ![]() =300 K,
где значение высоты барьера
=300 K,
где значение высоты барьера ![]() =1,2 эВ выбиралось
стандартным для контакта Шоттки (КШ) с анодом из титана [5].
=1,2 эВ выбиралось
стандартным для контакта Шоттки (КШ) с анодом из титана [5].
Как можно увидеть из рис. 2, кривые ВАХ, смоделированные в TCAD и рассчитанные на основе теории термоэлектронной эмиссии, весьма близки и имеют незначительное расхождение. С учетом этого, нами были найдены показатели идеальности и токи насыщения для каждой температуры диода Шоттки [6]. Графики были аппроксимированы согласно выражению (5), а полученные коэффициенты идеальности и токи насыщения сведены в таблицу 1.
Таблица 1. Значения коэффициентов идеальности и токов насыщения диода Шоттки Ti/4H-SiC
|
|
300 |
400 |
500 |
600 |
|
|
1,078 |
1,058 |
1,139 |
1,08 |
|
|
4∙10-17 |
4∙10-12 |
6∙10-9 |
4∙10-7 |
Среднее значение коэффициента идеальности составило n≈1,09, это как раз соответствует тому показателю, который демонстрируют качественные ДШ на карбиде кремния [1,3].
Далее согласно методике
[6] по извлеченным из ВАХ данным была построена зависимость ![]() от
от ![]() (график
Ричардсона) для определения эффективной высоты барьера Шоттки. Зависимость
представлена на рис. 3.
(график
Ричардсона) для определения эффективной высоты барьера Шоттки. Зависимость
представлена на рис. 3.

Рис.3. График Ричардсона.
Высоту барьера можно определить по
наклону аппроксимирующей линейной функции, и в нашем случае ![]() =1,17. Полученное значение высоты барьера
Шоттки довольно близко соответствует полученным экспериментальным данным в
работах [2] и [5].
=1,17. Полученное значение высоты барьера
Шоттки довольно близко соответствует полученным экспериментальным данным в
работах [2] и [5].
3.2. Обратные вольт-амперные характеристики
Известно, что теория термоэлектронной эмиссии предсказывает насыщение тока утечки при увеличении обратного напряжения, что не соответствует характеристикам, которые снимаются с реальных приборов. Это происходит вследствие того, что теория не учитывает множество дополнительных факторов, ответственных за рост обратного тока: распределение высоты барьера по площади контакта, туннелирование, тепловая генерация носителей в области пространственного заряда, зависимость высоты барьера от напряжения смещения [3].
Из всего перечисленного нами учитывалась только генерация носителей в области пространственного заряда (ОПЗ), что, по-видимому, и давало несколько заниженные результаты. Обратные ВАХ, полученные из расчетов в TCAD по методике, описанной в разделе 2, представлены на рис.4 в логарифмическом масштабе и в линейном масштабе на рис. 5.
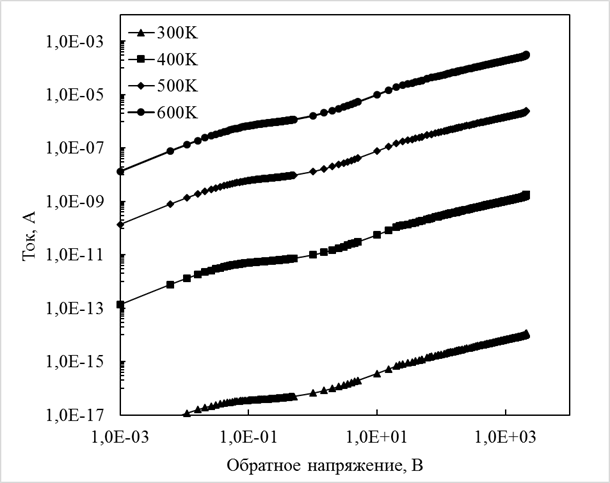
Рис.4. Обратные ВАХ Ti/4H-SiC диода Шоттки (логарифмический масштаб).
Если посмотреть на график обратной характеристики в линейном масштабе (рис.5), то можно заметить начало лавинного пробоя примерно на 2 кВ.
Напряжение пробоя
несимметричного резкого перехода ![]() можно рассчитать [4] по
следующей формуле:
можно рассчитать [4] по
следующей формуле:
![]() ,
,
где ![]() –
максимальная напряженность электрического поля для карбида кремния (2,5 МВ/см
для 4H-SiC
[7]),
–
максимальная напряженность электрического поля для карбида кремния (2,5 МВ/см
для 4H-SiC
[7]), ![]() – толщина ОПЗ. Если считать, что пробой
наступает в момент, когда толщина ОПЗ равна толщине эпитаксиального слоя, то
– толщина ОПЗ. Если считать, что пробой
наступает в момент, когда толщина ОПЗ равна толщине эпитаксиального слоя, то ![]() В. Рассчитанное значение довольно точно соответствует
результатам, полученным на основе нашей модели (см. рис. 5).
В. Рассчитанное значение довольно точно соответствует
результатам, полученным на основе нашей модели (см. рис. 5).

Рис.5. Обратная ВАХ Ti/4H-SiC диода Шоттки при 300 K.
4. Заключение
В данной работе методами моделирования проведено исследование структуры диода Шоттки Ti/4H-SiC, в которой высота барьера, коэффициент идеальности, прямой участок ВАХ и напряжение лавинного пробоя соответствуют практически «идеальному» диоду в рамках теории термоэлектронной эмиссии. Полученные значения имеют хорошее согласие с экспериментальными данными для подобных структур. Следовательно, предложенную модель можно использовать при расчетах параметров для всех структур диодов Шоттки аналогичного типа.
При этом токи утечки получаются заниженными вследствие того, что основным механизмом увеличения обратного тока является понижение высоты барьера, что не учитывалось в данной модели. С учетом этого, в будущем для корректного расчета этого параметра, в представленную модель планируется внести дополнительные корректировки.
Работа выполнена в рамках комплексного проекта при финансовой поддержке Министерства образования и науки Российской Федерации (договор № 02.G25.31.0201). Благодарим к.ф-м.н. Сурина Б.П. за предоставление и помощь в проведении расчетов в программе TCAD.
Литература
1. Kimoto T., Cooper J.A. Fundamentals of Silicon Carbide Technology. Growth, Characteriztion, Devices, and Applications. N.Y.: Wiley-IEEE Press. 2014. 539 p.
2. Xiaohu Zhang. Failure mechanism investigation for silicon carbide power devices. PhD thesis. University of Maryland, College Park, 2006.
3. Ivanov P.A., Grekhov I.V., Kon’kov O.I., Potapov A.S., Samsonova T.P., Semenov T.V. Semiconductors, 2011, Vol. 45, No. 10, pp. 1374–1377. DOI: 10.1134/S1063782611100095
4. Sze S.M., Ng Kwok K. Physics of Semiconductor Devices. New Jersey: John Wiley & Sons Int. 2007. 764 p.
5. Perrone D., Naretto M., Ferrero S., Scaltrito L., Pirri C.F. 4H-SiC Schottky Barrier Diodes Using Mo-, Ti- and Ni-Based Contacts, Materials Science Forum, 2009, Vols. 615-617, pp. 647-650. DOI: 10.4028/www.scientific.net/MSF.615-617.647.
6. Rhoderick E. H. Metal–Semiconductor Contacts. Oxford: Clarendon Press. 1978. 252 p.
7. Perez R. Planar edge terminations and related manufacturing process technology for high power 4H-SiC diodes. PhD thesis. Universitat Autònoma de Barcelona, Bellaterra (Barcelona), 2005.