УДК 621.385.2.029
СТАТИСТИКА ПОВРЕЖДЕНИЯ СВЧ ДИОДОВ ИМПУЛЬСНЫМ РАДИОИЗЛУЧЕНИЕМ
А.В. Ключник1, Ю.А. Пирогов2 , А.В. Солодов1
1Федеральное государственное унитарное предприятие “Московский радиотехнический институт Российской Академии наук”,
2Московский государственный университет им. М.В.Ломоносова, Центр магнитной томографии и спектроскопии
Получена 29 ноября 2010 г.
Аннотация. Рассмотрен процесс накопления повреждений СВЧ диодами при воздействии последовательности импульсов радиоизлучения. Проведен статистический анализ вероятности отказа СВЧ диодов от мощности воздействующих радиоимпульсов в полиимпульсном режиме.
Ключевые слова: модель, накопление повреждений, СВЧ диоды, радиоимпульс.
Введение
Анализ большого числа экспериментов [1-5] показывает, что значительную роль при оценке уровней повреждения СВЧ диодов играет режим воздействия (моноимпульсный, полиимпульсный, пачечный) и статистический (вероятностный) характер повреждения. Так если зафиксирована вероятность повреждения (например, на уровне 0,5), то повреждение СВЧ диодов в режиме одиночного импульса будет происходить при энергии и мощности импульса существенно больших, чем мощность и энергия одного импульса в полиимпульсном режиме.
Для объяснения эффектов повреждения при полиимпульсном воздействии можно воспользоваться моделью накопления повреждений [6]. В этой модели предполагается, что под действием одного импульса происходит незначительное локальное изменение структуры, например, образование дефекта. Выход прибора из строя будет происходить при достижении некоторого критического числа дефектов.
В данной работе представлены результаты экспериментальных исследований повреждения смесительных СВЧ диодов. После обработки экспериментальных данных, получена зависимость вероятности повреждения диодов от мощности радиоимпульса.
На основе модели накопления повреждений [6], проанализировано кинетическое уравнение для параметра, описывающего процесс повреждения СВЧ диодов, исследованы статистические особенности их повреждения в полиимпульсном режиме, получены зависимости вероятности повреждения от числа воздействующих импульсов и их мощности.
Результаты экспериментальных исследований
Регистрация сигналов с выхода СВЧ диодов, формирующихся под действием повторяющихся радиоимпульсов показывает, что в значительном числе случаев наблюдается ухудшение характеристик приборов «от импульса к импульсу».
Характерные осциллограммы сигналов с выхода, например, смесительного диода Д405 при мощности импульсов радиоизлучения в тракте Р=55 Вт, снятые в разные моменты времени t, представлены на рис. 1.
На этих осциллограммах прослеживается процесс повреждения диодов (изменение амплитуды выходного сигнала) при воздействии пачки радиоимпульсов.
В режимах с частотами повторения 100…1000 Гц для детекторных и смесительных диодов наблюдается быстрое уменьшение выходного сигнала и последующая его «стабилизация» на сниженном уровне. При высокой частоте повторения этот эффект можно было бы объяснить накоплением тепла от импульса к импульсу. Однако для накопления тепла необходимо, чтобы пауза между импульсами была соизмерима с тепловой постоянной выпрямляющего контакта. А эффект наблюдается и в том случае, когда длительность паузы между импульсами значительно больше тепловых постоянных, например, на частотах в десятки и сотни Гц.

Рис. 1. Осциллограммы сигналов с выхода смесительного диода
Параметры радиоимпульсов: частота повторения F =100 Гц,
длительность t = 37 нс, длина волны радиоизлучения l = 3.2 см
а – t = 0 c, б – 1 с, в – 6 с
В режимах с частотами повторения 100…1000 Гц для детекторных и смесительных диодов наблюдается быстрое уменьшение выходного сигнала и последующая его «стабилизация» на сниженном уровне. При высокой частоте повторения этот эффект можно было бы объяснить накоплением тепла от импульса к импульсу. Однако для накопления тепла необходимо, чтобы пауза между импульсами была соизмерима с тепловой постоянной выпрямляющего контакта. А эффект наблюдается и в том случае, когда длительность паузы между импульсами значительно больше тепловых постоянных, например, на частотах в десятки и сотни Гц.
Для количественной характеристики эффектов повреждения были выполнены эксперименты, целью которых являлся анализ зависимости, например, для смесительных диодов, изменения потерь преобразования DL от мощности СВЧ импульсов Ри.
Измерение абсолютного значения потерь преобразования смесительных диодов, проводилось в соответствии с [8] до и после СВЧ воздействия.
В процессе воздействия, амплитуда колебаний промежуточной частоты измеряется на выходе смесителя с помощью осциллографа. Изменение потерь преобразования определялось по формуле: DLпрб=10×lg(U0/UП), U0 - измеряется амплитуда колебаний промежуточной частоты для неповрежденного смесительного диода до СВЧ воздействия, UП - амплитуда колебаний промежуточной частоты повреждаемого диода, во время и после воздействия.
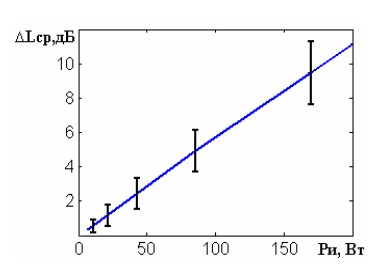
Рис. 2. Зависимость изменения потерь преобразования DLср диода Д405Б от мощности Ри
Параметры радиоимпульсов: частота повторения F =100 Гц,
длительность t = 37 нс, длина волны радиоизлучения l=3.2 см
На рис. 2 представлена зависимость изменения потерь преобразования DLср и среднеквадратичное отклонение от мощности Ри импульса излучения, которые были получены в экспериментах с постепенным увеличением мощности излучения после каждого облучения.
В силу естественного разброса характеристик СВЧ диодов имеется и статистический разброс в изменении параметров диодов при одном и том же уровне СВЧ воздействия. Поэтому необходима оценка вероятности повреждения диода. Для оценки вероятности эксперименты проводились с большим числом диодов. После этого рассчитывались вероятностные характеристики, такие как математическое ожидание и дисперсия.
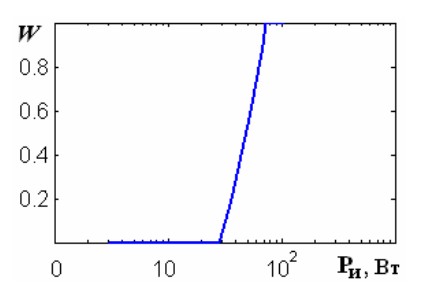
Рис. 3 Зависимость вероятности повреждения W смесительных диодов от мощности радиоимпульсов
Параметры радиоимпульсов: частота повторения F = 100 Гц,
длительность t = 37 нс, длина волны радиоизлучения l = 3.2 см
По результатам статистической обработке данных
экспериментов построена зависимость вероятности повреждения W
смесительных диодов Д405, соответствующего увеличению
потерь преобразования не менее 3 дБ, от мощности Ри
радиоимпульса, которая представлена на рис.3.
Исследование вероятности повреждения СВЧ диодов показали, что существуют определенные статистические закономерности выхода СВЧ диодов из строя. Например, наличие порога говорит о том, что физические механизмы повреждения «запускаются» только при превышении определенной мощности радиоимпульса.
Полученные экспериментальные результаты показывают, что повреждение полупроводниковых элементов носит вероятностный характер, вероятность повреждения является существенной характеристикой процесса повреждения, и должна учитываться при определении мощности повреждения. Она зависит от частоты повторения воздействующих импульсов и их мощности. Полученные экспериментальные результаты могут в значительной степени быть объяснены в рамках представленной ниже модели накопления повреждений.
Отметим, что существующие теории статистических отказов полупроводниковых элементов разработаны для случаев достаточно медленных, деградационных процессов (диффузия, электромиграция и т.д.) [7]. В представленной работе будут рассмотрены, «катастрофические» отказы под действием перегрузок, которые многократно превосходят рабочие параметры номинальных сигналов СВЧ диодов.
Модель накопления повреждений
Будем предполагать, что под действием радиоимпульса выше номинала происходит образование дефектов структуры выпрямляющего контакта диода, приводящих к изменению его характеристик. Такой характеристикой может быть, например, дифференциальная проводимость p(t) выпрямляющего контакта. Под действием одного импульса перегрузки параметр p(t) изменяется на dp. Изменение характеристик прибора будет связано с отклонением величины p(t) от номинального значения p0, характеризующего исправный прибор. При достижении некоторого критического значения p(t)=pc, будет происходить повреждение прибора. Размеры дефекта зависят от энергии импульса, а их число определяется структурой полупроводника, его однородностью. Количество импульсов, приводящих к повреждению полупроводникового элемента, может изменяться от образца к образцу. Наблюдаемое уменьшение мощности импульсов, вызывающих повреждение диода, с увеличением частоты повторения обусловлено тем, что повреждение полупроводникового элемента может происходить путем создания большого числа дефектов. Энергия образования каждого из них сравнительно невелика. Для повреждения элемента одним импульсом требуется создание одного большого дефекта, при этом для его создания требуется значительная энергия.
Изменение параметра p под действием одного мощного радиоимпульса длительностью t будет пропорционально скорости процесса повреждения r(t). Для оценки скорости изменения параметра p используем активационную теорию Аррениуса, в соответствии с которой
![]() ,
(1)
,
(1)
где Еа – энергия активации, r
- постоянная, зависящая от типа дефектов,
k - постоянная Больцмана, T – температура выпрямляющего контакта,
которая изменяется под действием радиоимпульсов.
В работе [9] получено кинетическое уравнение для параметра p(t), описывающее процесс повреждения p-n перехода:
 . (2)
. (2)
Член n×p(t), описывает процесс восстановления полупроводниковой структуры.
Рассмотрим импульсно-периодический режим тепловыделения с длительностью прямоугольных импульсов t и частотой повторения F, такой, что в паузе между импульсами температура перехода успевает восстановиться до первоначального значения. В этом случае, изменение параметра p(t) под действием пачки из N импульсов принимает вид
 , (3)
, (3)
где
 .
.
В рассматриваемом случае локальное повреждение и образование дефектов структуры в p-n переходе обусловлено его интенсивным локальным разогревом под действием радиоимпульсов. Эффективная локальная температура T(t) в (3) может быть определена из решения уравнения теплопроводности.
Решение уравнения теплопроводности для плоского p-n перехода площадью S и шириной d имеет вид:
 , t1<<t£t, (4)
, t1<<t£t, (4)
 , t>t,
, t>t,
где Р – рассеиваемая в p-n переходе мощность, t - длительность импульса, T0 – начальная температура, С, r - теплоемкость и плотность полупроводника, t1 = d2/k - тепловая постоянная p-n перехода, k - температуропроводность полупроводника.
Подставим в (3) полученную зависимость температуры от времени. В результате, в предельном случае E0 > kT для pN, получаем следующую оценку:
 , (5)
, (5)
 ,
,
где Tt=T0+∆T,
![]() .
.
Считаем, что статистические флуктуации параметра p связаны со случайной величиной активационной энергии Еа, и именно ее флуктуации определяют статистику повреждений (так как дефекты, образующиеся под действием серии импульсов перегрузки, могут возникать на различных центрах, кроме того, меняться условия образования дефектов).
Вероятность повреждения СВЧ диода W можно оценить как вероятность превышения параметром p критического значения pc:
 .
.
Если плотность вероятности g(p) случайной величины p, а f(Еа) - известная плотность вероятности случайной непрерывной величины Еа и р(Еа) - монотонно убывающая функция, то вероятность повреждения СВЧ диода W (после воздействия N импульсами перегрузки) можно оценить как
 . (6)
. (6)
Величина E(T,F,n,h,g) определяется из решения уравнения (3) или (5) при pN = pc, где вводится обозначение g = ln(rt/pc).
Представленная модель дает возможность рассчитать зависимость вероятности повреждения W, например, от числа тепловых импульсов N, от частоты повторения импульсов F, от мощности P (или энергии) одного импульса и т.д.
Для оценки вероятности повреждения СВЧ диода предположим, что энергия активации Еa имеет нормальный закон распределения со средним значением Em и дисперсией D2.
Тогда вероятность повреждения (превышения рс) будет иметь вид (например, для случая Em > E0):
при E(T,F,n, h,g) ³ Em
 ,
,
при E0 < E(T,F,n, h,g) <Em, (7)
 ,
,
 .
.
Величину Eo можно оценить как kTc, где Tc » (T0+DTс) - критическое значение температуры, используемое в модели Вонша-Белла, при достижении которого происходит повреждение p-n перехода. Величину DTс для разных p-n переходов, например, кремниевых p-n переходов можно определить по эмпирическому выражению, приведенным в работе [10]. Так для переходов p-n переходов с напряжением лавинного пробоя -7…-9 В, DTс » 350…5000.
На рис. 4 представлена зависимость вероятности повреждения СВЧ диода W от числа воздействующих радиоимпульсов N. Графики на рис. 4 построены при kT(Е)/Em = 0,1, E0/Em = 0.1, g = 3, n/F = 0.001.
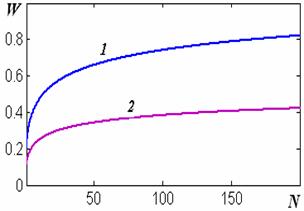
Рис. 4. Зависимость вероятности повреждения СВЧ диода W от числа воздействующих радиоимпульсов N
1 - D/Em = 1.3, 2 - D/Em = 2.
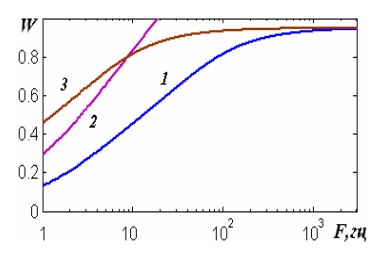
Рис. 5 Зависимость вероятности повреждения СВЧ диодов W от частоты повторения импульсов F
1 - D/Em = 1.3, 2 – D/Em = 2
На рис. 5 представлена зависимость вероятности
повреждения СВЧ диодов W от частоты повторения импульсов F.
Графики на рис. 5 построены при kT(Е)/Em = 0,1,
E0/Em = 0.1, g = 1, N = 200, n/F = 0,001.
Из выражения (5) следует, что при
n/F,Nn/F<<1 вероятность повреждения W
пропорциональна
log(N) и нарастает
с увеличением количества воздействующих импульсов, а при Nn/F>>1 вероятность
W
стремится к постоянной величине.
Образование дефекта происходит при T,Tc>>T0. Поэтому отношение kT(P)/kTс ~P/Pc.
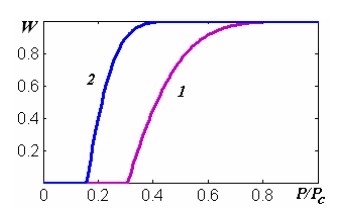
Рис. 6 представлена зависимость вероятности повреждения микросхем W от относительной мощности Р/Рc.
1 - nF = 0.1, 2 - nF = 1e-5.
На рис. 6
представлена зависимость вероятности повреждения микросхем W
от относительной мощности Р/Рc. Графики на рис. 6 построены при D/Em = 1, E0/Em = 1.5, g = 1, N = 200.
Кривые рис. 6 показывают, что выход из строя СВЧ диода происходит при превышении определенного уровня мощности.
Из анализа графиков на рис. 3-6 видно, что при сравнительно небольших вариациях параметров распределения активационной энергии, теоретические графики могут довольно хорошо аппроксимировать результаты статистической обработки экспериментальных исследований.
В заключение, если зафиксировать вероятность повреждения на уровне 0,5 в выражении (7), то можно определить зависимость относительной мощности Р/Рс импульса от частоты повторения импульсов F. Полагая Eo=kTc , то для наиболее интересного случая Nn/F<<1 получим
 .
(8)
.
(8)
Из (8) следует, что с увеличением частоты следования импульсов F мощность Р50% (энергия Е50%=P50%t) импульса, необходимая для повреждения прибора, уменьшается.
Аналогичное выражение вида (8) было получено в [5] на основе обработки большого массива экспериментальных данных для мощности повреждения смесительных диодов 1N23.
Выводы
Представленные экспериментальные результаты показывают, что повреждение полупроводниковых элементов под воздействием пачки радиоимпульсов носит статистический (вероятностный) характер. Выход СВЧ диодов из строя может рассматриваться на основе модели накопления повреждений и происходит при достижении некоторого критического числа дефектов, формирующихся под действием каждого импульса в пачке.
Построена модель накопления повреждений, основанная на активационной теории Аррениуса, в которой статистические особенности процесса повреждения определяются флуктуациями активационной энергии. Она позволяет описывать зависимость мощности повреждения СВЧ диодов от числа воздействующих радиоимпульсов N, их частоты повторения F и от мощности P (или энергии).
Литература
1. Garver R.V., Fazi C.,Druns H. Dynamic diode mixer damage measurements. – 1985 IEEE MTT-S Int.Microwave Symp. Digest., p.535-536.
2. Glan Chance V. Transit mixer damage. IEEE MTT-S Int. Microwave Symp. Digest., 1989, p. 475-477.
3. Christon A. GaAs mixer burnout mechanisms at 36-94 GHz. –Annual Proc. Reliab. Physics, 1980, p.140-144.
4. Dale ., Neylon S., Condie A., Kearacy M.J. Planar doped barrier diodes offering improved microwave burnout performance over Si and GaAs Shottky diodes. -19 Europe Microwave Conf. Proc., 1989, p.237-243.
5. Whalen J.J. The RF Pulse Susceptibility of UHF Transistors. // IEEE Trans., 1975, Vol. EMC-17, No.1.
6. Васильев К.Б., Ключник А.В., Солодов А.В. Статистика отказов цифровых ИМС, вызванных импульсным радиоизлучением. // 9-я Междунар. Крымская конфер. «СВЧ-техника и телекоммуникационные технологии». Доклад, Севастополь, 1999, с.329-330.
7. Физические основы надежности интегральных схем. / Сыноров В.Ф., Пивоваров Р.П., Петров Б.К., Долматов Т.В. / Под ред. Ю.Г. Миллера. – М.: Сов. Радио, 1976, 320 с.
8. ГОСТ 19656.4-74. Диоды полупроводниковые СВЧ смесительные. Методы измерения потерь преобразования.
9. Ключник А.В., Солодов А.В. Статистическая модель повреждения цифровых интегральных микросхем импульсным радиоизлучением // Радиотехника, 2010, №2, с.37-41.
10. Антипин В.В., Годовицын В.А., Громов Д.В., Кожевников А.О., Раваев А.А. Влияние мощных импульсных микроволновых помех на полупроводниковые приборы и интегральные микросхемы. // Зарубежная радиоэлектроника, 1995, №1, с. 37-52.