Полуизолирующие 6H-SiC подложки для применения в современной электронике
А. А. Лебедев 1,5, С. В. Белов 1, С. П. Лебедев 1,5, Д.П. Литвин 1,2 , И. П. Никитина 1,
А. В. Васильев
2, Ю. Н. Макаров 2, С. С. Нагалюк 2, А. Н. Смирнов 1,5,
В.В. Попов 3,
В. Н. Вьюгинов 4, Р. Г. Шифман 4, Ю. С. Кузмичёв 4,
Н. К. Травин 4, О. В. Венедиктов 4
1
ФГБУН Физико-технический институт им. А. Ф. Иоффе РАН
2 ГК «Нитридные кристаллы, Санкт-Петербург
3
ОАО «Светлана» , Санкт-Петербург
4 ЗАО «Светлана-Электронприбор»,
Санкт-Петербург
5 Санкт-Петербургский национальный исследовательский университет информационных технологий, механики и оптики
Статья получена 6 февраля 2014 г.
Аннотация. В настоящей статье проведено исследование полуизолирующих подложек 6H-SiC производства ЗАО «Светлана-Электронприбор». Показано, что выращенные подложки по своим параметрам практически не уступают аналогичным подложкам производства ведущих мировых компаний. Рассмотрены возможные применения данного материала в производстве различных электронных приборов
Ключевые слова: полуизолирующий карбид кремния, полевые транзисторы, нитрид галлия, графен.
Abstract: In this paper a study of semi-insulating 6H-SiC substrates production "Svetlana-Electronpribor". It was shown that substrate grown by its parameters are not inferior to similar substrates produced by leading world companies. Consider the possible applications of this material in the production of various electronic devices
Key words: semi-insulating silicon carbide field effect transistors, gallium nitride, graphene.
Введение.
Известно, что исследования карбида кремния (SiC) как материала для полупроводниковой электроники в Ленинграде (С. Петербурге) начались с работ О.В. Лосева, которые он проводил в ФТИ им. А. Ф. Иоффе в тридцатых годах прошлого века [1,2]. Уже в послевоенные годы эти исследования были продолжены усилиями сотрудников ФТИ им. А.Ф.Иоффе и ЛЭТИ им В.И.Ульянова (Ленина). Были проведены широкие исследования электрофизических свойств данного материала, отработаны технологии получения объёмных кристаллов SiC, создания р-п структур, формирования омических контактов и меза-структур. Были разработаны прототипы целого ряда полупроводниковых приборов на основе SiC: диодов Шоттки [3], полевых транзисторов JFET [4] и MESFET [5], УФ фотоприёмников [6], p-i-n диодов [7] и ЛПД [8]. В последние годы технология роста объёмных полуизолирующих кристаллов карбида кремния (SI SiC), разработанная ГК «Нитридные кристаллы», была передана в ЗАО «Светлана-Электронприбор», где создано производство подложек из этого материала, включающее не только рост, но также резку объемных кристаллов на пластины, их шлифовку, полировку и подготовку поверхности для эпитаксии [9].
Целью настоящей работы было исследование параметров полученных SI SiC подложек и рассмотреть наиболее перспективные применения.
1. Рост и исследование SI SiC.
Для роста монокристаллических слитков
карбида кремния используется технология сублимации. Данная технология основана
на испарении источника поликристаллического SiC и осаждения его компонент на монокристаллическую
затравку SiC, находящуюся в более холодном месте
реактора [10-14]. Рост происходит в вакууме или атмосфере инертного
газа. Техническая реализация ГК «Нитридные кристаллы» ростовой установки
представлена на рисунке 1. С использованием подобных установок в ЗАО
«Светлана-Электронприбор» начато промышленное производство высокоомных (![]() ) подложек карбида кремния политипа 6Н
диаметром три дюйма. Были выращены кристаллы полизолирующего SiC двух типов: легированные ванадием и
без дополнительного легирования. Для получения полуизолирующего материала был
разработан процесс синтеза чистого источника SiC из порошков Si и С.
) подложек карбида кремния политипа 6Н
диаметром три дюйма. Были выращены кристаллы полизолирующего SiC двух типов: легированные ванадием и
без дополнительного легирования. Для получения полуизолирующего материала был
разработан процесс синтеза чистого источника SiC из порошков Si и С.

Рис. 1. Установка с индукционным нагревом для сублимационного роста SiC диаметром до 4”.
Структурное совершенство и политипная однородность подложек была исследована рентгеновскими методами и Рамановской спектроскопией. Измерения кривых дифракционного отражения (КДО) на симметричном отражении (0006)SiC-6H проводились на двухкристальном спектрометре собранном на базе промышленного дифрактометра ДРОН-3 с медным антикатодом (lCuKa1=15.40563nm). В качестве монохроматора использовался бездислокационный монокристалл SiC-6H, выращенный традиционным методом Лэли, что обеспечивало практически бездисперсионную схему измерений и таким образом позволило оценивать реальные полуширины КДО выращенных слоев.
Полуширины рентгеновских кривых качания (FWHM) полученных подложек находились в диапазоне 20-40 arcsec (Рис.2).
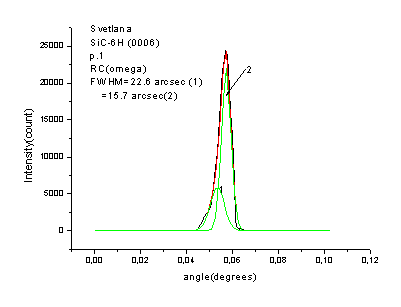
Рис. 2. Рентгеновская кривая качания для выращенной подложки 6H-SiC
Определение плотности дислокаций в пластинах карбида кремния осуществлялось с помощью метода селективного травления в расплаве щелочи (КОН). Для удобства пластины SiC разрезались на квадраты со стороной 1см. Температура расплава составляла 550-600оС, а время травления – от 5 до 20 минут. Для идентификации дефектов использовалась оптическая микроскопия.
После 20-ти минутного травления следы механической полировки полностью исчезали и на поверхности оставались только ямки травления, обусловленные различного рода дислокациями, присутствующими в пластинах SiC. При этом размеры ямок увеличились до 10-15 мкм.
Как видно из рисунка 3, плотность дислокаций неоднородна по поверхности. Встречаются как области с малой плотностью одиночных дислокаций (плотность дислокаций ~1х104см-2), так и области с линейными цепочками дислокаций. Данные цепочки могут быть обусловлены блочностью пластины SiC, в результате чего на границе доменов образуется избыточное количество дефектов упаковки. В таком случае плотность дислокаций возрастает как минимум на порядок (>1х105см-2).

Рис. 3. Распределение плотности дислокаций по поверхности подложки. Оптическая фотография после 20 мин. Травления в КОН.
Исследования политипной
однородности подложек были выполнены методом рамановской спектроскопии. Микро-рамановские
измерения проводились при комнатной температуре в геометрии обратного рассеяния
![]() на спектрометре Horiba Jobin-Yvon T64000. В качестве
источника возбуждения использовался Ar+-лазер (l=514 нм). Анализ спектров показывает, что исследуемая подложка SI 6H-SiC является
структурно-однородной по площади и не содержит включений других политипов,
кроме 6H-SiC. Положения фононных линий симметрии E2(TO) соответствуют их положению в недеформированных слоях SiC, что также характерно и для подложек
SI 6H-SiC производства
фирмы CREE, Inc (см. Рис.4).
Таким образом, согласно полученным экспериментальным данным можно сделать
вывод, что данные подложки по своему качеству практически не уступают подложкам
фирмы CREE,
Inc.
на спектрометре Horiba Jobin-Yvon T64000. В качестве
источника возбуждения использовался Ar+-лазер (l=514 нм). Анализ спектров показывает, что исследуемая подложка SI 6H-SiC является
структурно-однородной по площади и не содержит включений других политипов,
кроме 6H-SiC. Положения фононных линий симметрии E2(TO) соответствуют их положению в недеформированных слоях SiC, что также характерно и для подложек
SI 6H-SiC производства
фирмы CREE, Inc (см. Рис.4).
Таким образом, согласно полученным экспериментальным данным можно сделать
вывод, что данные подложки по своему качеству практически не уступают подложкам
фирмы CREE,
Inc.
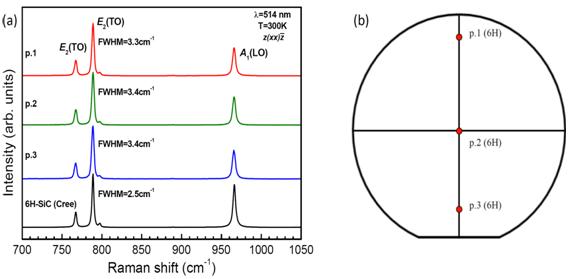
Рис.4. Рамановские спектры подложки SI 6H-SiC (a), полученные в разных точках образца (b). На рисунке (a), для сравнения, приведен спектр высококачественной подложки SI 6H-SiC производства фирмы CREE, Inc.
2. Возможные практические применения полученных подложек.
2.1 Гомоэпитаксия
Полуизолирующие подложки могут быть использованы для создания MESFET транзисторов (ПТШ) . На основе известных соотношений [15] можно оценить параметры подобного транзистора
Для расчёта использовались следующие параметры:
Легирование канала (Nd) = 2* 1017 см-3
Глубина канала (a) = 0,2 mm = 2*10-5 см
Длина канала (L) = 1 mm = 1*10-4 см
Ширина канала (Z) = 1мм = 10-1 см
Согласно литературе [16]: подвижность электронов (m) при таком значении Nd составляла 400 см2/В с; напряжение пробоя (Ubr.max) при таком значении Nd составляла 200 В; Диэлектрическая проницаемость 4H-SiC (e ); принималась равной 10; диэлектрическая проницаемость вакуума (e0 ) = 8,8 10-14 ф/см; заряд электрона (q) = 1,6* 10-19 Кл.
2.1.1.Максимальный ток насыщения Ip
Ip = 2 Z m q2 Nd2 a3 ≈ 1,2 A
6 e e0 L
2.1.2 Напряжение перекрытия канала транзистора U
Известно, что толщина слоя объёмного заряда (W) равна
W = (2e e0 U/ q Nd)1/2
Отсюда, полагая, что в момент перекрытия W = a,
получаем U = a2 q Nd/2e e0 ≈ 7 В
2.1.3. Максимальная рабочая частота Fm
Fm = q Nd m a2 / p L2 e e0 ≈ 180 ГГц
2.1.4. Напряжение пробоя
Сначала найдем толщину слоя объемного заряда (Wmax), соответствующую напряжению пробоя для данной концентрации в канале
Wmax = (2e e0 Ubr.max / q Nd)1/2 = 3,3 mm
Теперь оценим напряжение пробоя (U1) для нашей длины канала (W = L)
U1 = Ubr.max L/ Wmax ≈ 60 В
Подобные транзисторы уже разработаны за рубежом [17-18].
2.2 Рост плёнок графен
В последние годы усилился интерес к получению и исследованию планарных наноуглеродных слоев (графена). Графен (англ. graphene), двумерный кристалл, состоящий из одного (или нескольких) слоев атомов углерода, соединённых посредством sp2, связей в гексагональную двумерную кристаллическую решётку [19]. Среди достоинств графена можно отметить высокую подвижность носителей тока (~104 см2/(В•с)) при комнатной температуре, высокую механическую прочность, сочетание прозрачности и низкого электрического сопротивления. Данные слои стабильны при комнатной температуре на воздухе, и могут быть использованы для создания нанотранзисторов. Использование графена в качестве основы компонентной базы будущей наноэлектроники позволит преодолеть ограничения, свойственные традиционной кремниевой электронике и касающиеся степени миниатюризации и энергопотребления устройств [20-21]. Фирма INTEL рассматривает графен как одну из возможных основ микроэлектроники будущего и как возможную замену кремния в интегральных микросхемах.
Существует несколько методов получения графена – «отшелушивание» от куска графита, выращивание на поверхности SiC методом сублимации, химическое осаждение на поверхности металлов, и др. (см. Таблицу 1).
Таблица 1. Сравнение перспективности промышленного применения плёнок графена, полученных по различным технологиям.
|
Технология |
Существующие недостатки для промышленного применения |
|
Механическое «отшелушивание |
Пленки неправильной формы и небольшой площади |
|
Химическая интеркаляция |
Не контролируемая толщина получаемых пленок. Часто не происходит полного разделения отдельных плёнок, образцы в форме «книги». |
|
Осаждение на поверхности металлов |
Для создания приборов требуется отделения пленки от поверхности металлов и перенесение на диэлектрическую подложку. При этом происходит значительное ухудшение свойств графена |
|
Электрохимичские методы |
Неконтролируемость формы и размеров получаемых плёнок |
|
Термодеструкция поверхности карбида кремния в атмосфере инертных газов |
Подвижность носителей заряда уступает подвижности в плёнках, полученных отшелушиванием. Других недостатков нет. |
Наилучшим структурным совершенством обладают слои графена полученные методом отшелушивания. Однако эти слои имеют микронные размеры и неправильную геометрическую форму. Это делает их малопригодными для промышленного применения.
На втором мессе по своим структурному совершенству и электрофизическими параметрам находятся пленки графена, полученные на поверхности карбида кремния. Такие пленки могут быть выращены на подложках SiC диаметром 3 дюйма и демонстрируют однородность параметров по всей площади пластины. Подобные пластины могут быть использованы в стандартной технологической линейке для изготовления полупроводниковых приборов. Дополнительным преимуществом данной технологии является возможность получения графеновой пленки на полуизолирующей подложке SiC, что снимает необходимость переносить выращенную пленку на подложку диэлектрика, как это имеет место при росте на Mo и других металлах.
Достоинством метода термодеструкции SiC также является низкая себестоимость и достаточно высокое структурное совершенство полученных плёнок графена. Данная технология рассматривается сейчас как наиболее перспективная с точки зрения промышленного применения. Только на плёнках графена, полученных отшелушиванием и термодеструкцией удалось наблюдать квантовый эффект Холла [22]. Все остальные технологии производят плёнки с худшим структурным совершенством. Технология на основе термодеструкции SiC сейчас рассматривается как наиболее перспективная с точки зрения промышленного применения в электронике.

Рис. 5. АСМ топограмма пленки мультиграфена на поверхности SiC
2.3 Эпитаксия соединений III-N.
Поиск широкозонных полупроводников, которые могли бы заменить кремний для создания различных типовых силовых приборов, проводились достаточно давно [23]. Достигнутый в последние годы успех в технологии GaN и твёрдых растворов на его основе позволяет по новому взглянуть на эту проблему. В Таблице 2 представлено сравнение параметров ряда полупроводниковых материалов. Как видно из таблицы один GaN уступает SiC лишь в теплопроводности. Кроме того, рост GaN происходит при меньших температурах и с использованием более дешёвых материалов. Широкому использованию GaN для производства силовых приборов мешало отсутствие собственной подложки и низкое структурное совершенство получаемых эпитаксиальных слоёв.
Таблица 2. Параметры некоторых полупроводниковых материалов
|
Параметры |
Полупроводники |
|||
|
Si |
GaAs |
GaN |
6H-SiC |
|
|
Запрещённая зона, еВ |
1,1 |
1,4 |
3,4 |
3,1 |
|
Подвижность электронов, см2/В с |
1400 |
8500 |
1000 (объём) 2000 (2DEG) |
600 |
|
Скорость насыщения, см/сек, 107 |
1 |
2 |
2,5 |
2 |
|
Критическая напряженность электрического поля В/см, 106 |
0,3 |
0,4 |
> 5 |
4 |
|
Теплопроводность, Ватт/см |
1690 |
1510 |
> 1700 |
> 2100 |
Другой проблемой является получение сильно легированного р+ GaN эмиттера. Однако для униполярных приборов, диодов Шоттки и HEMT транзисторов это недостаток несущественен. Достигнуты прогресс в технологии позволил получить ДШ на напряжение ~ 1200 В [24] не уступающие аналогичным приборам на основе SiC, но более дешёвым. А также не имеющим аналогов на основе SiC HEMT транзисторы [25].
Отсутствие собственной подложки приводит к тому, что эпитаксиальные слои GaN чаще всего выращиваются на сапфире. Однако подложка Al203 является изолятором и не позволяет изготовлять приборы в вертикальной геометрии. Кроме того, сапфир обладает низкой теплопроводностью, а это снижает выходную мощность прибора.
С нашей точки зрения дальнейшим развитием технологии силовых GaN НЕМТ был бы переход на SiC подложки. Использование более дорогой, чем Al203 подложки SiC, можно компенсировать за счёт использования более дешёвой технологии роста эпитаксиальных слоёв HVPE вместо MOCVD .
Заключение
Согласно полученным экспериментальным данным можно сделать вывод, что выращенные ЗАО «Светлана» SI -6H-SiC подложки по своему качеству практически не уступают подложкам других производителей. Они могут быть использованы как для гомоэпитаксии SiC, так и для гетероэпитаксии III-N и создания плёнок графена.
Результаты работы доложены на 1-й Российско-белорусской научно-технической конференции «Элементная база отечественной радиоэлектроники», посвященной 110-летию со дня рождения О. В. Лосева, Нижний Новгород, 11-14 сентября 2013 г. [9].
Работа частично выполнена при государственной финансовой поддержке ведущих университетов Российской Федерации (субсидия 074-U01).
Литература
1. А.Г.Остроумов, А.А.Рогачёв. О.В.Лосев — пионер полупроводниковой электроники. Сб. Наун. тр. Физика: проблемы, история, люди/ Под ред. В.М.Тучкевича. Наука Л. (1986).
2 М.А.Новиков, Олег Владимирович Лосев — пионер полупроводниковой электроники. ФТТ, 46, (2004) 5-9.
3 Аникин М.М., А.Н.Андреев, А.А.Лебедев, С.Н.Пятко, М.Г.Растегаева, Н.С.Савкина, А.М.Стрельчук, А.Л.Сыркин, В.Е.Челноков, Высокотемпературный диод Шоттки, ФТП 25, (1991) 328.
4. М.М.Аникин, П.А.Иванов,А.Л.Сыркин,Б.В.Царенков, В.Е.Челноков SiC 6H — полевой транзистор с рекордной для карбидкремневых транзисторов крутизной, Письма в ЖТФ, 15 (1989) 36.
5. А.А.Лебедев, М.М.Аникин, М.Г.Растегаева, Н.С.Савкина, А.Л.Сыркин, В.Е.Челноков, Полевой транзистор на основе 6H-SiC с затвором в виде диода Шоттки, ФТП, 29 (1995) 1231-1236.
6 M.M.Anikin, A.N.Andreev, S.N.Pyatko, N.S.Savkina, A.M.Strelchuk, A.L.Syrkin and V.E.Chelnokov, UV photodetectors in 6H-SiC, Sensotrs and Actuators A, 33 (1992) 91-93.,
7. A.V.Bludov, M.S.Boltovets, K.V.Vasilevski, A.V.Zorenko, K.Zakentes, A.A.Lebedev, V.A.Krivitsa. Simulation and prototype fabrication of microwave modulators with 4H-SiC p-I-n diode. Material science Forum V 457-460 (2004) 1089-1092.
8. K.V.Vasilevski, A.V.Zorenko, K.Zekentes,Experimentsl observation of microwave oscillations produced by pulsed silicon carbide IMPATT diodes, Electron.letters 37 (7), (2001) 466-467.
9. Лебедев А.А., Белов С.В., Лебедев С.П., Литвин Д.П., Никитина И.П.,Васильев А.В., Макаров Ю.Н., Нагалюк С.С., Стрельчук А.М., Попов В.В., Вьюгинов В.Н., Шифман Р.Г., Кузмичёв Ю.С., Травин Н.К., Венедиктов О.В. Начало промышленного выпуска SiC подложек и приборов на их основе // Труды 1-й российско-белорусской научно-технической конференции «Элементная база отечественной радиоэлектроники», посвящённой 110-ю со дня рождения О. В. Лосева / Под ред. А. Э. Рассадина. --- Н. Новгород.: НИЖЕГОРОДСКАЯ РАДИОЛАБОРАТОРИЯ. 2013. В 2-х т. Т. 1. С. 23-24.
10. Yu.M.Tairov, and V.F.Tsvetkov, Investigation of Growth proceses of ingots of silicon carbide single crystals, J.Crystal Growth 43 (1978) 209-212.
11. Yu.A.Vodakov and E.N.Mokhov Patent USSR No 403275 (1970), Patent GB No 1458445 (21/02/74), Patent USA (1970) No. 4147575 (03/04/79).
12. E.N.Mokhov, I.L.Shulpina, A.S.Tregubova, and Yu.A.Vodakov, Cryst. Res. Technol. 16 (1981) 879
13. S.Yu.Karpov, Yu.N.Makarov, E.N.Mokhov, M.G.Ramm, M.S.Ramm, A.D.Roenkov, R.A.Talalaev, Yu.A.Vodakov, Analysis of silicon carbide growth by sublimation sandwich method, J. of Crystal Growth 173 (1997) 408-416.
14. С.М.Зи Физика полупроводниковых приборов, Москва, «Энергия», 1973
15 M.E.Levinshtein, S.L.Rumyantsev, M.S.Shur 2001 Properties of Advanced Semiconductor materials: GaN, AlN, InN, BN, SiC, SiGe (New York: Wiley)
16 J.H.Yim et al, 4H-SiC Planar MESFETs on High-Purity Semi-insulating Substrates, Materials Science Forum V 556-557 (2007) pp 763-766
17 S.Katakami, M.Ogata, S. Ono and M.Arai, Improvement of Electrical Characteristics of Ion Implanted 4H-SiC MESFET on a Semi-insulating Substrate, Materials Science Forum V 556-557 (2007) pp 803-806/
18 K.S. Novoselov, A.K. Geim, S.V. Morozov, D. Jiang, Y. Zhang, S.V. Dubonos, I.V. Grigorieva, A.A. Firsov, Electric field effect in atomically thin carbon films, Science 306, 666 (2004).
19 M.C. Lemme, Current status of graphene transistors, Solid State Phenomena 156, 499 (2009).
20 F. Schwierz, Graphene transistors, Nature Nanotech. 5, 487 (2010)
21 Y. Wu, Y. Lin, K. Jenkins et al, RF performance of short channel graphene field-effect transistor, Tech. Dig. of Int. Electron Device Meeting (IEDM), 226 (2010).
22 A.Tzalenchuk, S.lara-Avila, A.Kalaboukhov, S.Paolillo, M.Syvajarvi, R.Yakimova, O.Kazakova, T.J.B.M. Janssen, V.Fal’ko and S.Kubatkin, Nature Nanotechnology 5, 186-189 (2010).
23 А.А.Лебедев, В.Е. Челноков Широкозонные полупроводники для силовой электроники, ФТП, т33,№9,(1999), стр1096-1099
24 L.Young, et.al. Field plate engineering for GaN-based Schottky barrier diodes, J. of Semiconductors, V 34 No 5 (2013) 054007
25 J.R .LaRoche, B.Luo, F. Ren, K.H. Baik, D.Stodilka, B Gila, C.R. Abernathy, S.J. Pearton, A. Usikov, D. Tsvetkov, V.Soukhoveev, G. Gainer, A.Pechnikov, V. Dmitriev, G.-T. Chen, C.-C. Pan, J.-I. Chyi. GaN/AlGaN HEMTs grown by hydride vapor phase epitaxy on AlN/SiCsubstrates.: Solid-State Electronics 48, pp. 193-196 (2004).