УДК 538.958, 546.03
ИССЛЕДОВАНИЕ d - ЛЕГИРОВАННЫХ n-i-p-i-n СТРУКТУР GaAs МЕТОДОМ СПЕКТРОСКОПИИ ФОТООТРАЖЕНИЯ
Л. П. Авакянц1, П. Ю. Боков1, И. В. Бугаков1, Т. П. Колмакова2, А. В. Червяков1
1 физический факультет МГУ имени М.В. Ломоносова, кафедра общей физики
2 ОАО «Оптрон», Москва
Получена 15 января 2010 г.
Аннотация. Методом
спектроскопии фотоотражения исследованы полупроводниковые nipin-структуры арсенида галлия с
дельта-легированными слоями p-типа. Из анализа осцилляций Франца-Келдыша определены
напряженности встроенных электрических полей и энергии межзонных переходов
структуры. Обнаружено увеличение энергии межзонного перехода в области
дельта-легирования, что объясняется эффектом Бурштейна-Мосса вследствие фотогенерации
носителей.
Ключевые слова: гетеоструктуры, фотоотражение,
дельта-легирование.
Введение
Полупроводниковые гетероструктуры, полученные путём чередования тонких полупроводниковых слоев, отличающихся по типу легирования, (pin-диоды и транзисторы, nipi-кристаллы) являются основой для создания целого ряда приборов СВЧ техники и оптоэлектроники. Наиболее распространенными материалами для этих приборов являются кремний и арсенид галлия. При этом в быстродействующих оптоэлектронных и СВЧ устройствах несомненными преимуществами, с точки зрения времени жизни неравновесных носителей тока и их подвижности, обладает арсенид галлия.
Особый интерес представляют структуры с дельта-легированными слоями [1]. В этих системах примесь локализована в слое толщиной несколько нм, что обеспечивает пространственное разделение носителей заряда и ионизированной примеси, и приводит к увеличению их подвижности. Зонную диаграмму таких структур можно формировать, задавая необходимые параметры в ходе эпитаксиального роста. Кроме того, потенциал объемного заряда, а, следовательно, и зонную структуру можно изменять путем электрического или оптического возбуждения дельта-слоя. Это делает дельта-легированные структуры интересными с точки зрения создания перестраиваемых (внешним потенциалом или излучением) оптоэлектронных приборов [1, 2, 3], в том числе, приборов терагерцевого диапазона [4].
В настоящей работе приводятся результаты исследований методом спектроскопии фотоотражения полупроводниковых дельта-легированных n-i-p-i-n структур на основе GaAs, применяемых для изготовления биполярных транзисторов.
Образцы и методика эксперимента
Исследуемые образцы выращивались методом газофазной эпитаксии. Рост происходил на полуизолирующих подложках GaAs типа АГП с ориентацией поверхности (100). Образцы представляли собой структуры типа n+-i-dp-i-n+.
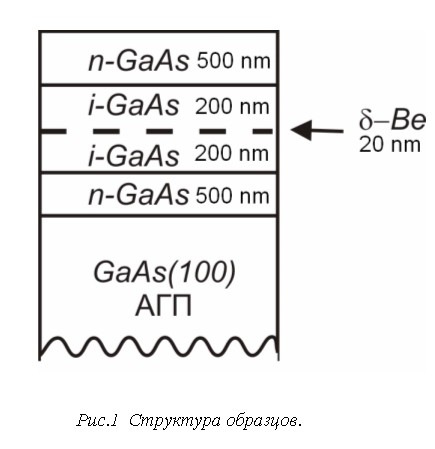
На рис. 1 схематически изображена структура исследуемых образцов: они состояли из слоев GaAs n-типа, слоев GaAs с собственной проводимостью i-GaAs и области дельта-легирования, созданной внедрением примеси Be. Толщина области дельта легирования не превышала 20 нм. Толщина слоя GaAs с собственной проводимостью составила 400 нм, n+ областей -500 нм, n=5·1018 см-3.
Исследуемые образцы имели технологические номера № 1205 и № 1206. Они отличались слоевой концентрацией легирующей примеси в области дельта-легирования: в образце № 1205 p=1.6·1012 см-2, в образце № 1206 p=2·1012 см-2.
Спектры фотоотражения регистрировались при комнатной температуре на установке [5], с использованием двойного монохроматора. Модуляция отражения осуществлялась He-Ne лазером (длина волны 632.8 нм, мощность 5 мВт) на частоте 370 Гц.
Результаты и обсуждение
На рис. 2 приведены спектры фотоотражения образца № 1206. В спектре, в области энергий от 1.4 – 1.7 эВ присутствуют осцилляции Франца-Келдыша двух различных периодов, и линия в области 1.8 эВ, связанная с переходом из зоны проводимости в спин-орбитально отщепленную подзону валентной зоны.
Разделение наблюдающихся в спектрах фотоотражения осцилляций Франца-Келдыша разных периодов производилось с помощью метода фазочувствительного анализа [6]. Для этого измерялись спектры фотоотражения с предустановкой фазы нановольтметра в 0 рад (рис. 2 снизу) и π/2 (рис. 2 посередине) и путем варьирования параметра φr в выражении (1) подбирался такой вид спектра (рис. 2 сверху), в котором возможно разделение осцилляций:
где ![]() и
и  - спектры
фотоотражения, зарегистрированные в фазе с модулирующим излучением и с
отставанием от него на π/2, Е – энергия
зондирующего излучения.
- спектры
фотоотражения, зарегистрированные в фазе с модулирующим излучением и с
отставанием от него на π/2, Е – энергия
зондирующего излучения.

В результате обработки экспериментальных данных в модели (1), получен спектр фотоотражения (рис. 2, верхний спектр), в котором видно разделение осцилляций Франца-Келдыша короткого и длинного периодов. Короткопериодные осцилляции расположены в области энергий в 1.4 - 1.5 эВ, длиннопериодные в области 1.5 - 1.7 эВ.
В работе [7] предложено простое приближение для описания среднеполевых спектров фотоотражения:
где ![]() - энергия зондирующего излучения, Eg
– энергия фундаментального перехода, d – размерность критической точки
(в случае GaAs, для прямых межзонных переходов в центре зоны Бриллюэна d = 3
[7].), Г – феноменологический параметр уширения,
- энергия зондирующего излучения, Eg
– энергия фундаментального перехода, d – размерность критической точки
(в случае GaAs, для прямых межзонных переходов в центре зоны Бриллюэна d = 3
[7].), Г – феноменологический параметр уширения, ![]() - электрооптическая энергия:
- электрооптическая энергия:
 (3)
(3)
здесь m - приведенная межзонная эффективная масса:
 (4)
(4)
me*, mh* - эффективные массы электрона в зоне проводимости и дырки в валентной зоне, ES – напряженность встроенного электрического поля, е – заряд электрона.
Как видно из (2), положения экстремумов
осцилляций Франца-Келдыша ![]() определяются соотношением:
определяются соотношением:
Где
 (6).
(6).
Зависимость ![]() от Fj - есть прямая линия с наклоном
от Fj - есть прямая линия с наклоном ![]() и точкой пересечения оси ординат, равной Eg.
и точкой пересечения оси ординат, равной Eg.
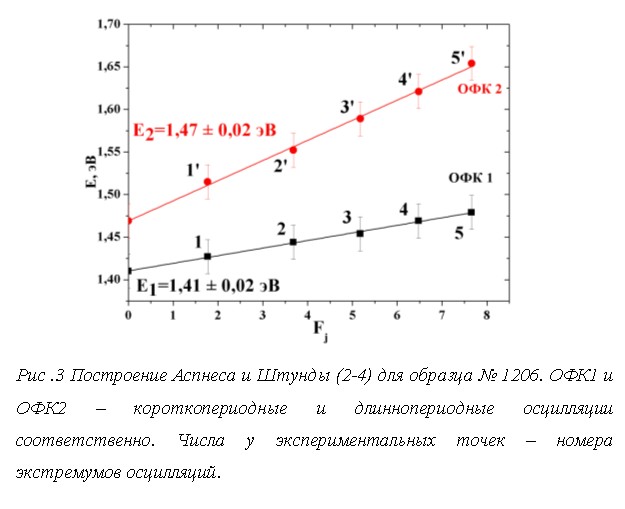
На рис. 3 приведены полученные зависимости (5) для образца № 1206, с помощью которых были вычислены напряженности встроенного электрического поля и энергии межзонного перехода, эти же параметры вычислены из спектров фотоотражения образца № 1205 (см. таблицу 1).
Из таблицы видно, что области с большей напряженностью встроенного электрического поля, соответствует большая энергия межзонного перехода, что не может быть объяснено эффектом Франца-Келдыша, согласно которому увеличение напряженности электрического поля должно приводить к уменьшению энергии перехода. Для объяснения указанных особенностей рассмотрим диаграмму зонной структуры исследуемых образцов при воздействии на них модулирующего излучения (рис. 4).
Таблица 1. Напряженности встроенного электрического поля и энергии межзонных переходов для образцов №1205 и №1206
|
Номер |
Напряженность встроенного электрического поля, кВ/см |
Энергия межзонного перехода, эВ |
||
|
ОФК1 |
ОФК2 |
ОФК1 |
ОФК2 |
|
|
1206 |
17±1 |
90±5 |
1.41±0.02 |
1.47±0.02 |
|
1205 |
32±1 |
120±5 |
1.43±0.02 |
1.47±0.06 |
При фотогенерации носителей под действием лазерного излучения, в первую очередь происходит закачка электронов в зону проводимости из под уровня Ферми в области дельта-легирования.
В результате этого, в валентной зоне и зоне проводимости образуются квазиуровни Ферми, соответствующие неравновесному распределению носителей. Дальнейшая рекомбинация носителей происходит с уровня энергии, соответствующего положению квазиуровня Ферми для электронов, на уровень энергии, соответствующий квазиуровню Ферми для дырок.
Таким образом, в данной структуре наблюдается эффект аналогичный эффекту Бурштейна-Мосса: при переизлучении электроны из зоны проводимости могут попадать на образовавшиеся дырки в валентной зоне, в этом случае энергия перехода оказывается больше ширины запрещенной зоны GaAs (1.42 эВ при комнатной температуре [8]). Данный переход соответствует области дельта легирования, то есть области с большей напряженностью встроенного электрического поля.
Заключение
Методом спектроскопии фотоотражения исследованы полупроводниковые n-i-p-i-n структуры на основе арсенида галлия с дельта-легированными слоями p-типа, применяемые для изготовления биполярных транзисторов.
В спектрах фотоотражения исследуемых образцов обнаружено два типа осцилляций Франца-Келдыша, соответствующих двум областям встроенного электрического поля: в области дельта-легирования напряженность встроенного электрического поля составляет 119 кВ/см и 96 кВ/см, в области n-GaAs 32 кВ/см и 17 кВ/см для образцов № 1205 и 1206 соответственно.
Анализ осцилляций Франца-Келдыша показал, что области с большей напряженностью встроенного электрического поля соответствует межзонный переход с большей энергией. Это связано с тем, что в области дельта-легирования межзонный переход происходит между дном зоны проводимости и уровнем энергии, положение которого определяется квазиуровнем Ферми для дырок, возникающим в результате фотогенерации носителей.
Список литеpатуpы
1. Херман М. Полупроводниковые сверхрешетки. М.:Мир. 1983.
2. Sciana B., Sek G., Misiewicz J. Et al. // Materials science-Poland. 2008. 26. P. 71.
3. Harris J.J. // J. Mat. Scie.: materials and electronics. 1993. 4. p. 93.
4. Cechaviius B., Kavaliauskas J., Krivaite G. et al. // Physica status solidi (c) 2007. 204. p. 412.
5. Авакянц Л.П., Боков П.Ю., Червяков А.В. // ЖТФ 2005. 75. с. 66Kavaliauskas J.; Krivaite G. // Physica status solidi. 2008. 245 p. 82.
6. Alperovich V.L.. Jaroshevich A.S., Scheibler H.E. et al. // Sol. St. Electr. 1994. 37. p. 657.
7. Aspnes D.E., Shtudna A.A. // Phys Rev B. 1973. 7. p. 4605.

 (2)
(2)