УДК 621.38-022.532
Изучение влияния дефектов в зародышевых слоях AlGaN на утечки в гетероструктурах для транзисторов с высокой подвижностью электронов
А. А. Андреев 1, Ю. В. Грищенко 1, И. С. Езубченко 1, М. Л. Занавескин 1, И. О. Майборода 1, М. А. Рудик 1, Ю. В. Федоров 2
1 Национальный исследовательский центр «Курчатовский институт»
2 Федеральное государственное бюджетное учреждение науки Институт сверхвысокочастотной полупроводниковой электроники Российской академии наук
Статья получена 24 декабря 2014 г.
Аннотация. Исследован вопрос улучшения морфологии рельефа зародышевых слоев нитридных гетероструктур на подложках сапфира, выращиваемых методом аммиачной молекулярно-лучевой эпитаксии, для транзисторов с высокой подвижностью электронов (ТВПЭ). Установлено, что при осаждении высокотемпературных слоев AlGaN, в отличие от AlN, галлий может выступать в качестве автосурфактанта, способствуя установлению двумерного режима роста. Показано, что использование зародышевых слоев с улучшенной морфологией поверхности позволяет снизить токи утечек в гетероструктурах для ТВПЭ на несколько порядков. На основе гетероструктуры с минимальными токами утечек изготовлены тестовые транзисторы с длиной затворов LG=0,15 мкм, демонстрирующие Ft до 71 ГГц и Fmax до 172 ГГц, что приближается к результатам, полученным на гетероструктурах, выращенным методом газофазной эпитаксии (MOCVD).
Ключевые слова: аммиачная МЛЭ, транзисторы с высокой подвижностью электронов, GaN, AlGaN, зародышевые слои.
Abstract. The issue of improving the morphology relief of the nucleation layers of the nitride heterostructure on sapphire substrates grown by ammonia MBE, for high electron mobility transistors (HEMT), was investigated. It was found that during deposition of high temperature layer of AlGaN unlike AlN, gallium can act as autosurfactant , promoting to establishment of the two-dimensional growth mode. It was shown that use of nucleation layer with improved morphology of the surface can reduce leakage currents on several orders of magnitude in heterostructure for HEMT. On the basis of heterostructure with minimal leakage currents, the test transistors with a gate length LG = 0,15 µm, showing Ft up to 71 GHz and Fmax up to 172 GHz, which is close to the results obtained in the heterostructures grown by chemical vapor deposition (MOCVD), were produced.
Key words: ammonia MBE, high electron mobility transistors, GaN, AlGaN, nucleation layers.
Введение
Благодаря своим уникальным свойствам нитриды галлия, алюминия, индия и их твердые растворы на данный момент являются наиболее подходящими материалами для изготовления транзисторов с высокой подвижностью электронов, сочетающих в себе высокие рабочие частоты и высокие удельные мощности [1]. Наличие в данных материалах эффектов спонтанной и пьезоэлектрической поляризаций приводит к возникновению двумерного газа электронов на гетерогранице GaN/AlGaN, который может выступать в качестве проводящего канала полевого транзистора.
На сегодняшний день для роста гетероструктур нитридов наиболее активно используются несколько методов: химическое осаждение из газовой фазы (MOCVD), молекулярно-лучевая эпитаксия с плазменной активацией азота (PAMBE) и аммиачная молекулярно-лучевая эпитаксия (NH3 MBE, аммиачная МЛЭ). Аммиачная МЛЭ объединяет в себе ряд преимуществ MOCVD и PAMBE [2]. Условия высокого вакуума обеспечивают низкую концентрацию примесей, рост структур с резкими гетерограницами, а также делают возможным использование дифракции быстрых отраженных электронов (RHEED) и квадрупольного масспектрометра во время ростового процесса. В качестве источника азота в аммиачной МЛЭ выступает аммиак, что позволяет проводить осаждение в широком диапазоне ростовых параметров, в то время как в PAMBE использование плазменного источника налагает сильные ограничения на потоки веществ и температуру подложки. Вместе с тем, условия осаждения нитридных пленок при аммиачной эпитаксии оказываются существенно отличными от других методов. Как следствие, гетероструктуры имеют высокую плотность проникающих дислокаций порядка 1010 на см2 и развитую морфологию рельефа пленок [3]. Несмотря на высокие значения концентрации и подвижности электронов в двумерном газе структур, получаемых аммиачной эпитаксией, пока что в публикациях не сообщалось о приборах, способных работать за пределами Х-диапазона [4]. В то же время на структурах, полученных методом MOCVD, успешно преодолен порог 100 ГГц [5]. Ясно, что параметры приборов на структурах полученных аммиачной эпитаксией ограничиваются качеством выращиваемых пленок. Таким образом, задача создания гетероструктур удовлетворительного качества для транзисторов с высокой подвижностью электронов методом аммиачной МЛЭ остается актуальной.
Возможный путь решения данной проблемы дают результаты исследования морфологии рельефа зародышевых слоев, используемых при росте структур. Так в работе [6] показано, что поверхность зародышевых слоев AlN, выращенных на подложках сапфира, содержит большое число островковых образований (более 109 на см2). Подобные особенности морфологии могут приводить к образованию дефектов кристаллической структуры в последующих слоях. Известно, что проникающие дислокации создают ловушки для электронов [7] и могут выступать как каналы утечек тока [8]. Полагая, что рельеф зародышевых пленок оказывает значительное влияние на образование дислокаций и возникновение каналов проводимости, мы в данной работе исследовали возможность снижения токов утечки в нитридных гетероструктурах за счет улучшения морфологии рельефа высокотемпературных зародышевых слоев AlN и AlGaN.
Зародышевые слои AlN на подложках сапфира
При росте нитридных гетероструктур на сапфировых подложках в качестве зародышевого слоя может быть использован AlN. Нитрид алюминия имеет значительно более высокую температуру разложения в вакууме по сравнению с GaN, что позволяет производить рост его пленок с низкими потоками аммиака при температурах выше 1000˚С. Высокая температура осаждения способствует росту более совершенных кристаллических слоев AlN на подложках сапфира, однако на их поверхности присутствует большое число (более 109 на см2) островковых образований [6]. Природа данных образований не совсем ясна. Они могут представлять собой выходы дислокаций [9], области инвертированной полярности [10], или же быть следствием того, что рост проходит по смешанному островково-послойному механизму Странского-Крастанова. В работе [6] показано, что плотность островков может быть значительно уменьшена за счет осаждения 1-2 монослоев Al с последующей нитридизацией. Это косвенно указывает на то, что островки зарождаются на границе раздела сапфира с AlN. Возможно, осаждение при большей температуре подложки могло бы помочь в получении более однородной морфологии рельефа за счет изменения кинетики адатомов, но этот путь представляется проблематичным, т.к. для большинства установок МЛЭ температуры нагрева подложки по технологическим причинам не могут превышать 1100-1200˚С.
Известно, что изменение режима роста пленки может быть достигнуто с помощью использования активных примесей - сурфактантов. Вещество сурфактант, присутствуя на поверхности растущей пленки, меняет кинетику адатомов, увеличивая их поверхностную подвижность, но при этом почти не встраивается в объем пленки [11]. В ряде исследований было показано, что галлий может выступать в качестве сурфактанта при осаждении пленок AlN методом MOCVD [12]. Так же в PAMBE широко используется осаждение пленок GaN в избытке галлиевой компоненты [13]. В этом случае избыточные атомы Ga на поверхности способствуют установлению двумерного режима роста, т.е. оказывают эффект аналогичный действию сурфактанта. При этом галлий все же является одной из составных компонент пленки GaN, а значит не соответствует определению сурфактанта, в связи с чем, при описании данного явления для галлия используется термин автосурфактант [14]. По нашим данным, в публикациях на текущий момент сообщения об использовании Ga в качестве сурфактанта при росте AlN или автосурфактанта при росте AlGaN отсутствуют. В данной работе мы проверили возможность использования избыточного потока галлия при росте зародышевых слоев AlGaN на подложках сапфира при температурах выше 1000˚С для улучшения морфологии осаждаемых пленок.
Методика эксперимента
Гетероструктуры были выращены на подложках сапфира (0001) в установке аммиачной молекулярно-лучевой эпитаксии Semiteq STE3N*. Обратная сторона подложек покрывалась слоем титана толщиной 300 нм для обеспечения радиационного нагрева. Контроль температуры подложки осуществлялся с помощью однолучевого инфракрасного пирометра. Перед ростом подложки подвергались термическому отжигу в условиях высокого вакуума в течение часа при температуре 850˚С с последующей нитридизацией в потоке аммиака в течение 10 мин. Осаждение пленок происходило в условиях избыточного потока аммиака. In-situ наблюдение за процессом роста производилось с помощью дифракции быстрых отраженных электронов (RHEED) и лазерного интерферометра. Для характеризации рельефа полученных пленок использовалась атомно-силовая микроскопия (АСМ). Электрофизические параметры двумерного проводящего канала гетероструктур (холловская подвижность и концентрация носителей) были измерены четырехзондовым методом Ван-дер-Пау.
Рост зародышевых слоев
На рисунках 1 и 2 приведены АСМ изображения осажденных на сапфировую подложку пленок AlN и AlGaN соответственно. Слой AlN толщиной 200 нм был выращен при температуре 1100˚С. На поверхности наблюдается высокая плотность островков диаметром несколько десятков нанометров. Плотность покрытия поверхности островками составила порядка 109-1010 на см2, в зависимости от выбора участка поверхности. Дифракционная картина RHEED для данного образца представляла собой суперпозицию линий и точечных рефлексов, что соответствует гладкой фоновой составляющей рельефа и трехмерным островкам. Как было отмечено в работе [6], подобная картина наблюдается для пленок толще 100 нм и слабо зависит от условий нитридизации.
Пленка AlGaN толщиной 300 нм была выращена при температуре подложки 1050˚С. После нитридизации и установления ростовой температуры подложки на ее поверхность были одновременно поданы потоки галлия, алюминия и аммиака. Соотношение потоков галлия и алюминия составляло 3:2. В течение 8 минут после начала осаждения на дифракционной картине исчезли точечные рефлексы, что свидетельствует о переходе к двумерному росту. Как видно из приведенных на рисунке 2 АСМ изображений на поверхности пленки AlGaN количество островков значительно снижено по сравнению с образцом AlN до 107 на см2. Важной особенностью рельефа пленки AlGaN является наличие атомарно гладких ступеней шириной до микрона и более, что свидетельствует о высокой подвижности адатомов на поверхности образца. Угол наклона поверхности ступеней по отношению к плоскости образца составляет порядка 0,2 градуса, что совпадает с углом среза поверхности подложки по отношению к плоскости (0001) сапфира. Исследование полученной пленки AlGaN с помощью метода дифракции рентгеновских лучей позволило установить, что мольная доля галлия в ней составила порядка 0,17. Сопоставление данного числа с заданным в ходе роста соотношением потоков Ga и Al показывает, что в кристалл встроилось менее 40% поступавшего на поверхность галлия.

Рис.1. АСМ изображение слоя AlN на сапфире.

Рис.2. АСМ изображение слоя AlGaN на сапфире.
Таким образом, за счет роста AlGaN при температуре, значительно превышающей температуру начала разложения GaN, удалось добиться быстрого перехода в двумерный режим роста, о чем свидетельствуют широкие (до 1 мкм и более) атомарно-гладкие ступени. Так же достигнуто снижение плотности островковых образований по сравнению с пленкой AlN на два порядка: с 109 до 107 на см2. Быстрый переход к двумерному режиму роста и наличие широких атомарно гладких ступеней свидетельствуют об увеличении поверхностной подвижности адатомов за счет избыточного потока галлия, поступающего на поверхность. На основании полученных результатов можно заключить, что при осаждении высокотемпературного слоя AlGaN галлий выступал в качестве автосурфактанта.
Гетероструктуры
На основе зародышевых слоев AlN и AlGaN были выращены образцы гетероструктур С1 и С2 соответственно. Зародышевые слои AlN и AlGaN были осаждены согласно процедурам, описанным выше. Далее были сформированные буферные слои AlGaN, состоящие из первого градиентного слоя с плавным падением доли алюминия до 40%, слоя с постоянной долей Al 40% и второго градиентного слоя, в котором доля алюминия была плавно снижена до нуля. Общая толщина буферной конструкции составила 0,5 мкм. Далее было произведено выращивание 0,5 мкм GaN и барьерных слоев AlN/AlGaN/GaN с толщиной AlN 1 нм, AlGaN 10 нм (мольная доля алюминия 45%) и GaN толщиной 2 нм.
Измерение электрофизических параметров двумерного газа электронов дало значение подвижности электронов 1250 см2/В*с и 1600 см2/В*с в образцах С1 и С2 соответственно, слоевая концентрация носителей в обоих образцах составила 1,7*1013 см-2.
Для оценки изолирующих свойств структур на них были сформированы меза-изоляция и невжигаемые омические контакты [15]. Измерение утечек производилось на тестовых структурах с периферией 0,5 мм. Значение токов утечек на образце С1 при напряжении 50 В составило более 1 мА. Для образца С2 максимальные утечки по пластине при 50 В не превышали 10 мкА.
Таким образом, для образца С2 с зародышевым слоем AlGaN токи утечек в глубоких слоях оказались более чем на два порядка ниже, чем для С1. Данный результат позволяет сделать вывод о значительном влиянии морфологии зародышевого слоя на величину токов утечек. Вместе с тем вопрос о том, каким образом наличие островков на поверхности зародышевых слоев приводит к возникновению утечек в буферных слоях остается открытым.
Транзистор на основе гетероструктуры
На образце С2 с высокотемпературным зародышевым слоем AlGaN были сформированы тестовые транзисторы с грибообразными затворами Ni/Au с длиной основания (LG) и высотой ножки 0,15 и 0,3 мкм соответственно. Расстояние исток-сток составляло 4 мкм, затвор был смещен к истоку на 0,3 мкм. Полная периферия тестового транзистора составляла 100 мкм (WG=2х50 мкм). Ввиду наличия высоких токов утечки на образце С1, с зародышевым слоем AlN, он не использовался для изготовления транзисторных структур.
Вольт-амперные характеристики одного из тестовых транзисторов представлены на рисунке 3. Видно, что начальный ток насыщения транзистора Ids0 достигает 1,2 А/мм, а максимальная крутизна – 350 мСм/мм.
Измерение затворных ВАХ (рисунок 4) показали наличие повышенного тока утечки затвора, достигающего 170-180 мкА/мм при напряжении сток-затвор 23 В. Это ограничивает область рабочих напряжений транзисторов величиной около 15-20 В, что недостаточно для применения их в усилителях мощности. По–видимому, это является следствием недостатков технологии выращивания буферного слоя, отмеченных выше.
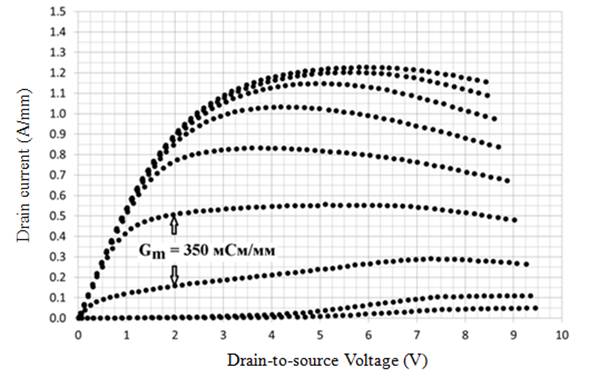
Рисунок 3. Вольт-амперные характеристики тестового
транзистора с WG=2x50 мкм.
Напряжение затвор-исток изменялось от 1 В
с шагом -1 В.

Рисунок 4. Зависимость обратного тока утечки затвора транзистора от напряжения между стоком и затвором.
Результаты измерения СВЧ характеристик одного из тестовых транзисторов в диапазоне частот 0,1-67 ГГц, выполненные с помощью векторного анализатора E-8351A фирмы Agilent technologies, приведены на рисунке 5. Аппроксимация частотных зависимостей H21 и U-Gain дает значения для граничной частоты усиления по току Ft около 70,5 ГГц, а для граничной частоты усиления по мощности Fmax около 172 ГГц (рисунок 5). Величины граничных частот усиления по току Ft тестовых транзисторов по пластине варьировались в диапазоне 63-71 ГГц, что свидетельствует о высокой однородности гетероструктуры и технологического процесса.
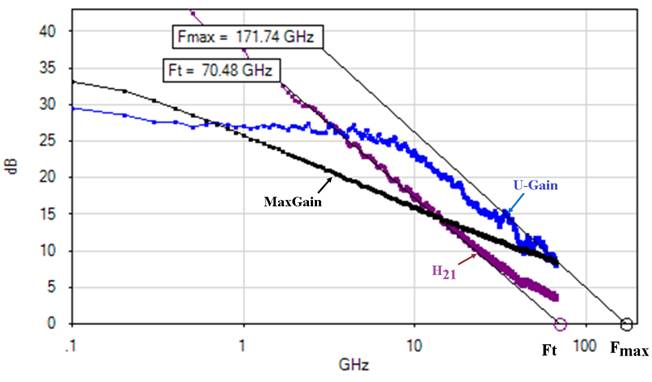
Рисунок 5. СВЧ параметры тестового транзистора с WG=2x50 мкм
Следует отметить наличие петли гистерезиса на затворной ВАХ транзисторов (рисунок 4) и временные флуктуации СВЧ параметров транзисторов, наблюдавшиеся при их измерениях (рисунок 5). Вероятно, это также является следствием наличия электронных ловушек в буферном слое гетероструктуры С2.
Как указано в обзоре [16], в структурах, выращиваемых методом аммиачной МЛЭ выявлено несколько типов объемных дефектов с энергетическими уровнями в запрещенной зоне, и природа некоторых из них еще не выяснена. Результаты проведенного исследования показывают, что количество островковых образований на поверхности зародышевых слоев влияет на токи объемных утечек, и, возможно, приводит так же к возникновению затворных утечек. Скорее всего, образования на поверхности зародышевых слоев связаны с проникающими дислокациями, которые выступают в качестве каналов проводимости. Таким образом, дальнейшие исследования, направленные на улучшение морфологии начальных слоев роста пленок нитридов, могут помочь в достижении высокого качества аммиачных структур для приборов на основе нитридов.
Заключение
Проведенные исследования по оптимизации процессов роста зародышевых слоев нитридных гетероструктур на подложках из сапфира, выращенных методом аммиачной МЛЭ, позволили установить, что при росте высокотемпературного зародышевого слоя AlGaN галлий может выступать в роли автосурфактанта, что позволяет снизить плотность островковых образований на поверхности зародышевого слоя по сравнению со стандартными высокотемпературными слоями AlN. Использование зародышевых слоев с меньшей плотностью островковых образований в качестве основы при росте гетероструктур для ТВПЭ позволило снизить токи утечек в глубоких слоях структуры на несколько порядков, что свидетельствует о правильности направления исследований. В результате СВЧ параметры тестовых транзисторов (Ft = 71 ГГц и Fmax = 172 ГГц) на гетероструктурах с зародышевым слоем AlGaN, выращенных методом аммиачной МЛЭ в настоящей работе, впервые приблизились к соответствующим СВЧ параметрам, характерным для HEMT на гетероструктурах, выращенных методом газофазной эпитаксии. Однако наблюдаемое наличие значительных токов утечек затворов транзисторов и временной нестабильности их статических и СВЧ параметров пока еще ограничивают область применения аммиачных гетероструктур и свидетельствует о необходимости дальнейшего улучшения технологии их роста.
Литература
1. Ю. Федоров. Широкозонные гетероструктуры (Al, Ga, In)N и приборы на их основе для миллиметрового диапазона длин волн // Электроника НТБ, № 2 (2011)
2. Stephen W. Kaun et al. Molecular beam epitaxy for high-performance Ga-face GaN electron devices // Semicond. Sci. Technol., №28 (2013), p. 074001
3. Corrion A.L., Poblenz C., Wu F. and Speck J.S. Structural and morphological properties of GaN buffer layers grown by ammonia molecular beam epitaxy on SiC substrates for AlGaN/GaN high electron mobility transistors // J. Appl. Phys., 103 (2008), p. 093529
4. Christiane Poblenz et al. Power Performance of AlGaN/GaN HEMTs Grown on SiC by Ammonia-MBE at 4 and 10 GHz // IEEE ELECTRON DEVICE LETTERS, VOL. 28, NO. 11, NOVEMBER 2007
5. M.Higashiwaki et al. Millimeter-wave GaN HFET technology // Proc. SPIE, Gallium Nitride Materials and Devices III, vol. 6894 (2008), 68941L
6. V.G.Mansurov et al. AlN growth on sapphire substrate by ammonia MBE // Journal of Crystal Growth, 300 (2007), pp. 145–150
7. D. Chernsand, C. G. Jiao. // Phys. Rev. Lett., 87 (2001), p. 205504
8. J. W. P. Hsu et al. Direct imaging of reverse-bias leakage through pure screw dislocations in GaN films grown by molecular beam epitaxy on GaN templates // Appl. Phys. Lett., Vol. 81, N. 1, 2002
9. W. Qianetal. Open-core screw dislocations in GaN epilayers observed by scanning force microscopy and high-resolution transmission electron microscopy // Appl. Phys. Lett., Vol. 67, N. 16, 1995
10. J. Jasinskietal. Inversion domains in AlN grown on (0001) sapphire // Appl. Phys. Lett., 83 (2003), p. 2811
11. Zahl P., Kury P. Horn-von Hoegen M., Interplay of surface morphology, strain relief, and surface stress during surfactant mediated epitaxy of Ge on Si // Appl. Phys. A., Vol. 69, N. 5, 1999, pp. 481–488
12. T. M. Altahtamouni, J. Li, J.Y. Lin and H.X. Jiang. Surfactant effects of gallium on quality of AlN epilayers grown via metal-organic chemical-vapour deposition on SiC substrates // J. Phys. D: Appl. Phys., 45 (2012), p. 285103
13. E. J. Tarsa, B. Heying, X. H. Wu, P. Fini, S. P. DenBaars, and J. S. Speck. Homoepitaxial growth of GaN under Ga-stable and N-stable conditions by plasma-assisted molecular beam epitaxy // J. Appl. Phys., Vol. 82, N. 11, 1997
14. S. T. King, M. Weinert, and L. Li. Atomistic View of the Autosurfactant Effect during GaN Epitaxy // Phys. Rev. Lett., 98 (2007), p. 206106
15. Майборода И.О., Андреев А.А., Перминов П.А., Aедоров Ю.В., Занавескин М.Л. Селективный рост невжигаемых омических контактов к двумерному электронному газу в транзисторах с высокой подвижностью электронов на основе гетеропереходов GaN/AlGaN методом молекулярно-пучковой эпитаксии // ПЖТФ, том 40, выпуск 11, 2014, сc. 80-86
16. Rathnait D. Long and Paul C. McIntyre. Surface Preparation and Deposited Gate Oxides for Gallium Nitride Based Metal Oxide Semiconductor Devices // Materials, 5 (2012), pp. 1297-1335