УДК 537.312.7
ПРОТОТИП МЕМРИСТОРНОЙ ЯЧЕЙКИ НА ОСНОВЕ МДМ СТРУКТУР С ИСПОЛЬЗОВАНИЕМ ДИЭЛЕКТРИЧЕСКОЙ ПЛЕНКИ HfxAl1-xOy С ПЕРЕМЕННЫМ СОСТАВОМ
А. А. Чуприк1,
А.
С. Батурин 1, К. В. Булах
1, К. В. Егоров 1,
А. А. Кузин 1, Д. В. Негров
1, С. А. Зайцев 1, А. М. Маркеев
1,
Ю.
Ю. Лебединский 3,1,
Е. С. Горнев 2,1, О. М. Орлов
2,1, А. В. Заблоцкий 1
1 Московский
физико-технический институт (государственный университет)
2 Научно-исследовательский институт молекулярной электроники
3 Научно-исследовательский ядерный университет «МИФИ»
Получена 17 июня 2013 г.
Аннотация. Изготовлены и исследованы с точки зрения функциональности структуры, являющиеся прототипом ячеек энергонезависимой памяти на эффекте резистивного переключения в оксидных плёнках HfxAl1-xOy с переменным (по глубине) содержанием Al. Изготовленные структуры моделируют размещение ячеек энергонезависимой памяти между слоями металлизации интегральных схем. Полученные функциональные параметры ячеек в части снижения напряжения записи и повышения скорости записи информации существенно превосходят параметры традиционной флэш-памяти.
Ключевые слова: эффект резистивного переключения, атомно-слоевое осаждение, энергонезависимая память, оксид гафния, ReRAM.
Abstract. Prototype
of non-volatile resistive switch memory cell based on MIM-structures using gradient HfxAl1-xOy
as insulator layer was produced and its functional properties was
investigated. These structures imitate placing of memory cells at metallization
layers. Its rewrite voltage is considerably lower and its rewrite speed is considerably
faster then as compared with traditional flash-memory cell.
Keywords: resistive switch effect, atomic layer deposition, non-volatile
memory, hafnium oxide, ReRAM.
1. Введение
В мире в настоящее время существует несколько разработанных, либо перспективных технологий изготовления устройств энергонезависимой памяти. Стоит упомянуть такие концепции, как сегнетоэлектрическая память (FeRAM) [1], память на эффекте момента вращения спина (STT-MRAM) [2], магниторезистивная память (MRAM) [3], память на основе изменения фазового состояния вещества (PCM) [1], резистивная память (ReRAM) [4]. Естественно, основной работающей технологией в данной области остается флэш память (EEPROM – Electrically Erasable Programmable Read-Only Memory) Данная технология позволяет относительно легко повышать плотность записи информации и снижать стоимость единицы объема памяти. Однако начинают ощущаться присущие флэш технологии недостатки [5]. К присущим флэш технологии ограничениям можно отнести напряжение записи-перезаписи 10-15 В, что приводит к повышенному потреблению энергии и нагреву; низкую скорость записи-перезаписи 100 нс - 1 мкс; ограниченное число циклов записи 104-105 раз; большая площадь ячейки памяти. Также ожидается, что в течении ~5 лет будет исчерпана возможность увеличения плотности упаковки элементов в традиционной технологии флэш из-за физических ограничений (при характерном размере 16 нм и меньше), в частности, в силу ограничения возможности хранения заряда плавающего затвора величиной несколько элементарных зарядов.
Среди перечисленных концепций энергонезависимой памяти одной из наиболее перспективных является резистивная память с произвольным доступом (Resistive Random Access Memory – ReRAM) [2]. ReRAM основана на эффекте резистивного переключения, характеризующегося обратимым изменением электрического сопротивления элемента структуры в зависимости от воздействующего на него электрического поля [6]. Элемент ReRAM обычно представляет собой структуру металл-диэлектрик-металл (МДМ), при этом МДМ-структура может находиться в высокоомном (состояние OFF, ROFF) или низкоомном (состояние ON, RON) состоянии. На сегодняшний день рассматриваются два основных механизма, объясняющих резистивное переключение: электродиффузия атомов металла электродов с образованием проводящих металлических мостиков в так называемых ячейках с программируемой металлизацией на основе твердых электролитов; образование и дрейф вакансий кислорода в структурах с диэлектриком на основе оксидов переходных металлов.
Элемент ReRAM имеет упрощенную по сравнению с флэш памятью структуру, что позволило достичь на данный момент минимального размера топологических элементов до 9 нм [7], а прогноз уровня миниатюризации составляет 5 нм [5]. Также ReRAM технологию отличает низкая стоимость на бит, малое напряжение при записи-перезаписи (1...1,6 В) и, соответственно, малое энергопотребление – менее 1 пДж [7] на акт записи-перезаписи, высокая скорость записи-перезаписи (менее 10 нс [8]), большая продолжительность использования (число циклов записи-перезаписи до 1012 [9]), длительное время хранения информации (более 10 лет), а также возможность трехмерной интеграции, в частности, возможность размещения ячеек памяти между слоями металлизации. В данной работе была поставлена задача изготовления и исследования функциональности прототипа ячеек ReRAM, моделирующего размещение ячеек памяти между слоями металлизации интегральных схем.
2. Проведение эксперимента
Схема прототипа ячейки энергонезависимой памяти с резистивным механизмом переключения ReRAM приведена на рисунке 1. МДМ-структура представляла собой набор последовательных слоев, включающий слой HfAlO, заключенный между слоями Pt и TiN. Структура располагалась на слое изолятора из термического SiO2 в окне диэлектрика SiNx, осажденного методом PECVD. Такая конструкция имитирует размещение ячеек памяти между слоями металлизации интегральных схем.
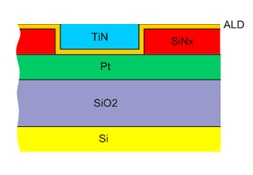
Рис. 1. Поперечное сечение прототипа ячеек ReRAM со схематичным расположением слоев: желтый – кремний; серый – оксид кремния (SiO2) 200-300 нм; зеленый – нижний электрод из платины (Pt) 100-150 нм; красный – PECVD нитрид кремний (SiNx) 100-150 нм; оранжевый – функциональная АСО пленка HfAlO (ALD) 6 нм; голубой – верхний электрод из нитрида титана (TiN) 100-150 нм; фиолетовый – контактные площадки из золота для бондинга (Au) 100-200 нм.
Нижний электрод МДМ-структуры из Pt формировался методом электронно-лучевого напыления, контактные площадки из Au изготавливались методом электронно-лучевого напыления с использованием жесткой маски; верхний электрод из TiN – методом реактивного магнетронного распыления с использованием жесткой маски. Окна в слое диэлектрика SiNx, предназначенные для размещения запоминающих ячеек изготавливались методом плазмохимического травления в установке Corial 100I в атмосфере SF6 с использованием маски из резиста PMMA A4 изготовленной методом электронной литографии. Латеральные размеры ячеек составляли от 80 нм до 450 нм. Слой функционального диэлектрика HfxAl1-xOy с переменным (по глубине) содержанием Al был выращен методом атомно-слоевого осаждения в реакторе Sunale R-150 Picosun OY c горячими стенками при пониженном давлении (5 мбар) и температуре подложек 240oC. Переменная концентрация Al по глубине пленки была получена за счет организации процесса атомно-слоевого осаждения в виде шести реакционных серий суперциклов с различным отношением числа n циклов Al(CH3)3 – H2O и числа m циклов Hf[N(CH3)(C2H5)]4 – H2O.
Квазистатические вольт-амперные характеристики (ВАХ) прототипов ячеек ReRAM были получены при комнатных условиях с помощью характериографа Agilent B1500A. В процессе измерений напряжение прикладывалось к TiN электроду, при этом Pt электрод был заземлен. Тесты на деградацию функциональных свойств проводились в импульсном режиме. Длительность импульсов составляла 1 мкс, амплитуда импульсов была равной VSET = 1,7 В и VRESET = -2 В для акта включения и выключения соответственно. Считывание текущего значения тока осуществлялось при Vread = -0.1 В.
Результаты и их обсуждение
Типичный вид полученных в работе квазистатических вольт-амперных характеристик прототипов ячеек ReRAM приведен на рисунке 2. Значения напряжения записи информации (SET) VON лежали в диапазоне 0.75 В…1.9 В. Среднее напряжение записи составляло VON = 1.7 В. Значения напряжения перезаписи (RESET) составляли VOFF = -1.0 В…-2 В. Среднее напряжение перезаписи составляло VOFF = -1.6 В. Сопротивление МДМ-структур оценивалось при напряжении чтения Vread от -0,5 В до 0,2 В. Были получены значения отношения сопротивлений в высокоомном и низкоомном состоянии ROFF/RON в среднем от 15 до 30, в отдельных случаях отношение сопротивлений достигало значений 50-120.
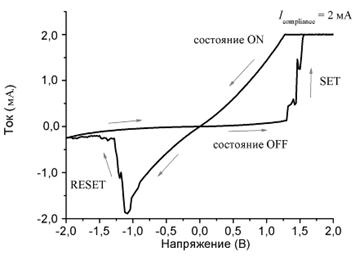
Рис. 2. Типичный вид вольт-амперных характеристик
Исходное состоянием МДМ-структур после изготовления соответствовало состоянию ячейки “ON”, т.е. было низкоомным. Для приведения таких структур в стабильное рабочее состояние проводилась формовка отрицательным импульсом напряжения Vф = -2 В. После этого структуры демонстрировали петли резистивного переключения, представленные на рисунке 2. При этом Vф = VOFF, т.е. можно считать, что специальной операции формовки не требуется, т.к. процедура формовки не отличается от стандартного цикла записи информации в ячейку. Симметричный вид полученных биполярных ВАХ может быть интерпретирован исходя из механизма формирования в диэлектрике клиновидного проводящего канала из вакансий кислорода [6].
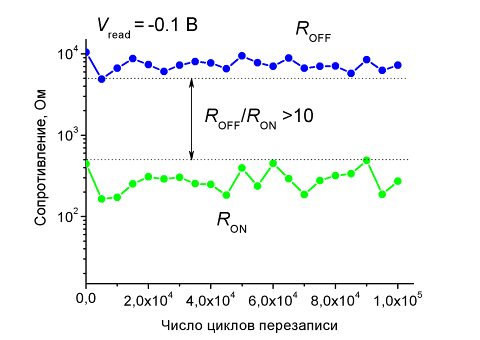
Рис. 3. Результаты теста на деградацию при 105 циклах переключения
Тесты на деградацию функциональных свойств прототипов ячеек ReRAM резистивного переключения показали, что, несмотря на относительно большой разброс сопротивлений в состояниях ON и OFF, через 105 циклов перезаписи при длительности управляющих импульсов 1 мкс структуры остаются в рабочем состоянии (см. рис. 3). Оценка скорости переключения состояния также была проведена в импульсном режиме путем уменьшения длительности управляющих импульсов. Установлено, что при минимально возможной для применяемого измерительного стенда длительности импульса в 50 нс ячейки стабильно переходят из низкоомного состояния в высокоомное и обратно.
Заключение
В представленной работе изготовлены и исследованы структуры ReRAM МДМ типа вида Pt/ HfxAl1-xOy / TiN. Полученные структуры являются прототипами ячеек памяти, размещенных между слоями металлизации интегральных схем, кремниевая подложка использована в данном случае только для механической жесткости. Достигнутые функциональные параметры ячеек в части снижения напряжения записи и повышения скорости записи информации существенно превосходят параметры традиционной флэш-памяти (см. таблицу 1).
Таблица 1 − Сравнение функциональных параметров полученных прототипов ReRAM и флэш-памяти
|
|
Флэш-память[2],[8] |
Прототип ячеек ReRAM Pt/ HfxAl1-xOy / TiN |
|
|
|
NOR |
NAND |
Результат |
|
Размер элемента, F |
90 нм |
22 нм |
80-450 нм |
|
Напряжение записи |
10 В |
15 В |
0,75-2 В |
|
Напряжение чтения (считывания) |
1,8 В |
1,8 В |
0,1-0,5 В |
|
Скорость записи |
10 мс - 1 мкс |
100 мкс |
< 50 нс |
|
Число циклов перезаписи |
105 |
104 |
>105 |
Благодарности
Научные исследования проводились при финансовой поддержке Министерства образования и науки Российской Федерации в рамках реализации федеральной целевой программы «Научные и научно-педагогические кадры инновационной России» на 2009-2013 годы (Соглашение №14.A18.21.1854 от 04 октября 2012 г.) и федеральной целевой программы «Исследования и разработки по приоритетным направлениям развития научно-технологического комплекса России на 2007—2013 годы» с использованием оборудования Центра коллективного пользования МФТИ (ГК № 16.552.11.7070).
1. H. Ishiwara, Ferroelectric Random Access Memories // Journal of Nanoscience and Nanotechnology. 2012, Vol. 12, P. 7619, DOI:10.1166/jnn.2012.6651
2. J.A. Katine, E. E. Fullerton Device implications of spin-transfer torques // Journal of Magnetism and Magnetic Materials. 2008, V. 320, I.7, P. 1217, DOI: 10.1016/j.jmmm.2007.12.013
3. S. Tehrani, JM. Slaughter, M. Deherrera, et al. Magnetoresistive random access memory using magnetic tunnel junctions // Proceedings of the IEEE. 2003, V. 91, I.5, P.7. DOI: 10.1109/JPROC.2003.811804
4. H.P. Wong, S. Raoux, SB Kim et al. Phase Change Memory // Proceedings of the IEEE. 2010, V. 98, I. 12, P. 2201-2227 DOI: 10.1109/JPROC.2010.2070050
5. International Technology Roadmap of semiconductors. Редакция 2011 г. http://www.itrs.net/
6. J. J. Yang, D. B. Strukov and D. R. Stewart, Memristive devices for computing // Nature Nanotechnology. 2013, V. 8, pp. 13-24.
7. C-H. Ho, Ch-L. Hsu, Ch-Ch. Chen et al. 9nm half-pitch functional resistive memory cell with <1µA programming current using thermally oxidized sub-stoichiometric WOx film // IEDM. 2010, 19.1.1 - 19.1.4
8. H.Y. Lee, Y.S. Chen, P.S. Chen, et al. Evidence and solution of over-RESET problem for HfOX based resistive memory with sub-ns switching speed and high endurance // IEDM. 2010, 19.7.1 - 19.7.4
9. M-J. Lee, Ch. B. Lee, D. Lee et al. A fast, high-endurance and scalable non-volatile memory device made from asymmetric Ta2O5−x/TaO2−x bilayer structures // Nature Materials. 2011, V. 10, pp. 625-630.