Повреждения интегральных микросхем в полях радиоизлучения
Ю. А. Пирогов 1 , А. В. Солодов 2
1 Московский государственный университет имени М.В. Ломоносова, физический факультет
2 Московский радиотехнический институт Российской академии наук
Получена 21 июня 2013 г.
Аннотация. Рассмотрены возможные механизмы, вызывающие деградацию и катастрофические отказы микросхем в полях мощного радиоизлучения. Проанализированы результаты экспериментальных исследований и модели, используемые для анализа механизмов повреждения современных интегральных микросхем при воздействии радиоизлучения.
Ключевые слова: деградация, повреждение, интегральные микросхемы, радиоизлучение.
Abstract. The possible mechanisms causing degradation and catastrophic failures of microcircuits in electromagnetic fields of powerful RF pulses are considered. Results of experimental researches and the damage mechanism models are analyzed for the modern integral microcircuits under influence of RF pulses.
Keywords: degradation, damage, failure, integral microcircuits, RF pulses.
Введение
В настоящее время практически в любой электронной аппаратуре (ЭА) используются интегральные микросхемы (ИМС). С повышением степени интеграции современной микроэлектроники, миниатюризацией элементной базы, созданием многофункциональных ИМС все больший интерес приобретают вопросы защиты ЭА от влияния электромагнитных помех. Аппаратура в процессе своей работы, может подвергаться воздействию различных интенсивных внешних электромагнитных помех, влияющих на ее функциональное состояние. Устойчивая работа ЭА может быть гарантирована только при безотказном функционировании ее элементов - диодов, транзисторов, ИМС и др., работа которых рассчитывается для нормального режима.
В этой связи изучение физических механизмов, нарушающих работу элементной базы микроэлектроники (в частности ИМС) в полях радиоизлучения, является актуальным.
Исследованиям воздействия импульсных электромагнитных полей на микросхемы посвящено большое количество работ. Многие специалисты сводят воздействие электромагнитных полей на элементы ЭА к подаче на выводы полупроводниковых приборов видео- или радиоимпульса [1-5]. В реальных условиях микросхемы располагаются на платах, где и происходит непосредственное воздействие импульсных электромагнитных полей на ИМС. Поэтому исследований в свободном пространстве проводятся по схемам представленным, например, в работах [6].
Как известно, падающее на микросхему радиоизлучение создает наводки (токи и напряжения высокой частоты) на выводах интегральной микросхемы (см. рис. 1).
Амплитуды наводок существенно зависят от размеров, формы, ориентации выводов ИМС, параметров излучения и т.п. [7-9]. Эти высокочастотные колебания, сформированные на выводах, попадают на элементы ИМС – резисторы, диоды, транзисторы. Часть мощности при этом поглощается ими, приводя к нагреву, часть переотражается, а часть детектируется на нелинейных элементах ИМС.
В зависимости от поглощенной элементами микросхемы СВЧ мощности наблюдаются следующие нарушения работоспособности ИМС [10-12]:
- помехи и обратимые отказы с восстановлением нормальных характеристик и параметров после прекращения воздействия СВЧ излучения;
- деградационные изменения параметров и характеристик с медленным ухудшением технических характеристик микросхем в процессе эксплуатации и возможным выходом рабочих параметров за пределы установленных допусков;
- быстрые «катастрофические» отказы с необратимым нарушением работоспособности.
Помехи и обратимые отказы возникают при сравнительно низких уровнях мощности радиосигналов. Они, в частности, могут быть связаны с детектированием радиоизлучения в диодах и транзисторах микросхем [13].
Деградационные изменения наблюдаются при промежуточных значениях мощности радиоизлучения и энергии импульсов.
Катастрофические отказы, обусловленные воздействием мощного излучения, связаны с выделением тепла в локальной области микросхемы, проплавлением полупроводника, выгоранием контактных элементов, металлизации, пробоями подзатворных диэлектриков. Существенное влияние на критические уровни мощности радиоизлучения, вызывающие катастрофические отказы, оказывают “скрытые дефекты” материалов и конструктивно-технологические особенности микросхем (технология изготовления, топология ИМС, тип корпуса, выводов и т.п.). Повреждения активных элементов (в том числе и микросхем) в значительной степени определяют Вероятность повреждения ЭА в целом.
В данной работе рассмотрены возможные механизмы, вызывающие деградацию и катастрофические отказы ИМС в полях мощного радиоизлучения. Проведен анализ результатов экспериментальных исследований воздействия мощного импульсного радиоизлучения на стойкость ИМС.
Деградационные изменения параметров и характеристик полупроводниковых элементов
Многие деградационные явления в активных элементах микроэлектроники в настоящее время связывают с диффузией — процессом массопереноса в объеме полупроводника, на его поверхности, по границам раздела фаз и в контактах. Именно этот процесс, который может ускоряться в зависимости от наличия дислокаций, внутренних механических напряжений и таких внешних факторов, как давление, температура, электрическое поле, радиация и др., обусловливает деградацию электрических характеристик прибора, ползучесть, старение, коррозию материалов полупроводниковой структуры и контактов.
Специфика механизмов деградации наиболее четко проявляется в зависимости от метода создания выпрямляющего контакта. Так, экспериментальные исследования диодов с барьером Шоттки на основе арсенида галлия и кремния в различных режимах работы показали [14], что основным физическим процессом, обусловливающим деградацию параметров, является интердиффузия на границах раздела металл-полупроводник и металл-металл. Взаимная диффузия приводит к образованию интерметаллических соединений на границе металл-полупроводник и к генерации глубоких центров в области пространственного заряда [15], ухудшению пробивного напряжения барьера Шоттки [16-18].
Для диодов с барьером Шоттки наряду со взаимной диффузией компонентов важным механизмом деградации является релаксация внутренних механических напряжений.
Влияние пластической деформации на характеристики полупроводниковых приборов обусловлено неоднородным изменением концентрации носителей, их времени жизни и других свойств материала, из которого изготовлен прибор. Корреляция избыточных обратных токов полупроводниковых диодов с плотностью дислокаций в базе отмечается в работе [16]. Связанные с дислокациями генерационно-рекомбинационные центры, изменения зонной структуры полупроводника, обусловленные деформационным полем дислокаций, могут проявиться в появлении туннельных токов. Авторами работы [19] показано, что весьма эффективно осуществляется генерация дислокаций в процессе термокомпрессии вследствие градиента температур и локальной пластической деформации.
Для современных ИМС с высокой степенью интеграции одним из доминирующих механизмов отказа является процесс деградации и разрушения микропроводников многоуровневой металлизации и ее элементов вследствие электромиграции [20, 21].
Электромиграция (электродиффузия) - перенос массы, наблюдаемый в металлах и полупроводниках при прохождении постоянного и переменного электрического тока большой плотности, является основной формой проявления ионной проводимости, вследствие чего этот процесс называют электропереносом. Механизм перемещения ионов является диффузионным, например, диффузия ионов по поверхности, границам зерен, дислокациям (существуют и другие механизмы переноса, такие как вакансионный и тепловой диффузии междоузельных атомов [22]).
Алюминий и его сплавы остались основным материалом металлизации микросхем. Для развития эффектов электромиграции в алюминиевой металлизации характерное значение плотности тока J=106 А/см2 (для линии с сечением 10 мкм2 это соответствует току 100 мА). При больших плотностях тока электромиграция значительно ускоряется (при плотности тока 107 А/см2 характерное время повреждения может составлять единицы мс [23]).
Воздействие мощного радиоизлучения приводит к тому, что в полупроводниковых приборах и ИМС возникают большие токи и напряжения, проводники и нелинейные элементы микросхем в таких условиях максимально нагружены и поэтому приходится считаться с высокими плотностями тока и опасностью электродиффузии (электромиграции).
С учетом диффузионных, тепловых, электрических и механических эффектов, которые могут возникнуть при воздействии мощного радиоизлучения, обобщенное уравнение массопереноса имеет вид [24]
![]()
где J - поток
ионов и первый член в правой части описывает диффузию под действием градиента
концентрации ионов
![]() Dnexp(-Еa/kТ)=D - диффузионная
компонента, Еa - энергия
активации процесса электромиграции, k - константа
Больцмана, T - температура; второй - описывает
диффузию под действием температурного градиента
Dnexp(-Еa/kТ)=D - диффузионная
компонента, Еa - энергия
активации процесса электромиграции, k - константа
Больцмана, T - температура; второй - описывает
диффузию под действием температурного градиента
![]() , q - теплота
переноса диффундирующих ионов; третий - описывает диффузию под действием градиента
электрического поля
, q - теплота
переноса диффундирующих ионов; третий - описывает диффузию под действием градиента
электрического поля
![]() , eZ* -
эффективный заряд иона; четвертый - описывает диффузию под действием градиента
внутренних напряжений
, eZ* -
эффективный заряд иона; четвертый - описывает диффузию под действием градиента
внутренних напряжений
![]() Р -
постоянная.
Р -
постоянная.
Массоперенос во всех случаях пропорционален количеству освобождаемых ионов за счет действия различных эффектов. Уравнение непрерывности при этом имеет вид:
dN/dt+div(J)=0,
где dN/dt - скорость изменения концентрации ионов, например, в сечении токопроводящей дорожки. Если в некоторой области металлического проводника div(J) < 0, то происходит накопление вещества в виде холмиков, бугорков и наоборот, при div(J) > 0 происходит формирование пузырей и пустот.
Следует отметить, что любое несовершенство (дефект) края металлизации приводит к увеличению напряженности поля в локальной области прибора или к локальному повышению плотности тока, стимулирует электромиграцию материала, изменение проводимости, например, канала полевых транзисторов с барьером Шоттки в микрообъеме, и последующее лавинное развитие микропробоя, приводящее либо к закорачиванию электродов прибора, либо к отключению части прибора.
Таким образом, большие напряженности электрических полей, большие плотности токов и их градиенты способствуют таким процессам, как перегрев, электромиграции ионов, возникновению и перестройке структурных дефектов в полупроводниковом материале. Указанные процессы приводят к ускорению изменения исходных свойств материала и параметров p-n-структуры, как правило, в сторону ухудшения ее характеристик.
Основным механизмом воздействия СВЧ излучения на дефектную структуру полупроводниковых кристаллов, полагают в [5], является разогрев носителей заряда. Горячими подвижные носители становятся, набрав энергию от поля [25]. Для этого требуются электрическое поле с напряженностью Е>4×104 В/см и возможность пробега в нем на расстоянии l в десятки нанометров, в результате чего носитель наберет энергию qEl, если не будет иметь потерь энергии от неупругого рассеяния. Для электронов канала МОП-транзистора такие условия выполняются в стоковой области пространственного заряда [26].
Даже незначительное увеличение температуры возбужденных электронов (DT~0.3To) приводит к увеличению коэффициента диффузии D(T)/D(To) на несколько порядков [27].
Поэтому кратковременное приложение напряжения пробоя к p-n переходу или контакту металл-полупроводник создает электрическое поле, которое, помимо того, что ускоряет движение свободных носителей и увеличивает их кинетическую энергию (т.е. увеличивает температуру электронно-дырочного газа), приводит к следующему:
- разделению электронно-дырочных пар путем отталкивания их в противоположные направления, обеспечивая тем самым благоприятные условия для селективного захвата электронов или дырок диффундирующими дефектами,
- ускоряет перемещение и перестроение заряженных примесных атомов и дефектов в контактной области полупроводника.
Таким образом, отклонение электронной подсистемы полупроводника от термодинамического равновесия за счет возникновения горячих носителей заряда в приповерхностном слое полупроводника приводит к изменениям примесно-дефектного состава этого слоя (разогрев стимулирует перемещение дефектов на стоки). В качестве последних (стоков) могут выступать дислокации, малоугольные границы, крупные кластеры точечных дефектов.
В сообщениях [28-30] указывается на стимулирование СВЧ излучением эффекта геттерирования дефектов и структурной релаксации в полупроводниковых материалах. В результате СВЧ облучения (режим облучения в свободном пространстве сантиметрового диапазона длин волн) на поверхностно-барьерные диоды Шоттки происходит заметное изменение свойств межфазных границ и приповерхностных слоев полупроводника, сопровождающееся изменением высоты барьера jВ, уменьшается фактор неидеальности n, возрастает диффузионная длина неосновных носителей заряда Lp. Последнее свидетельствует о стимулированных СВЧ излучением процессах геттерирования в приповерхностных слоях, как в кремнии, так и в арсениде галлия, фосфиде индия и галлия [31].
Мощным СВЧ излучением можно вызвать увеличенный разогрев вблизи дефектных скоплений примеси [32]. Помимо этого, если в исходном состоянии образцы имеют низкую плотность дислокаций, расположенных хаотически, то воздействие мощного СВЧ излучения приводит к генерации дислокаций и формированию разнообразных дислокационных структур в материале. Оказывается, что максимальная степень генерации дислокаций имеет место во внешней половине скин-слоя. Дислокации во внутренней половине скин-слоя и за его пределами появляются благодаря скольжению их из внешней половины скин-слоя под действием высокого уровня напряжений. Избыточная плотность дислокаций исчезает вблизи расчетной границы скин-слоя от поверхности. Амплитуда дальнодействующих полей напряжений, рассчитанная по [33], имеет максимум на том же расстоянии. Это вызывает концентрацию примесей вблизи облучаемой границы и приводит к более резкой границе диффузии примеси [34]. Характер возникающей дислокационной структуры свидетельствует о ее неравновесности. Аналогичные результаты наблюдаются и в металлах [35].
Следует ожидать, что уменьшение длительности радиоимпульсов и увеличение мощности излучения будет сопровождаться усилением данного эффекта.
Исследование изменений в структурах Al/SiО2/Si [36], которые возникают в результате воздействия импульсным электромагнитным излучением с длительностью переднего фронта импульса 1.4 10-9 с и общей длительностью импульса ~ 11.5×10-9 с, частотой следования импульсов 10 кГц и различной энергией импульса (< 2.4 10-4 Дж), показывают следующее:
- вольт-фарадные характеристики таких структур оказываются измененными до, во время и после воздействия импульсов;
- в зависимости от энергии импульса происходят изменения во время воздействия, связанные с перестройкой неравновесной дефектной структуры границы раздела с полупроводником и поляризацией диэлектрика (с энергией порядка 10-5Дж), а также необратимые изменения, связанные с пробоем, наблюдаемые и после выключения воздействия (при увеличении энергии импульсов до 10-4Дж).
Известно, что большое влияние на надежность полупроводниковых приборов оказывают неоднородности токопрохождения, причиной которых могут являться как структурные неоднородности, так и неустойчивости однородного распределения тока.
Развитие электрических пробоев (лавинного, туннельного, а также пробоя подзатворного диэлектрика) и тепловых процессов ускоряет деградационные процессы и приводит к необратимым отказам в полупроводниковых приборах (повреждение p-n переходов, подзатворного диэлектрика и токоведущих линий). Обычно считается, что даже кратковременное пребывание прибора в режиме вторичного пробоя (ВП) может привести к остаточным изменениям его свойств [37, 38] и накоплению повреждений от импульса к импульсу [38].
Механизмы повреждение интегральных микросхем
Анализ экспериментальных исследований показывает, что из-за сложности регистрации быстро протекающих процессов и изменений в структуре полупроводниковых элементов, происходящих при воздействии радиоимпульса, практически все авторы ограничиваются описанием условий возникновения и констатацией внешних особенностей отказа, что, конечно, не позволяет точно установить физическую причину повреждений. Весьма вероятно, что на высоких частотах действуют те же механизмы, что и в режиме видеоимпульса, однако эти механизмы (так же детально и подробно) не идентифицированы.
Наиболее распространенными механизмами повреждения ИМС считаются вторичный пробой, плавление металлизации, пробой диэлектрика. Рассмотрим их некоторые особенности.
Вторичный (тепловой) пробой в режиме коротких высокочастотных импульсов связан с попаданием рабочей точки в область электрического пробоя (на обратной ветви ВАХ), резким увеличением тока через прибор, значительным тепловыделением в области p-n перехода и последующим тепловым повреждением структуры. Чаще всего наблюдается проплавление локальных областей эмиттера входных транзисторов и p-n переходов защитных диодов.
Физика повреждения металлизации не так сложна, как полупроводников, температурный коэффициент проводимости положительный, так что токовой нестабильности у них нет.
Металлизация в большинстве случаев теплоизолирована слоем окиси, поэтому адиабатическая область модели Вонша-Белла [1-3] характеризует, в первую очередь, большинство повреждений металлизации. Плавление токоведущей линии в условиях адиабатического нагрева коротким импульсом (в отсутствии теплопередачи в окружающую среду) происходит при плотности тока j=[sСrТпл/t]1/2, где s, С и r - проводимость, теплоемкость и плотность материала токоведущей линии. При длительности импульса 10 нс соответствующая плотность тока (для алюминиевых токоведущих линий) имеет величину около 2,5×108 А/см2. Для токоведущих линий на кристалле ИМС, имеющих характерные размеры сечения 10´1 мкм2, это соответствует току 2,5 А.
Из-за неоднородностей токовой линии (они часто наблюдаются в углах поворота, изгиба, в области контактных площадок и т.п.) критические значения плотности тока начала плавления оказываются почти на порядок меньше, так как прогорание начинается в местах максимальной плотности тока.
В микросхемах, изготовленных по КМОП технологии, еще одной причиной повреждения может быть пробой окисной пленки под затвором [23]. Характерное поле пробоя пленки SiO2 составляет 5×106 В/см, что при типичной толщине пленки 500…1000 Å дает напряжение пробоя 25…50 В.
Электрический пробой диэлектрика имеет место лишь в совершенных пленках, не имеющих дефектов. При наличии пор в окисле, через которые возможно шунтирование затвора электрода с подложкой, наблюдается тепловой пробой. Тепловой пробой происходит при напряжениях, на 5…10 В меньших напряжения пробоя диэлектрика. Часто первый электрический пробой не вызывает катастрофического отказа окисла пленки в ИМС, однако он оставляет структурно слабые точки на пленке. При повторном пробое эти точки продолжают ослаблять пленку, работающую до тех пор, пока пленка не пробивается.
Все механизмы имеют низкие пороги повреждений из-за малых геометрических размеров характерных областей в ИМС и наличия дефектов.
Отметим, что характер процессов и механизмов повреждения интегральных микросхем существенным образом зависит как от параметров микросхем (размеров активных элементов, чипа, корпуса ИМС, длины ее выводов, их взаимного расположения, ориентации относительно вектора напряженности электрического поля), так и от амплитудно-временных характеристик излучения (интенсивности излучения, несущей частоты, длительности и частоты повторения импульсов, времени облучения). Это является одной из причин существенного разброса в результатах, приводимых разными авторами.
Испытания, проведенные на ряде ИМС, показали, что порог разрушения при длительности импульсов от 100 нс до 100 мкс соответствует модели Вонша-Белла [39]. Типичным разрушающим уровнем на несущей частоте в несколько ГГц при длительности импульса 1мкс является мощность порядка 100 Вт.
Пороговая мощность, приводящая к повреждению цифровых устройств, имеет примерно тот же порядок, что и для аналоговых устройств [40].
Результаты исследований, проведенных авторами [41], показали, что на уровни повреждения микросхем сильное влияние оказывает степень их интеграции, т.е. размеры элементов ИМС, их количество и расстояние между ними. При воздействии радиоизлучения 3 ГГц и 10 ГГц с длительностью импульса 0,1 мкс пороги мощности повреждения ИМС лежат в пределах 20…50 Вт для монолитных СВЧ микросхем (MMIC), для ИМС высокой степени интеграции (VLSI) - в пределах 50…200 Вт, для ИМС средней степени интеграции (MSI) - 100…2000 Вт и для ИМС малой степени интеграции (SSI) - 4000…7000 Вт.
Повреждение микросхем при облучении СВЧ излучением может происходить в результате комбинации повреждений p-n переходов и металлизации. Как правило, из строя выходят входные и выходные элементы.
Так, в результате воздействия на микросхемы короткими радиоимпульсами (длительностью t = 20…30 нс и длиной волны l = 10 см) наблюдалось полное разрушение области p-n-перехода, расплавление и разрыв металлизации для ТТЛ микросхем при напряженности электрического поля Е = 1,4…1,8 кВ/см и для МОП микросхем при Е = 0,1…4 кВ/см [42].
В результате анализа образцов ИМС, подвергнутых СВЧ воздействию, было найдено [42, 43], что 90% биполярных и 63% КМОП ИМС выходят из строя из-за повреждения металлизации. Плавление чаще всего наблюдалось в области контактных площадок и поворотов токоведущих линий. В области плавления, как правило, имеется повышенная концентрация источников тепловыделения. Повреждения металлизации проявлялись в местах наибольшего механического напряжения в структуре: на ступеньках окисла и вокруг контактных площадок.
В ТТЛ, ТТЛШ микросхемах (на основе многоэмиттерного биполярного транзистора) наблюдалось повреждение защитных диодов, т.к. они имели минимальные размеры. Другие повреждения биполярных ИМС были обусловлены дефектами металлизации и межслойной изоляции. Повреждение ИМС, выполненных по современной технологии, вызывались разрушением тонкопленочных резисторов в коллекторных цепях выходных транзисторов и пробоем переходов эмиттер-база фазоинверсных каскадов.
На рис. 2 представлены зависимости усредненных интенсивностей излучения (плотности потока энергии), вызывающих необратимые повреждения микросхем в зависимости от длительности СВЧ импульсов (при длине волны излучения l = 4 см в режиме с малой частотой повторения импульсов F < 10 Гц) [44].
|
|
|
Рис. 2. Зависимость интенсивности радиоизлучения I, приводящего к повреждению ИМС от длительности импульса t |
Из представленных результатов следует, что для большей части микросхем уровни повреждения лежат в диапазоне 50…100 Вт/см2 (Е=19…28 кВ/м) при t = 5 мкс и возрастают до 1000…1500 Вт/см2 (Е=87…106 кВ/м) при t = 0,1…0,3 мкс. По определению I= E2/2W0, Е – амплитуда электрического поля электромагнитной волны, W0=120p Ом.
Анализ представленных результатов показывает, что разброс значений интенсивностей, при которых происходит повреждение цифровых ИМС с малым числом элементов на кристалле, оказывается сравнительно небольшим ~ 4 дБ, несмотря на значительное разнообразие типов микросхем и разные режимы их функционирования (“запитанные” или “холодные”).
Сравнение с результатами экспериментальных работ по повреждению ИМС, выполненных на других длинах волн [42, 43, 45], показывает, что имеется качественное согласие результатов, полученных различными авторами (для сопоставления использовались антенная модель и тепловая модель Вонша-Белла).
Результат действия СВЧ импульсов определяется не только параметрами излучения, но и технологией изготовления ИМС, а также типом их корпуса (металлический, пластмассовый).
Наименее стойкими к действию импульсного излучения оказались элементы памяти (ИМС 155РУ7 и 561РУ2). Микросхемы памяти имеют высокую степень интеграции (несколько тысяч транзисторов на кристалле) и малые размеры элементов, которые примерно на порядок меньше размеров элементов микросхем цифровой логики. Для микросхем памяти уровни повреждения оказались в несколько раз меньше, чем для цифровых микросхем с низким уровнем интеграции элементов на кристалле. Особенно заметно отличие при воздействии коротких радиоимпульсов.
Физико-технический анализ поврежденных ИМС показал [44], что наиболее распространенными механизмами повреждения ИМС являются вторичный пробой, плавление металлизации, пробой диэлектрика. Для микросекундных радиоимпульсов 60% отказов связано с пробоем p-n-переходов и 40% - c плавлением металлизации. Плавление чаще всего наблюдалось в области контактных площадок и поворотов токоведущих линий. Наиболее уязвимыми оказываются входные и выходные элементы ИМС, на которые сигнал СВЧ наводки поступает непосредственно с выводов микросхем.
Характерные виды повреждений интегральных микросхем представлены на рис. 3.
|
а |
б
|
в |
|
Рис. 3 |
||
На рис. 3а представлен фрагмент ИМС 133ЛД с повреждением типа разрыва металлизации по входам 1,2; пробой переходов Э-Б входного транзистора по входам 1, 2, 3, 4, 5, 13. На рис. 3б показан фрагмент ИМС 564 ЛН2 с пробоем защитного диода по входу 1. На рис. 3в изображен фрагмент ИМС 100ЛЕ111 с перегоранием токоведущей линии на углу поворота.
В составе ЭА микросхемы располагаются на платах, у которых имеются токоведущие линии разных длин и большое количество других микросхем и элементов. В результате происходит взаимодействие микросхем с множеством компонентов плат, блоков и узлов, составляющих данное устройство.
У исследуемых микросхем, расположенных на платах и находящихся в области облучения, были зарегистрированы как эффекты временной потери работоспособности, так и повреждения при увеличении интенсивности радиоизлучения. Уровни повреждения довольно хорошо соответствуют уровням, полученным в экспериментах с отдельными микросхемами. Так, например, выход из строя ТТЛШ и КМОП ИМС, расположенных на платах, наблюдался при интенсивности излучения I ~ 200…300 Вт/см2 и длительности радиоимпульса t=2 мкс и, соответственно, I ~150…200 Вт/см2 и t=5 мкс [44].
В процессе исследований [46-49] (l=10 см, t=1 мкс) было установлено, что микроконтроллеры (ATtiny15, PIC16F628-20I/Р), микросхемы памяти 27С256-20FA, АЦП и ЦАП (TLC549IP и AD7243) выходят из строя при воздействии радиоимпульсов с Em> 85…95 кВ/м.
При Em>10 кв/м начинаются деградационные явления в микроструктурных элементах микросхем, каковыми являются в основном локальные прожоги контактных площадок.
Анализ кристаллов, вышедших из строя вследствие импульсного воздействия, позволил выявить виды отказов современных микроконтроллеров. Основной причиной их отказов является прожог металлизации - 60%. В свою очередь из этих 60% отказов половина произошла вследствие прожога контактных площадок (рис. 4), а другая половина - вследствие прожога токопроводящих дорожек (рис. 5).
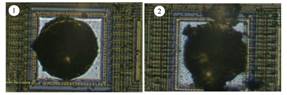
Рис. 4. Фрагмент контактной площадки ИМС ATtiny15: [52]
1 – контактная площадка до воздействия; 2 –деградация контактного соединения

Рис. 5. Прожоги проводящих дорожек ИМС 27С256-20FA после воздействия [53]
Было замечено, что 30% - катастрофических отказов микросхем наступает вследствие одновременного теплового разрушения проводящих дорожек и полупроводниковых приборов, а 10% микросхем выходят из строя вследствие выгорания активных полупроводниковых микроструктурных элементов ИМС [46-49]. Аналогичные результаты отмечались в работах [42, 43], показавших, что для коротких радиоимпульсов (t = 20…30 нс, l = 10 см) наиболее уязвимым микроструктурным элементом ИМС является металлизация.
Исследования, проведенные авторами [50, 51], показали, что увеличение степени интеграции ИМС приводит к тому, что повреждение небольших ЭВМ и микропроцессоров происходит уже при средней плотности потока мощности СВЧ излучения ~ 1…10 мВт/см2 (Em»0,1…0,3 кВ/м) (длительность импульса t=1 мкс).
Анализ большого числа экспериментов показывает, что значительную роль при оценке уровней повреждения ИМС играют режим воздействия (моноимпульсный, полиимпульсный, пачечный) и статистический (вероятностный) характер повреждения.
На рис. 6 представлена зависимость интенсивности повреждения I ТТЛ микросхем от частоты следования F радиоимпульсов длительностью t = 5 мкс [44].
|
|
|
Рис. 6. Зависимость интенсивности повреждения I ИМС 133ЛН1 от частоты следования F СВЧ-импульсов [50]. |
Эти исследования показали, что в диапазоне частот 0,1…10 Гц уровни интенсивности СВЧ излучения, вызывающие повреждение микросхем, меняются слабо. С увеличение частоты повторения СВЧ импульсов F уровень интенсивности, необходимый для повреждения микросхем, уменьшается. Это характерно, в том числе, при частотах повторения F < 1000 Гц, где повреждение может быть связано с накоплением дефектов, а не с накоплением тепла от импульса к импульсу СВЧ-излучения. Однако следует отметить, что полученные результаты могут объясняться и возрастанием вероятности повреждения с увеличением частоты повторения.
При частоте повторения радиоимпульсов F = 104 Гц наблюдалось плавное уменьшение выходного сигнала вплоть до выхода микросхемы из строя, что связано с тепловым перегревом микросхемы в процессе облучения. При высокой частоте повторения этот эффект можно было бы объяснить накоплением тепла от импульса к импульсу. Однако для накопления тепла необходимо, чтобы пауза между импульсами была соизмерима с тепловой постоянной выпрямляющего контакта. А эффект наблюдается и в том случае, когда длительность паузы между импульсами значительно больше тепловых постоянных, например, на частотах в десятки и сотни Гц.
Следует отметить, что все измерения носят статистический характер. Даже на идентичных микросхемах выход из строя регистрировался при разных параметрах СВЧ излучения (отличались интенсивность или время выхода из строя). Это связано, в частности, с различием в таких слабо контролируемых параметрах ИМС, как число и распределение дефектов внутри p-n переходов и в других элементах микросхем.
Так, регистрация сигналов с выхода ИМС, формирующихся под действием мощных повторяющихся радиоимпульсов, показывает, что в значительном числе случаев наблюдается ухудшение характеристик приборов «от импульса к импульсу» [52-54].
|
|
|
|
|
Рис. 7. |
||
На рис. 7 в качестве примера представлены осциллограммы сигнала с выхода микросхемы 133ЛД3, снятые в разные моменты времени t (а - t= 0,1 c, б - 0,4 с, в - 2 с).
На осциллограммах прослеживается процесс повреждения микросхемы от импульса к импульсу под действием пачки радиоимпульсов длительностью t = 5 мкс, следующих с частотой повторения F = 10 Гц. И если заметное изменение формы выходного сигнала с микросхемы зафиксировано на 4 импульсе, то повреждение микросхемы произошло на 20 импульсе.
На рис. 8 представлены осциллограммы сигнала промежуточной частоты с выхода СВЧ микросхемы (двойного балансного смесителя) при мощности импульсов радиоизлучения в тракте Р = 70 Вт (F = 10 Гц, t = 810 нс, l = 3 см), снятые в разные моменты времени t (а – t = 0 c, б - 0.2 с, в – 3 с) [55].
|
|
|
|
|
Рис. 8. |
||
По результатам статистической обработки экспериментальных исследований [52] была построена представленная на рис. 9 зависимость вероятности повреждения ТТЛ микросхем от числа радиоимпульсов N (от начала воздействия до выхода ИМС из строя).
|
|
|
Рис. 9. Зависимость вероятности повреждения микросхем как функции числа радиоимпульсов N от начала воздействия до выхода ИМС из строя, t = 5 мкс. |
Представленная на рис. 9 зависимость была получена для серии однотипных ИМС при фиксированных значениях длительности импульсов t = 5 мкс. Как видно из графика на рис. 9, до 40% повреждений происходит на первом импульсе. Среднее значение номера N импульса СВЧ излучения, соответствующего повреждению микросхем, было <N> = 160, а отношение среднеквадратичного отклонения sN к среднему sN/<N> = 1.5, что указывает на наличие значительных флуктуаций, причем величина N флуктуирует существенно больше, чем величина порогового уровня интенсивности.
Полученное распределение имеет определенное сходство с кривой отказов полупроводниковых приборов. Для кривой отказов первый максимум, как известно, связывается с наличием «некачественных» изделий. В отличие от кривой отказов второй максимум не наблюдается при больших значениях N, что связано с высоким уровнем интенсивности радиоизлучения в наших экспериментах.
Вероятность повреждения возрастает от значения ~ 0.33 до 0.7 при изменении N от 1 до ~100, а затем скорость роста вероятности заметно снижается. Причиной небольшой скорости роста вероятности повреждения как функции числа импульсов N является то, что большим значениям вероятности повреждения P > 0.9 соответствуют значительные превышения требуемой величины N над средним значением. В рассмотренном выше распределении среднее значение N = 160, и ему соответствует вероятность повреждения ~ 0.7, а вероятности повреждения 0.9 соответствуют значения N = 500…600.
|
|
|
Рис. 10. Зависимость вероятности повреждения микросхем 133-й серии от интенсивности при длительности СВЧ импульса t = 5мкс. |
На рис. 10 показана зависимость вероятности повреждения интегральных ТТЛ микросхем от интенсивности импульсов радиоизлучения [52]. Вероятность рассчитывалась как доля поврежденных микросхем от общего числа исследуемых.
Наличие порога по интенсивности, ниже которого повреждений нет, говорит о том, что физические механизмы повреждения «запускаются» только при превышении определенной мощности радиоимпульса. Для интенсивности радиоизлучения на 1…2 дБ ниже порога повреждения ИМС не наблюдались до весьма больших значений числа импульсов N > 104.
Флуктуации интенсивности оказываются меньше среднего значения. Для ИМС различных типов разброс пороговых значений интенсивности оказывается существенно больше.
Результаты статистической обработки экспериментальных исследований показывают, что повреждение ИМС носит вероятностный характер. Вероятность повреждения является существенной характеристикой процесса деградации микросхемы и должна учитываться при определении мощности радиоизлучения, вызывающей развитие этого процесса. Она зависит от частоты повторения воздействующих импульсов и их энергии. Полученные экспериментальные результаты в значительной степени могут быть объяснены в рамках модели накопления повреждений [52-54], которая позволяет описать процессы повреждения ИМС относительно слабыми импульсами, длительность паузы между которыми настолько больше тепловых постоянных, что эффект накопления тепла отсутствует.
В работе [56, 57] предложено ввести параметры скорости отказов BFR (Breakdown Failure Rate) для описания обратимых отказов и DFR (Destruction Failure Rate) для описания не обратимых отказов микросхем (см. рис. 13). В частности, DFR - число отказов системы (NDestructions), деленное на число импульсов, которые воздействовали на нее (NPulse). При этом полагается, что после сброса воздействия система не возвращается к нормальному функционированию (рис.13). Параметр DFR ведет себя как показано на рис. 14. Его описывают две величины. DT (Destruction Threshold – порог) определяет величину электрического поля, при которой происходят первые не обратимые отказы (повреждения). DB (Destruction Bandwidth – полоса пропускания) - диапазон величин электрического поля, в котором порог (DT) изменяется от 0,05 до 0,95. Аналогичная зависимость справедлива и для скорости обратимых отказов BFR (см. рис.11, 12).
Исследования чувствительности логических устройств (НЕ-И и Инвертор, выполненных в различные полупроводниковых технологиях (см. Табл. 1), к EMP (ElectroMagnetic Pulse - электромагнитный импульс) и UWB импульсам (UltraWideBand - сверхширокополосный) (см. Табл. 2) показали [57], что природа наблюдаемых отказов функционирования ИМС определяется различием между устройствами биполярных и униполярных технологий.
На рис. 13 показаны уровни необратимых отказов (разрушения) TTL и КМОП-инверторов.
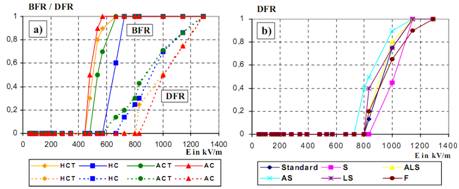
Рис. 13. Скорости обратимых отказов (BFR) и разрушений (DFR) КМОП (a) и ТТЛ (b) инверторов [57].
У КМОП микросхем при воздействии наблюдаются как обратимые отказы, так и необратимые отказы (разрушения), в то время как у ТТЛ устройств наблюдаются только необратимые отказы (разрушения).
Сравнение КМОП- и ТТЛ-инверторов показывает, что пороги разрушения (DT) подобны для обеих технологий и колеблются от 540 до 820 кВ/м. Те же самые эффекты наблюдались во время исследования устройств НЕ-И.
Пороги обратимых отказов (BT) четырех КМОП микросхем начинаются примерно с 230 кВ/м и 415 кВ/м. В КМОП ИМС паразитные биполярные тиристорные структуры образуются из близко расположенных логических элементов [57].

Рис. 14. Скорости обратимых отказов (BFR) и разрушений (DFR) КМОП и ТТЛ
a) НЕ – И b) Инвертор [57]
На рис. 14 показаны скорости обратимых отказов (BFR) и повреждений (DFR) устройств НЕ-И и инверторов для десяти различных технологий (см. Табл. 1) с кабельной лентой длиной 20 см, подключенной к выводам приборов.
Дальнейший статистический анализ показывает, что вероятность повреждения полупроводникового прибора в зависимости от амплитуды электрического поля (интенсивности) радиоизлучения близка к распределению Вейбулла [58].
Микроскопический анализ разрушенных устройств показывает [59], что наблюдаются три различных типа повреждений (Рис. 15). В более низких полях повреждаются только такие электронные компоненты, как диоды или транзисторы на чипе (Рис. 15a). Если амплитуда электромагнитного поля увеличивается приблизительно на 50%, то наблюдаются многочисленные повреждения компонент и дополнительные в местах контакта выводов ИМС (Рис. 15b, с). Дальнейшее увеличение амплитуды приводит к дополнительным многочисленным повреждениям компонент на чипе ИМС.
На рис. 16 показаны многочисленные повреждения элементов НЕ–И ТТЛ микросхемы.
На рис. 17 показан Шоттки ТТЛ инвертор после воздействия ЭМИ с амплитудой поля Em=1090 кВ/м. Наблюдаются все три типа повреждений. Элементы ИМС разделены на шесть одиночных инверторов, каждый с вводом (A) и выводом (Y), дополнительно есть два соединителя для напряжения питания (Vcc) и заземления (GND). Распределение повреждений на микросхеме примечательно - три логические элемента повреждаются в большой степени (INV 2, 4, 6), в то время как другие три повреждены частично (INV 1, 3, 5).
|
|
|
|
Рис. 17. Шоттки TTL- инвертор после воздействия ЭМИ (Em = 1090 кВ/м.) [59]. |
Рис. 18. Режимы инверторов во время воздействия [59]. |
Если рассматривать ИМС, показанную на рис. 18, очевидно, что логические элементы с потенциалом заземления на входе более восприимчивы к воздействию EMP, чем те, на которые подано управляющее напряжение.
Распределение повреждений, следовательно, зависит от состояния системы, этот факт наблюдается на всех исследованных ТТЛ ИМС.
При теоретической оценке уязвимости ИМС к воздействию радиоизлучений в широком диапазоне параметров используют математическое моделирование.
Анализ приведенных в работах [46-49] результатов экспериментальных исследований позволил сделать заключение, что при воздействии импульсных электромагнитных полей СВЧ-диапазона на микроструктурные элементы современных интегральных микросхем (микроконтроллеров, микросхем памяти, АЦП и ЦАП) в кристалле появляются цепи разряда.
В общем случае разрядная цепь образуется при последовательном и параллельном соединении проводящих, диэлектрических структур и активных элементов микросхем. С учетом статистических данных по стойкости микроструктурных элементов микросхем к воздействию радиоизлучения, несмотря на большое разнообразие микроструктурных элементов кристалла, достаточно рассмотреть два основных вида разрядных цепей с пассивными и активными элементами (рис. 19, 20).
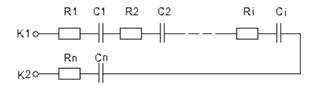
Рис. 19. Эквивалентная схема цепи разряда для проводящих и диэлектрических микроструктурных элементов [60].
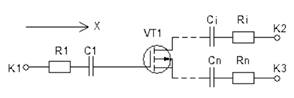
Рис. 20. Эквивалентная схема цепи разряда для активных, проводящих и диэлектрических микроструктурных элементов [60].
При моделировании электротепловых процессов напряжение, прикладываемое к цепям разряда, находится посредством решения дифракционной задачи для микросхемы.
Элементы цепей определяются исходя из реальных геометрических параметров микроструктурных элементов ИМС и экспериментальных данных.
Для многослойной микроструктуры ИМС (рис. 21) численно решалось уравнение теплопроводности [60, 61].

Рис. 21. Электротепловая модель кристалла современных микросхем [60].
Расчетным путем получены данные по стойкости микросхем при воздействии мощных импульсных электромагнитных полей, получены численные значения пороговых полей катастрофических отказов к рассматриваемому виду воздействия. Показано, что уменьшение толщины проводящих дорожек приводит к снижению стойкости микросхем. Так, для кристалла 4x4 мм уменьшение толщины пленки от 120 нм до 30 нм снижает стойкость микросхем с 80 кВ/м до 37 кВ/м.
Наибольшее повышение температуры наблюдается на самых тонких участках металлизации, что приводит к их последующей деструкции (температура данных участков достигает значения температуры плавления алюминия).
Подобные расчеты были проведены, когда на ИМС воздействует ЭМИ и СК ЭМИ [59, 62].
Для моделирования воздействия на ИМС использовалась затухающая функция синуса (рис. 22) [59].

Рис. 22. Напряжение: измеренное и приближение [59].
Численно решалось уравнение теплопроводности, из которого определялась амплитуду электрического поля, при которой происходит плавление контактного окна в течение воздействия импульсов.
Проведено сравнение с экспериментами (для таких же амплитуд электромагнитных полей). На рис. 23 представлена структура выходного транзистора после воздействия и моделирования.

Рис. 23. Выходной транзистор после полевого воздействия и моделирования [62]. Коллектор (C), База (B) и Эмиттер (E).
В обоих случаях повреждение произошло между электрически одинаковыми частями (База и Эмиттер). Точное положение в конструкции немного отличается, что было замечено на исследованных устройствах и основано на допусках при производстве ИМС.
Однако, как правило, для оценки результатов воздействия радиоимпульса на ИМС руководствуются методологией, представленной в работах [41, 63]: определяется потенциально уязвимый элемент, «антенны», на которых формируются наводки, пути поступления к элементу наводок и простые модели самого уязвимого элемента.
Для описания повреждения одного р-n перехода одним тепловым импульсом используется обобщенная модель Вонша-Белла, связывающая энергию повреждения Ес плоского р-n перехода с длительностью импульса t,
где Е0=CrSwDTc - энергия адиабатического нагрева объема p-n перехода до критической температуры Тс, t1 =w2/k - тепловая постоянная p-n перехода, w и S - его толщина и площадь, t2=S/k, С, r и k - теплоемкость, плотность и температуропроводность полупроводника.
Энергия повреждающего импульса определяется из условия достижения критической температуры в p-n переходе Т=Тс. Температура Тс является общим свойством всех тепловых теорий вторичного пробоя. Величина DТс= Тс- Т0 для низковольтных переходов, например, в кремниевых ИМС лежит в диапазоне 300…500°С (Т0 – рабочая температура прибора).
При облучении микросхем электрические перегрузки в цепях обусловлены сильными электромагнитными наводками [64], которые формируют сигналы сразу на всех ее выводах (см. рис.1). Источниками тепловыделения становятся многие активные элементы (диоды, транзисторы), расположенные на кристалле, и зависимость энергии повреждения от времени носит более сложный характер, чем для одного p-n перехода в модели повреждения Вонша-Белла.
Так, например, расчеты [64] показали, что в области длительностей импульсов tl << t << tD (где tD ~ 4D2/p2k, для цифровых ИМС tD ~ 0,3…1,4 мс), когда области сильного нагрева от соседних источников тепловыделения перекрываются, энергия Ес вторичного пробоя цифровых ИМС пропорциональна ~Öt.
Это вполне хорошо согласуется с экспериментальными данными для цифровых ИМС в области длительностей радиоимпульсов 1…40 мкс (см. рис. 24).
|
|
|
Рис. 24. Зависимость энергии повреждения ИМС от длительности радиоимпульса t. |
Поэтому константы Е0, t1, t2 в выражении (1), которые зависят от геометрии структуры области тепловыделения, тепловых свойств материала полупроводника, температуры повреждения Тс, характера воздействующего импульса, бывает удобнее определить из экспериментальных зависимостей Ес(t) (или Pс(t)=Есt) для конкретного вида, типа полупроводникового прибора.
В отличие от тепловой модели модель накопления повреждений утверждает [52-54], что действие одного импульса приводит к несущественным для работы ИМС локальным изменениям структуры и выход прибора из строя происходит при достижении критического числа дефектов. Наблюдаемое уменьшение мощности повреждения с увеличением частоты повторения импульсов обусловлено тем, что повреждение полупроводникового элемента осуществляется путем создания большого числа локальных дефектов. Вывод из строя ИМС одним мощным импульсом требует формирования одного крупного дефекта, эквивалентного закритическому набору локальных повреждений. Представленная модель позволяет описывать зависимость уровней повреждения ИМС и СВЧ диодов от мощности (или энергии) действующих радиоимпульсов, их числа N и частоты повторения F.
Выводы
Для радиоизлучения (как непрерывного, так и импульсного различной длительности) проведено достаточно много исследований по воздействию на материалы и приборные структуры. И было установлено, что на стойкость интегральных микросхем существенно влияют параметры радиоизлучения (несущая частота, длительность и частота повторения импульсов, ориентация относительно электромагнитных полей) и конструктивно-технологические особенности ИМС (технология изготовления, топология ИМС, тип корпуса, выводов и т.п.).
Описанные результаты указывают на существенную роль преобразований точечно-дефектной структуры кристаллов, токоведущих линий, которые могут стимулироваться при воздействии радиоимпульсов. А развитие электрических пробоев (лавинного, туннельного, а также пробоя подзатворного диэлектрика) и тепловых процессов, ускоряют деградацию параметров и приводят к необратимым отказам в полупроводниковых приборах (повреждение p-n переходов, подзатворного диэлектрика и токоведущих линий).
Установлено, что физические механизмы деградационных изменений параметров и повреждения микросхем “запускаются” только при превышении определенного уровня мощности радиоимпульса.
Деградационные эффекты в импульсных полях проявляются при существенно более низких уровнях энергии, чем в стационарных полях.
Максимальные воздействия проявляются в импульсных полях, создающих наибольшие градиенты электрических полей и температуры.
Наименее устойчивыми к облучению являются неоднородные полупроводниковые структуры, содержащие встроенные электрические поля и границы раздела диэлектрика и металла.
Все результаты исследований стойкость интегральных микросхем в полях радиоизлучения носят статистический характер. Даже на идентичных микросхемах деградация параметров и выход из строя регистрировался при разных параметрах радиоизлучения (отличались интенсивность или время выхода из строя). Это связано, в частности, с различием в таких слабо контролируемых параметрах ИМС, как число и распределение дефектов внутри p-n переходов и других элементах микросхем.
При теоретической оценке уязвимости ИМС к воздействию радиоизлучения в широком диапазоне параметров используют математическое моделирование с использованием современных вычислительных средств. Однако точное положение районов повреждения в реальной конструкции микросхем немного отличается от расчетных, это часто заметено на исследованных устройствах и основано на допусках при производстве ИМС.
Литература
1. Antinone R.J. Young P.A., Wilson D.D., and et al. Electrical overstress protection for electronic devices. - Noyes Publications, 1986. - 394 p.
2. Messenger G.C., Ash M. S. The Effects of radiation on Electronic System’s. - Van Nostrad, Reinhold Co. N.-Y. 1986. – 264 p.
3. Риккетс Л.У., Бриджес Дж. Э., Майлетта Дж. Электромагнитный импульс и методы защиты. – М., Атомиздат, 1979. – 328 с.
4. Antinone R.J. A Review of the Phenomenology of High Power Microwave Effects on Electronic Components. // International Symposium on Electromagnetic Environments and Consequence, 17-21 Jan 1994: proc. – Bordeaux, 1994. – pp. 344–350..
5. Korte S., Garbe H. Breakdown behavior of electronics at variable pulse repetition rates. // Adv. Radio Science, 2006, N 4, pp. 7–10.
6. Ключник А.В., Пирогов Ю.А., Солодов А.В. Методические аспекты исследования стойкости интегральных микросхем в электромагнитных полях импульсного радиоизлучения. // Журнал радиоэлектроники, 2010, №8, с. 1-27.
7. Taylor C.D., Harrison C.W. On the coupling of microwave radiation to wire structures // IEEE Trans., 1992, vol. EMC-34, N 3, pp. 183-188.
8. Шеин А.Г., Григорьев E.B., Старостенко B.B. Влияние ориентации электромагнитного поля при воздействии на интегральные микросхемы // Электронная техника. Сер. Упр. кач-вом., 1992, Вып. 2(149), c.16-18.
9. Дементьев Ю.В, Каплун В.Г, Кучеров Ю.С, Сытник А.Ф. Влияние длины волны внешнего СВЧ излучения на стойкость элементной базы радиоэлектронной аппаратуры // Радиотехника, 1996, №2, c.125-126.
10. Бригидин А.М., Титович Н.А., Кириллов В.М. и др. Влияние электромагнитных помех на работоспособность полупроводниковых приборов и интегральных схем // Электронная техника. Сер. Упр. качеством, стандартизация, метрология, испытания, 1992, вып.1 (148), c. 3-12.
11. Антипин В.В., Годовицын В.А., Громов Д.В., Кожевников А.О., Раваев А.А. Влияние мощных импульсных микроволновых помех на полупроводниковые приборы и интегральные микросхемы // Зарубежная радиоэлектроника, 1995, №1, с. 37-52. =4
12. Баранов И.А., Обрезан О.И., Ропий A.M. Стойкость твердотельных модулей СВЧ к кратковременным электроперегрузкам // Обзоры по электронной технике. Сер. 1. СВЧ-техника. 1997. – 111с.
13. Ключник А.В., Пирогов Ю.А., Солодов А.В. Обратимые отказы интегральных микросхем в полях радиоизлучения // журнал Радиоэлектроники, 2013, №1, с. 1-24.
14. Прогнозирование надежности полупроводниковых лавинных диодов /Конакова Р.В., Кордош П., Тхорик Ю.А. и др. – Киев.: Наука думка. 1986. -168с.
15. Орешкин П.Т., Рыжков С.В. Барьерный слой как резонатор при поверхностно-барьерной неустойчивости // ФТП, 1984, т.18, №6, с.1102-1105.
16. Baliga В.J., Ehle R., Sears A. et al. Breakdown stability of gold, aluminum and tungsten Schottky barriers on gallium arsenide // IEEE Electron Devices Letters, 1982, v.EDL-3, N 7, pp.177-179.
17. Katsukawa K., Taheuchi T., Tokunaga K., Nagasako I. Failure analysis and reliability for X-band power GaAs FET //NEC Research and Development, 1983, N71, pp.82-87.
18. Dumas J.M., Paugam J., Le Mouellic C., Boulaire J.Y. Long term degradation of GaAs power MESFET’s induced by surface effects // In.:21th Ann.Proc.Reliab.Phys., Phoenix, Arizona, 1983, pp.226-228.
19. Акулова Г. В., Корнилова Т. А. Исследование дефектов в арсениде галлия, вводимых при термокомпрессии // Электронная техника, Сер. 3, Микроэлектроника, 1980, вып.1, с. 61-64
20. Sasagawa K., Kazushi N. Masumi S., Hiroyuki A. A method to predict electromigration failure of metal lines // Jour., Appl. Phys., 1999, vol.86, №11, pp. 6043- 6051.
21. Валиев К. А., Гольдштейн Р. В., Житников Ю. В. и др. Теория и моделирование разрушения тонкопленочных проводников, и долговечность металлизации интегральных микросхем. Часть I. Общая теория переноса вакансий, генерации механических напряжений и зарождения микрополостей при электромиграции. Деградация и разрушение многоуровневой металлизации //Микроэлектроника, 2009, т. 38, № 6, с. 404-427. Часть II. Деградация и объемное разрушение поликристаллической проводящей линии // Микроэлектроника, 2010, т. 39, № 3, с. 163-176.
22. Абдуллаев Г. В., Джафаров Т. Д. Атомная диффузия в полупроводниковых структурах. - М.: Атомиздат, 1980. - 280 с.
23. Физические основы надежности интегральных схем. / Сыноров В.Ф., Пивоваров Р.П., Петров Б.К., Долматов Т.В. / Под ред. Ю.Г. Миллер. – М.: Сов. Радио, 1976. – 320 с.
24. Горлов М.И., Строганов А.В. Геронтология интегральных схем. Долговечность алюминиевой металлизации // Петербургский журнал электроники, 1997, №1, c.27-37
25. Басс Ф.И., Гуревич Ю.Г. Горячие электроны и сильные электромагнитные волны в плазме полупроводников и газового разряда. – М.: Наука, Гл.ред. физ.-мат. Литературы, 1975. - 400с.
26. Ульев М.А. Эффекты горячих электронов в МОП- транзисторах // Обзоры по электронной технике. Серия 2 Полупроводниковые приборы, 1989, вып. 2(1431), 57c.
27. Синищук П.К., Чайка Г.Е., Шишияну Ф.С. Радиационно-стимулированная диффузия атомов в контакте металл-полупроводник // ФТП, 1985, т.19, вып.4, с. 674-677.
28. Абдурахимов Д.Е. и др. Изменение свойств полупроводниковых материалов в результате воздействия СВЧ импульсов наносекундной и микросекундной длительности // МЭ, 1991, т.20, вып.1, с.21-25.
29. Абдурахимов Д.Е. Бочикашвили П.Н., Калинушкин В.Д. и др. Воздействие электромагнитных СВЧ импульсов на структуру примесных неоднородностей в кристаллах кремния и характеристики полупроводниковых приборов // МЭ, 1992, т.21, вып.1, с.82-89.
30. Kryshtab T.G., Lytvin P.M., Masin M.A., Prokorenko I.v. // Metal Phys. and Technol., 1997, vol.19, N3, рp.71-77.
31. Беляев А.А., Беляев А.Е., Ермолович И.Б. и др. Влияние сверхвысокочастотной обработки на электрофизические характеристики технически важных полупроводников и поверхностно-барьерных структур // ЖТФ, 1998, т.68, №12, с.49-53.
32. Винник Е.В. и др. Использование мощного СВЧ излучения для быстрого отжига GaAs // Оптоэлектроника и полупроводниковая техника. 1989, №15, с.48-50.
33. Конева Н.А. Козлов Э.В. Природа субструктурного упрочнения // Изв.вузов. Физика, 1982. №8, c.3-14.
34. Ржанов А.В. и др. СВЧ нагрев как метод термообработки полупроводников // Письма в ЖТФ, 1981, т.7, вып.20, с.1221-1223.
35. Диденко А.Н. Козлов Э.В. Шаркеев Ю.П. и др. Дефектная структура меди после воздействия мощного импульсного электромагнитного излучения СВЧ-диапазона. // Докл. РАН, 1994, т.346, №5, c.918-926.
36. Терехов В.А., Манько А.Н., Бормонтов Е.Н. и др. Влияние сверхкоротких импульсов электромагнитного излучения на параметры структур металл-диэлектрик-полупроводник // ФТП, 2004, т. 38, вып. 12, с.1435-1438.
37. Brown W.D. Semiconductor device degradation by high amplitude pulses // IEEE Trans., 1972, v.NS-19, N6, pp.68-75.
38. Пентюш Э.В., Фонав Э.А, Эглитис В.Я. Развитие деградации кремниевых переходов при многократном образовании вторичного пробоя // Изв. АН ЛатвССР. Сер. физ. и техн. наук, 1978, № 6, с. 41-44.
39. Antinone R., Ng W.G. HPM testing of electronic components // Technical report UCID-21687, Lawrence Livermore national Laboratory, Livermore, CA.
40. Taylor C.D., Younan N.H. Effects from High Power Microwave Illumination // Microwave journal, 1992, vol.35, N6, pp.80, 82, 84, 86, 88, 93-96.
41. Garver R.V., Tatum J.T. Assessment Methodology for radio frequency effects // IEEE National Symposium on electromagnetic compatibility, 1989, рр.137 -142.
42. Магда И.И., Блудов С.Б., Гадецкий Н.П. и др. Механизмы деградации ИЭТ в полях мощного СВЧ излучения // Петербург. жур. Электроники, 1995, №3, c. 56-59.
43. Старостенко В.В., Таран Е.П., Григорьев Е.В., Борисов А.А. Воздействие электромагнитных поле на интегральные микросхемы // Измерительная техника, 1998, №4, c. 65-67.
44. Ключник А.В., Пирогов Ю.А., Солодов А.В. Исследование стойкости интегральных микросхем в электромагнитных полях импульсного радиоизлучения // РиЭ, 2011, т. 56, № 3, с.375-378. Klyuchnik A.V., Pirogov Yu.A., Solodov A.V. Investigation of the IC Resistance to Pulsed Electromagnetic Radiation // Journal of Communications Technology and Electronics, 2011, Vol. 56, N. 3, pp. 342–346.
45. Абдурахимов Д.Е. Бочикашвили П.Н., Калинушкин В.Д. и др. Воздействие электромагнитных СВЧ импульсов на структуру примесных неоднородностей в кристаллах кремния и характеристики полупроводниковых приборов // МЭ, 1992, т.21, вып.1, с.82-89.
46. Грибский М.П., Григорьев Е.В., Старостенко В.В. и др. Воздействие импульсных электромагнитных полей на современные микроконтроллеры // Прикладная радиоэлектроника, 2006, т. 5, № 2, с. 294–297.
47. Грибский М.П., Ахрамович Л.Н., Старостенко В.В. и др. Воздействие импульсных электромагнитных полей на интегральные микросхемы памяти // Радиоэлектроника и информатика, 2006, т. 35, № 4, с. 15–17.
48. Грибский М.П., Григорьев Е.В., Старостенко В.В., Унжаков Д.А. Воздействие импульсных электромагнитных полей на микросхемы АЦП и ЦАП // Радиоэлектроника и информатика, 2007, т. 39, № 4, с. 24–26.
49. Грибский М.П., Григорьев Е.В., Старостенко В.В. и др. Воздействие импульсных электромагнитных полей на экранированные микросхемы // Прикладная радиоэлектроника, 2007, т. 6, № 4, с. 590–593.
50. W.W. Everett III and W.W.Everett Jr. Microprocessor susceptibility to RF signals – experimental results // Proceedings of the 1984 Scutheastcon, April, 1984, pp.512-516.
51. Clayborne D. Taylor, Nicolas H. Younau. Effects from high power microwave illumination // Microwave Journal, 1988, vol.35, №6, pp.80-96.
52. Васильев К.Б., Ключник А.В., Солодов А.В. Статистика отказов цифровых ИМС, вызванных импульсным радиоизлучением // Тезисы докладов на 9-й Междунар. Крымская конфер. «СВЧ-техника и телекоммуникационные технологии», Севастополь, 1999, - С.329-330.
53. Ключник А.В., Солодов А.В. Статистическая модель повреждения цифровых интегральных микросхем импульсным радиоизлучением // Радиотехника, 2010, №2, с. 37-41.
54. Ключник А.В., Пирогов Ю.А., Солодов А.В. Модель накопления повреждений интегральными микросхемами в электромагнитных полях импульсного радиоизлучения // журнал Радиоэлектроники, 2010, №7, с. 1-12.
55. Ключник А.В., Пирогов Ю.А., Солодов А.В., Тюльпаков В.Н. Влияние радиоимпульсов высокого уровня мощности на работу смесителей // РиЭ, 2011, т. 56, № 3, с.370-374. Klyuchnik A.V., Pirogov Yu.A., Solodov A.V., Tyul’pakov V.N. Effect of High Power RF Impulses on the Mixer Operation // Journal of Communications Technology and Electronics, 2011, vol. 56, N. 3, pp. 347–350.
56. Garbe H., Camp M. “Susceptibility of different semiconductor technologies to EMP and UWB,” in XXVIIth General Assembly of the International Union of Radio Science (URSI) 2002, Maastricht, Nether-lands, August 17-24 2002.
57. Camp M., Garbe, H., Nitsch D. Influence of the technology on the destruction effects of semiconductors by impact of EMP and UWB pulses // IEEE International Symposium on EMC, 2002, vol.1, pp. 87 – 92.
58. Camp M., Gerth H., Garbe H., Haase H. Predicting the Breakdown Behavior of Microcontrollers under EMP/UWB Impact Using a Statistical Analysis. // IEEE Trans. on EMC, 2004, vol. 46, No. 3, pp. 368-379.
59. Korte S., Camp M., Garbe H. Hardware and Software Simulation of Transient Pulse Impact on Integrated Circuits.// International Symposium on EMC, 8-12 Aug. 2005, vol.2, pp.489 - 494
60. Грибский М.П., Старостенко В.В., Григорьев Е.В. и др. Прогнозирование стойкости микросхем при их работе в напряженных токовых режимах. // Вicник СумДУ. Серiя "Фiзика, математика, механiка", 2008, № 2, с.185-190.
61. Старостенко В.В., Грибский М.П., Полетаев Д.А. и др. Динамика электротепловых процессов в диэлектрических структурах микросхем при воздействии электромагнитных полей. // РИ, 2007, №4, с.45-49.
62. Rohe M., Korte S., Koch M. Simulation of the Destruction Effects in CMOS-Devices caused by Impact of Fast Transient Electromagnetic Pulses // [Электронный ресурс]. URL http://www.comsol.com/papers/5355/download/ Rohe.pdf
63. Methodology guidelines for high power microwave (HPM) susceptibility assessments. Ed. By N.J. Chesser. Report. Chairman–A.Pesta.Jan.1990г. ДСП.
64. Ключник А.В., Маслов Д.Е., Солодов А.В. Тепловое повреждение интегральных микросхем // Электр. Техн. Сер. СВЧ техн. 1994, Вып. 1 (461), с. 46-48.

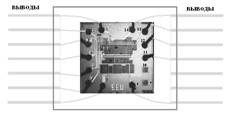
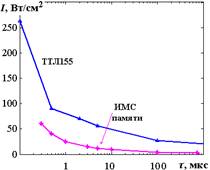
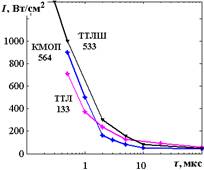


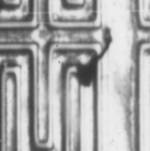

 а
а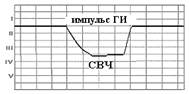 б
б в
в