УДК 621.382
ОБ ОЦЕНКЕ МОЩНОСТИ
ТЕПЛОВОГО ПОРАЖЕНИЯ ДИОДНЫХ
ПОЛУПРОВОДНИКОВЫХ СТРУКТУР ИМПУЛЬСНЫМ
ЭЛЕКТРОМАГНИТНЫМ ИЗЛУЧЕНИЕМ
С.А. Мещеряков
Федеральное автономное учреждение "Государственный научно-исследовательский испытательный институт проблем технической защиты информации ФСТЭК России"
Статья получена 9 июня 2014 г.
Аннотация. В рамках численной модели в диффузионно-дрейфовом тепловом приближении приведены результаты расчета энергомощностных характеристик для p – n-переходной структуры и структуры с барьером Шоттки при воздействии импульсного электромагнитного излучения. Показано различие в оценке мощности теплового поражения по двум критериям: падающей внешней мощности и рассеиваемой внутренней мощности. Проведено сравнение энергомощностных характеристик теплового поражения диодных структур для сверхвысокочастотного и прямоугольных импульсов в диапазоне температур теплового разогрева 400...1400 °С.
Ключевые слова: численная модель, полупроводниковая структура, импульсное излучение, мощность теплового поражения.
Abstract: Within the limits of numerical model in drift-diffusion thermal approach of calculation of power characteristics for p-n-structure and structure with a Schottky barrier are given at action of a pulsing electromagnetic radiation are given. Distinction is shown in an estimate of thermal defeat power by two criterions – incident exterior power and diffused interior power. Characteristics of thermal burnout of the diode-structures for microwave and square pulses in a gamut of temperatures of a thermal heating 400 ... 1400 °С is compare.
Key words: numerical model, semiconductor structure, pulse radiation, power of thermal burnout.
Введение
Анализ экспериментальных данных [1 – 8] по влиянию импульсного электромагнитного излучения (ЭМИ) на однотипные полупроводниковые диоды показывает существенную разницу в оценках мощности (энергии) их теплового поражения, составляющую свыше двух порядков при одинаковых длительности и форме воздействующего импульса. Однако геометрические размеры этих полупроводниковых диодов, а значит и подверженный разогреву объем структуры (или ее части) не имеют столь существенного разброса. В рамках распространенных тепловых моделей [2, 9, 10], основанных на рассмотрении только падающей мощности и трактующих всю поступающую "извне" энергию как тепловую и полностью поглощаемую полупроводниковой структурой, объяснить указанную разницу в оценке мощности теплового поражения весьма затруднительно.
В отличие от тепловых моделей представленный в [11 – 15] подход к расчету влияния ЭМИ на полупроводниковые диодные структуры основан на рассмотрении наведенного (на штатные или случайные антенны) или непосредственно поданного в схему измерения электрического сигнала. Под воздействием сигнала ток внутри структуры приводит к возникновению тепловых процессов, влияющих на динамику саморазогрева структуры, и, как следствие, к функциональным сбоям в работе или необратимому тепловому поражению (выгоранию). Указанная трансформация – "воздействующая мощность – электрический сигнал – рассеиваемая мощность" – приводит к необходимости использования двух критериев оценки мощности. Первый критерий должен характеризовать рассеиваемую внутри структуры и приводящую к тепловому разогреву электрическую мощность, связанную с процессами зарядо- и теплопереноса. Второй критерий должен определять необходимую для разогрева внешнюю падающую мощность, зависящую как от рассеиваемой мощности внутри структуры, так и от характеристик приемного тракта аппаратуры, генератора или схемы измерения. Иными словами, первый критерий характеризует энергию (мощность), разогревающую структуру "изнутри", второй – энергию, обеспечивающую этот разогрев "извне".
Цель данной работы – продемонстрировать различие в указанных критериях оценки мощности и энергии теплового поражения импульсом ЭМИ при помощи модели, основанной на диффузионно-дрейфовом тепловом приближении (ДДМТ), на примере диодных структур: биполярной (p – n-переходной) и структуры с барьером Шоттки.
Постановка задачи
Вычисления будем проводить для p – n-переходной структуры и структуры с барьером Шоттки на основе кремния в рамках одномерной ДДМТ. Электрофизические параметры кремния (подвижности свободных носителей заряда, теплопроводность и др.) и их температурные зависимости взяты из [16].
На рис. 1а
представлен профиль распределения легирующей примеси N(x)
в биполярной n+ – p – p+ – p++-диодной
структуре. К n+-эмиттеру
примыкает теплоизолированный омический контакт (![]() ), к p++-области
– омический теплоотводящий контакт (T
= T0
= 20 ºС). Площадь эмиттерного контакта
), к p++-области
– омический теплоотводящий контакт (T
= T0
= 20 ºС). Площадь эмиттерного контакта
S =
6.2×10-6 см2.
Рис. 1б иллюстрирует профиль распределения легирующей примеси N(x) в диодной n – n+ – n++-структуре с барьером Шоттки. К эпитаксиальной пленке n-типа примыкает теплоизолированный выпрямляющий контакт Шоттки с высотой потенциального барьера Fb = 0.7 эВ, к n++-области – омический теплоотводящий контакт. Площадь выпрямляющего контакта Шоттки S = 7.5×10-6 см2.
Исходное значение сопротивления обеих структур при указанных параметрах составляет 250 Ом, что соответствует типовым значениям выходного сопротивления СВЧ-диодов [17].
Не приводя весь набор уравнений ДДМТ (см., например, [14]), требуемый для расчетов электротепловых характеристик полупроводниковой структуры, выделим уравнение теплопроводности, используемое при оценке внутренних рассеиваемых мощности и энергии


(а) (б)
Рис.
1.
Профили легирующей примеси диодных структур и типы проводимости различных
областей (n – электронный, p – дырочный);
а – биполярная структура, б – структура с барьером Шоттки.
где r – плотность вещества; cp – удельная теплоемкость вещества; T – абсолютная температура; l – коэффициент теплопроводности полупроводника; Jn, Jp – плотность тока электронов и дырок соответственно; E – напряженность электрического поля; R – темп рекомбинации; G – темп генерации; Ec, Ev – энергетические уровни дна зоны проводимости и потолка валентной зоны соответственно; kB – постоянная Больцмана.
Из уравнения (1) следует, что рассеиваемая мощность, приводящая к изменению температурного поля в каждой точке структуры, связана с тремя электрическими процессами: разогрев протекающим внутри структуры током (Джоулево тепло), выделение дополнительного тепла за счет рекомбинации и поглощение тепла за счет генерации.
Интегрирование по длине моделируемой структуры правой части уравнения (1) дает мгновенную рассеиваемую плотность мощности P(t). Энергия W, рассеиваемая за время импульса tp, и средняя рассеиваемая мощность Pav за время импульса вычисляются по следующим формулам:
 , (2)
, (2)
![]() . (3)
. (3)
Внешняя падающая мощность Pinc (с учетом сопротивления приемной антенны или генератора R и амплитуды или уровня наведенного электрического сигнала U0) и соответствующая ей энергия Winc определяются из уравнений
где ![]() в случае сверхвысокочастотного (СВЧ)
импульса и
в случае сверхвысокочастотного (СВЧ)
импульса и ![]() в случае прямоугольного импульса;
в случае прямоугольного импульса;
![]() .
(5)
.
(5)
Уравнения (2) – (5) иллюстрируют разницу в подходе к оценке энергомощностных характеристик воздействия импульса ЭМИ на исследуемые структуры по критериям внешней падающей мощности и внутренней рассеиваемой мощности. Как следует из уравнения (4), внешняя падающая мощность Pinc складывается из двух компонентов. Первое слагаемое характеризует мощность, рассеиваемую на активном сопротивлении антенного тракта (генератора, схемы измерения и др.), второе – мощность, рассеиваемую на диодной структуре.
"Общей точкой", связывающей представленные характеристики, служит временная зависимость напряжения наведенного сигнала u(t) с амплитудой (или уровнем) U0. С одной стороны, использование ее в качестве граничного условия для электрической составляющей ДДМТ позволяет в каждый момент времени оценить параметры источников и приемников тепла для уравнения (1), рассчитать температурное поле внутри структуры и получить значение длительности импульса, необходимое для достижения заданной максимальной температуры. С другой стороны, значение напряжения U0 и полученная длительность импульса tp дают "внешние" энергомощностные характеристики.
В зависимости от соотношения указанных слагаемых будет наблюдаться разное поведение энергомощностных характеристик внешнего импульсного воздействия. Если до воздействия в идеальном случае существует полное согласование (равенство) сопротивлений антенны или генератора и диодной структуры, то при воздействии импульса изменение сопротивления диодной структуры будет влиять на соотношение слагаемых уравнения (4). Как показано в [14, 18, 19], сопротивление диодной структуры при этом будет уменьшаться, и бóльшая часть падающей мощности будет приходиться именно на структуру. В результате характер поведения Pinc будет близок к Pav. Если же изначально сопротивление R значительно меньше сопротивления диодной структуры (например, случайная антенна в виде низкоомных межсоединений на платах аппаратуры), то бóльшая часть падающей мощности будет приходиться на R, а характер поведения Pinc будет соответствовать PR. Рассмотрим оба этих случая.
Результаты моделирования
На рис. 2а, 2б приведены зависимости W и Pav от длительности СВЧ-импульса с несущей частотой f = 1 ГГц для биполярной структуры и структуры с барьером Шоттки, полученные согласно уравнениям (2) и (3) из результатов численного моделирования их внутренних электротепловых характеристик вплоть до температуры плавления кремния (1400 °С). Штриховыми линиями показаны одинаковые амплитуды воздействующего сигнала.
Графики на рис. 2 содержат ранее известные из теоретических расчетов и экспериментальных данных характерные участки поведения энергомощностных характеристик при различных длительностях импульсного воздействия: в определенных диапазонах tp они близки к известным зависимостям Вунша–Белла [9] и адиабатической [2, 10]. Кроме того, в области сверхкоротких импульсов (tp < 10…50 нс) при U0 > 200 В наблюдается экспериментально выявленный в [20] участок (назовем его "генерационный"), характеризующийся ростом энергии с дальнейшим ее насыщением. Причиной возникновения этого участка является рассматриваемый в ДДМТ приемник тепла, связанный с генерационными процессами, наиболее существенными при больших значениях амплитуды воздействующего сигнала, в то время как в тепловых моделях априорно предполагается наличие только источников тепла, приводящих непосредственно к разогреву структуры [11, 12].
На рис. 3а, 3б показаны рассчитанные в условиях полного согласования (R = 250 Ом) соотношения рассеиваемой мощности (энергии) и падающей мощности (энергии) для исследуемых структур. Из представленных характеристик видно, что при tp = 100…105 нс рассеиваемые мощность Pav и энергия W составляют 60…80 % от падающей мощности Pinc (энергии Winc) для биполярной структуры и 50…90 % для структуры с барьером Шоттки в зависимости от максимальной температуры разогрева Tmax и длительности однократного СВЧ-импульса.
Характер поведения кривых отношения мощностей (энергий) на рис. 3 противоположен поведению кривых мощностей (энергий) на рис. 2: максимальным значениям зависимости W/Winc(tp) соответствует минимум зависимости W(tp), а замедление роста рассеиваемой энергии в областях очень коротких импульсов (менее 10 нс) и длинных импульсов (более 104 нс) приводит к резкому изменению соотношения W/Winc(tp).
Так как в биполярной структуре неосновные носители играют определяющую роль во всех механизмах зарядопереноса, а следовательно, и теплопереноса (через тепловую обратную связь), то рекомбинационные процессы в них более существенны, чем в униполярных структурах с барьером Шоттки. Это приводит к выравниванию распределения мощности и температуры по всей глубине биполярной структуры. Из зависимости W(tp) видно, что рост энергии на "генерационном" участке в области коротких импульсов у биполярных структур (рис. 2а) менее выражен, чем у структур с барьером Шоттки (рис. 2б) из-за быстро нарастающей компенсации темпа генерации (приемника тепла) темпом рекомбинации (источником тепла). Этим же объясняется и более выраженное насыщение W(tp) при дальнейшем уменьшении времени импульсного воздействия. В результате размытость максимума характеристики W/Winc(tp) для биполярной структуры больше, чем для структуры с барьером Шоттки (см. рис. 3).
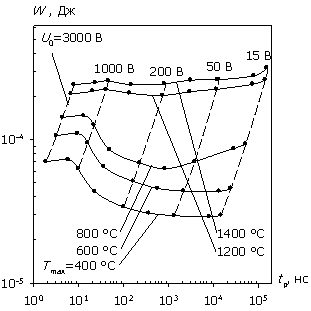
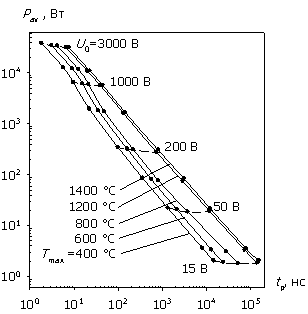
(а)

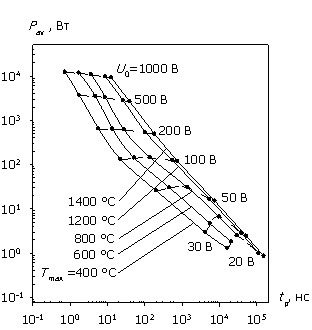
(б)
Рис.
2.
Зависимости W(tp) и Pav(tp);
а – биполярная структура; б – структура с барьером Шоттки.
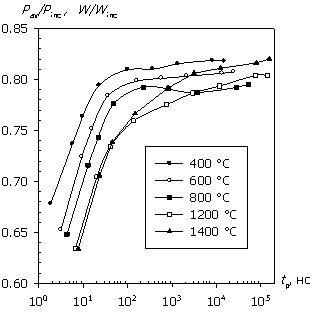
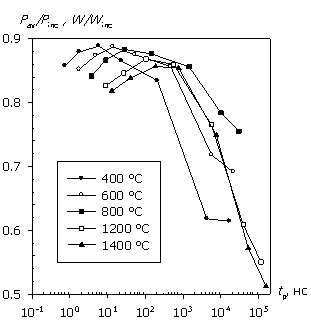
(а) (б)
Рис. 3. Соотношения
рассеиваемой и падающей мощности (энергии);
СВЧ-импульс; полное согласование; а – биполярная структура,
б – структура с барьером Шоттки.
На рис. 4а, 4б показаны рассчитанные для диодных структур в условиях отсутствия согласования (R = 1 Ом) падающая мощность и энергия в зависимости от длительности СВЧ-импульса. Сравнение энергомощностных характеристик (рис. 2 и рис. 4) показывает, что в этом случае Pinc и Winc больше Pav и W почти на два порядка, и в отличие от полного согласования в данном случае соотношения мощностей составляют доли процента. Но при этом усиливается искажение характеристик Pinc и Winc в силу уравнений (4), (5) и формы соотношений W/Winc(tp) и P/Pinc(tp) на рис. 3. Сравнение рис. 2 и рис. 4 показывает, что зависимость Winc(tp) растет значительно быстрее W(tp) для биполярной структуры при U0 > 200 В и для структуры с барьером Шоттки при U0 < 50 В. Иными словами, использование экспериментально наблюдаемой зависимости Winc(tp) (или Рinc(tp)) может давать существенную погрешность в оценке температуры теплового поражения, которая тем больше, чем больше степень рассогласования.
Очевидно, что отмеченные различия в энергомощностных характеристиках при воздействии СВЧ-импульса будут проявляться и для других форм импульсов. На рис. 5а, 5б приведены результаты расчетов падающей и рассеиваемой мощности (энергии) для прямоугольных импульсов различной полярности при R = 1 Ом в сравнении с СВЧ-импульсом. Обозначено: П+ – прямая полярность, П- – обратная.
Сравнительный анализ представленных на рис. 5 графиков показывает следующее. Наибольшее различие в характере поведения энергомощностных характеристик диодных структур наблюдается при воздействии П--импульса.

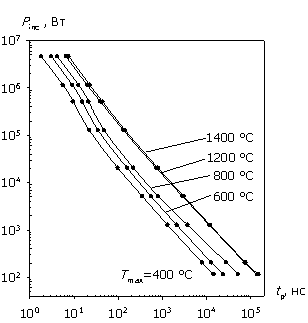
(а)
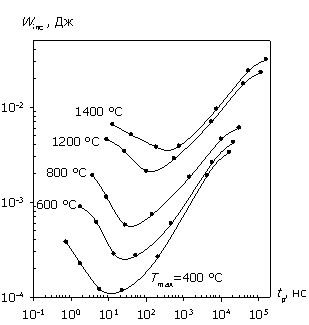
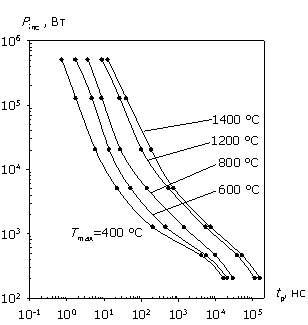
(б)
Рис. 4. Зависимости Winc(tp) и Pinc(tp); отсутствие согласования; СВЧ-импульс;
а – биполярная структура; б – структура с барьером Шоттки.

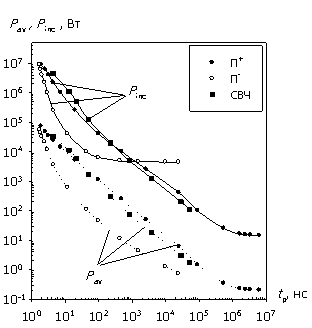
(а)


(б)
Рис. 5. Зависимости W(tp), Winc(tp), Pav(tp) и Pinc(tp) для СВЧ и
прямоугольных импульсов; отсутствие согласования; Tmax = 800 ºС;
а – биполярная структура;
б – структура с барьером Шоттки.
В этом случае обе структуры могут пропустить значительный ток, приводящий к тепловому разогреву до определенной температуры, только в состоянии лавинного пробоя. Следовательно, уровень воздействующего напряжения при увеличении времени импульса асимптотически стремится сверху к пробивному напряжению. В итоге, "внутренние" характеристики показывают насыщение энергии W, так как объем, затронутый лавинной генерацией, практически постоянен. Это насыщение особенно выражено для структур с барьером Шоттки, где рекомбинационные процессы менее значимы. Средняя за время импульса мощность Pav при этом падает. Противоположно этому "внешние" характеристики в силу уравнения (4) дают насыщение мощности Pinc (требуется поддержка определенного уровня напряжения U0 при любой длительности импульса), но тогда из уравнения (5) получаем асимптотически бесконечный рост энергии Winc с увеличением tp.
Наименьшее различие в характеристиках наблюдается при воздействии П+-импульса, дающего наиболее равномерное распределение рассеиваемой мощности по всей длине структуры. Следует также предполагать наличие указанных для П--импульса участков насыщения W и Pinc при tp > 107 нс, когда уровень напряжения приближается к стационарному значению (точка вольт-амперной характеристики), соответствующему заданной температуре разогрева.
Характеристики воздействия
СВЧ-импульса находятся, в общем случае, между характеристиками прямоугольных
импульсов. Отклонения от этой тенденции связаны с генерационно-рекомбинационными
процессами, изменением объема локализации и перераспределением внутри структуры
энергии, идущей на тепловой разогрев согласно уравнению (1). Как следует из
рис. 5 для биполярной структуры воздействие СВЧ-импульса ближе к воздействию
П+-импульса при tp
= 1…105 нс. Для структуры с барьером Шоттки воздействие СВЧ-импульса
ближе к воздействию П+-импульса при tp
= 102…105 нс и к воздействию П--импульса при tp
= 1…102 нс.
Заключение
Результаты моделирования демонстрируют, что оценки мощности и энергии теплового разогрева импульсным ЭМИ по "внешнему" и "внутреннему" критериям отличаются как по величине, так и по характеру поведения, и существенно зависят от степени согласования сопротивлений антенны (генератора, схемы измерения) и диодной структуры. Наибольшее расхождение в оценках по указанным критериям свойственно прямоугольному импульсу обратной полярности при стремлении напряжения воздействующего сигнала к пробивному напряжению диодной структуры.
На основании полученных результатов моделирования можно утверждать, что согласованные антенные тракты приемо-передающей радиоэлектронной аппаратуры, содержащие полупроводниковые детекторные и смесительные диоды, наиболее подвержены тепловому поражению мощным СВЧ ЭМИ.
Литература
1. Сорокин Л.Н., Усыченко В.Г., Щерстюк А.В. Выгорание полупроводниковых приборов под воздействием сверхвысокочастотных импульсов и электрических видеоимпульсов // Радиотехника и электроника. – 2010. – Т. 55. – № 5. – С. 631-638.
2. Dwyer V.M., Franklin A.J., Campbell D.S. Thermal failure in semiconductor devices // Solid-State Electronics. – 1990. – V.33. – N 5. – P. 553-560.
3. Anand Y., Moroney W.J. Microwave mixer and detector diodes // Proceedings of the IEEE. – 1971. – V. 59. – N 8. – P. 1182-1190
4. Ahmad K. RF burnout in X-band Schottky mixers // Journal of Applied Physic. – 1972. – V. 43. – N 11. – P. 4826-4827.
5. Guccione S.A. Pulse burnout of microwave mixer diodes // IEEE Transaction on Reliability. – 1973. – V. R-22. – N. 4. – P. 196-207.
6. Whalen J.J. The RF pulse susceptibility of UHF transistors // IEEE Transaction on Electromagnetic Compatibility. – 1975. – V. EMC-17. – N 4. – P. 220-225.
7. Diaz C., Kang S., Duvvury Ch. Simulation of electrical overstress thermal failures in integrated circuits // IEEE Transaction on Electron Devices. – 1994. – V. ED-41. – N. 3. – P. 359-366.
8. Anand Y. X-band high burnout resistance Schottky-barrier diodes // IEEE Transaction on Electron Devices. – 1977. – V. ED-24. – N. 12. – P. 1330-1336.
9. Wunsh D.C., Bell R.R. Determination of threshold failure levels of semiconductor diodes and transistors due to pulse voltage // IEEE Transaction on Nuclear Science. – 1968. – V. NS-15. – N 6. – P. 244-259.
10. Taska D.M. Pulse power failure modes in semiconductors // IEEE Transaction on Nuclear Science. – 1970. – V. NS-17. – N 7. – P. 364-372.
11. Мещеряков С.А. Моделирование физических процессов в полупроводниковых структурах при воздействии мощного СВЧ-импульса. Структуры с барьером Шоттки [Электронный ресурс] // Журнал радиоэлектроники: электронный журнал. – 2013. – № 11. – Режим доступа: http://jre.cplire.ru/jre/nov13/2/text.pdf.
12. Мещеряков С.А. Моделирование физических процессов в полупроводниковых структурах при воздействии мощного СВЧ-импульса. Биполярные структуры [Электронный ресурс] // Журнал радиоэлектроники: электронный журнал. – 2013. – № 12. – Режим доступа: http://jre.cplire.ru/jre/dec13/6/text.pdf.
13. Мещеряков С.А. Моделирование теплового поражения диодных полупроводниковых структур полиимпульсным сверхвысокочастотным радиоизлучением [Электронный ресурс] // Журнал радиоэлектроники: электронный журнал. – 2013. – № 7. – Режим доступа: http://jre.cplire.ru/jre/jul13/4/text.pdf.
14. Бердышев А.В., Мещеряков С.А. Численное моделирование физических процессов в кремниевых полупроводниковых p – n-переходных структурах при воздействии электромагнитного излучения сверхкоротких импульсов // Радиотехника и электроника. – 2013. – Т. 58. – № 7. – С. 726-734.
15. Мещеряков С.А., Бердышев А.В. Электротепловая модель воздействия электромагнитного излучения на полупроводниковые структуры // Радиотехника и электроника. – 2013. – Т. 58. – № 11. – С. 1127-1135.
16. NSM Archive – Physical Properties of Semiconductors [Электронный ресурс]. Режим доступа: http://www.ioffe.rssi.ru\SVA\NSM\Semicond\index.html.
17. Диоды: Справочник / О.П. Григорьев и др. М.: Радио и связь, 1990.
18.
Brown W.D. Semiconductor device degradation by high amplitude current pulses
// IEEE Transaction on Nuclear Science. – 1972. – V. NS-19. – N 2. –
P. 68-75.
19. Prokopyev A.I., Mesheryakov S.A. Static characteristics of high-barrier Schottky diode under high level injection // Solid-State Electronics. – 1999. – V. 43. – N 9. – P. 1747-1753.
20. Юшков Ю.Г., Чумерин П.Ю., Артеменко С.Н. и др. Экспериментальное исследование воздействия сверхвысокочастотных импульсов на работу персонального компьютера // Радиотехника и электроника. – 2001. – Т. 46. – № 8. – С. 1020-1024.
