|
|
"ЖУРНАЛ РАДИОЭЛЕКТРОНИКИ" N 3, 2005 |
|
Тестирование двухслойных структур молибден-медь
А.Г. Коваленко
Институт радиотехники и электроники РАН
Получена 15.03.2005 г.
При изготовлении двухслойных структур «молибден-медь» с целью исследования сверхпроводникового фазового перехода при сверхнизких температурах (50 мК – 1,0 К) в таких структурах и оценки чувствительности болометров на их основе [1-4] возникает необходимость измерения с высокой точностью толщины и формы поверхности слоев и двухслойной структуры в целом.
В процессе изготовления двухслойных структур задавалось время осаждения пленки, при этом скорости осаждения слоев (при выбранных параметрах осаждения) были заранее прокалиброваны. Для измерения толщин слоев и суммарной толщины структуры после каждого напыления использовался профилометр “ALPHA-STEP 200” фирмы KLA-Tencor (рис. 1). Принцип работы профилометра – механический. Плоский образец кладется на столик. Игла профилометра подводится к поверхности образца до касания, а затем в автоматическом режиме прижимается с усилием 25 мг и проходит некоторое расстояние (в нашем случае 400 мкм) по прямой в горизонтальной плоскости, фиксируя неровности поверхности с точностью до 10 Å, при этом столик и образец неподвижны. Результат в виде кривой появляется на экране прибора (рис. 1). Для измерения толщины слоев профилометром изготавливались тестовые образцы с перепадом высоты ступеньки, равным толщине слоя в структуре.
|
|
|
|
|
Рис. 1. Фотография профилометра Alpha-Step 200, фирмы KLA-Tenkor с характерной кривой – результатом замера высоты ступеньки |
||
Для изготовления тестовых образцов методом взрывной фотолитографии применяется набор фотолитографического оборудования, включающий в себя центрифугу для нанесения фоторезиста методом раскрутки, сушильный шкаф, установку совмещения. На очищенную кремниевую подложку методом раскрутки наносится фоторезист (S1813) и засушиваетя в печи при температуре 90 С в течение 30 мин. Затем на установке совмещения на подготовленную вышеуказанным образом подложку через фотошаблон засвечивается любой рисунок, удобный для прохождения иглы профилометра, и, затем, проявляется. На подложке получается некоторый рисунок из фоторезиста (рис.2 a). Поместив эту подложку в вакуумную камеру напылительной установки вместе с основным образцом, получают на тестовом образце пленку той же толщины, что и на основном образце (рис.2 б). Далее осуществляется процесс взрыва литографической маски (lift-off) путем опускания тестового образца в кювету с органическим растворителем (ацетон, диметилформамид). При этом фоторезист растворяется, «взорвав» находящуюся над ним пленку напыленного материала, а на тестовом образце останется «ступенька», высота которой равна толщине пленки напыленного материала (рис.2 в). Таким образом получаются ступеньки с высотой, равной как толщине каждого слоя двухслойной структуры, так и ее суммарной толщине. Проходя поперек «ступеньки», игла профилометра измеряет ее высоту. На экране профилометра получается соответствующая кривая (рис. 1).
|
|
. |
|
Рис. 2. Схема процесса изготовления тестового образца методом взрывной фотолитографии для измерения толщины слоя: (а) маска из фоторезиста, (б) маска с напыленной на нее пленкой до взрыва, (в) рисунок из напыленной пленки после взрыва. |
|
На рис.3 показана часть тестового образца, изготовленного для измерений толщины слоев.
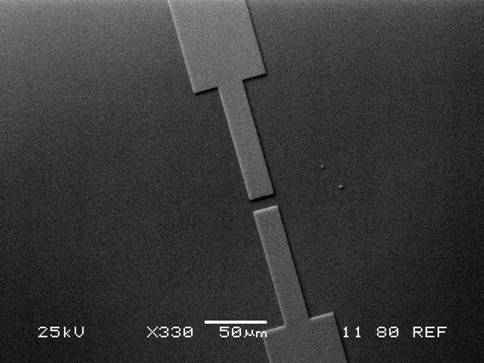
Рис. 3. Изображение тестового образца, полученное на электронном микроскопе JEOL-6460 в обратно-рассеянных электронах.
Для выборочного контроля поверхности слоев образцы исследовались на микроскопе атомных сил Solver P47H. Были отобраны тестовые образцы молибдена толщиной 15 нм и двухслойная структура из молибдена толщиной 15 нм и меди толщиной 35 нм. На рис. 4 и рис. 5 приведены результаты исследования: поверхности пленки молибдена и двухслойной структуры: шероховатость поверхности молибдена δМо= 0,253 нм, шероховатость поверхности меди в двухслойной структуре δCu=0,418 нм.
С точки зрения конструкции болометра не имеет значения взаимное расположение слоев на подложке. Принятый порядок осаждения металлов, сначала молибден, затем медь, был продиктован следующими соображениями. Тонкие (20 – 30 нм) пленки меди на подложке из диэлектрика могут при температуре порядка 200 С начать рост, образовывая монокристаллические островки (механизм Фольмера-Вебера) [5]. В данной работе получение монокристаллических пленок было нежелательным, так как это ведет к уменьшению остаточного сопротивления материала. Поэтому сначала осаждался молибден, он служил подслоем для пленки меди, то есть, пленка меди осаждалась на металл (молибден). Кроме того, как сказано в [1], держатель образцов охлаждался водой в процессе осаждения пленок. Это позволило исключить возможность монокристаллического островкового роста пленок меди.
На рис. 6 (а, б) помещены результаты исследований пленки Мо (15 нм) и на рис. 6в – двухслойной структуры (Мо – 15 нм, Сu – 35 нм) на растровом электронном микроскопе JEOL –6460. Эти исследования в совокупности с исследованиями на микроскопе атомных сил (см. выше) показали, что и пленка молибдена, и двухслойная структура – сплошные и достаточно гладкие.
.
|
|
Рис. 4. Исследование пленки Мо 15 нм на микроскопе атомных сил
|
|
Рис. 5. Исследование двухслойной структуры Мо/Си (15/35 нм) на микроскопе атомных сил
|
10 мкм
|
|
Рис. 6. Изображение центральной части тестового образца (рис. 3) в растровом электронном микроскопе JEOL 6460: 6а, 6б - материал – молибден 15 нм толщиной (6а - во вторичных электронах (SE) и 6б- в обратно рассеянных электронах (REF), 6в – структура Мо (15 нм) / Cu (35 нм) во вторичных электронах (SE).
|
Автор выражает благодарность В.В. Казьмируку и А.Л. Власюку за помощь в измерениях.
Литература
[1] Выставкин А.Н., Дмитриев В.В., Завьялов В.В., Коваленко А.Г., Ковтонюк С.А. , Чеботарев А.А. // Радиотехника и электроника, 2003, Т. 48, № 7, С. 874-876.
[2] Выставкин А.Н., Коваленко А.Г., Ковтонюк С.А. // Радиотехника и электроника, 2004,
Т. 49, № 6, С. 757-760.
[3] Vystavkin A.N., Kovtonyuk S.A., Kovalenko A.G. // Nuclear Instruments and Methods in Physics Research, 2004, V. A 520, P. 289-292.
[4] Kovalenko A.G., Kovtonyuk S.A., Vystavkin A.N. // The Proc. of the 5th Intern. Kharkov Symposium on Physics and Engineering of Microwaves, Millimeter and Submillimeter Waves, June 21 -26, 2004, Kharkov, Ukraine, Р. 598-600.
[5] Трофимов В.И., Осадченко В.А., Рост и морфология тонких пленок. // Москва, Энергоатомиздат, 1993, 272 с.
 |
 |