УДК 621.38-022.532
ПРИМЕНЕНИЕ ПЛАЗМОСТОЙКОГО НЕГАТИВНОГО ЭЛЕКТРОННОГО РЕЗИСТА ИЗ ПОЛИЭФИРСУЛЬФОНА ПРИ ИЗГОТОВЛЕНИИ ЧУВСТВИТЕЛЬНЫХ К ПРИМЕСЯМ СВЕРХПРОВОДНИКОВЫХ СТРУКТУР
А. С. Ильин, И. А. Кон, А. Г. Коваленко
Институт радиотехники и электроники им. В.А.Котельникова РАН
Статья получена 20 ноября 2014 г.
Аннотация: Для изготовления сверхпроводниковых микроструктур из титана методами электронно-лучевой литографии исследовано применение негативного плазмостойкого резиста на базе полиэфирсульфона. Резистные маски из полиэфирсульфона обладают высокой химической, термической и механической стойкостью. Это позволило избежать негативных последствий дегазации резиста и его задубливания и получить титановые микроструктуры, обладающие высокой чистотой, для их применения в сенсорах на краю сверхпроводникового перехода. Негативность резиста позволяет уменьшить время экспозиции и снизить риски, связанные с термодрейфом держателя образцов.
Ключевые слова: полиэфирсульфон, электронно-лучевая литография, негативный резист, дегазация, титан, сверхпроводниковые микроструктуры.
Abstract: Use of negative plasma-stable resist based on poly(ether sulfone) for superconducting titanium microstructures fabrication using electron-beam lithography methods is investigated. Poly(ether sulphone) resist masks show high chemical, thermal and mechanical stability. This allows to avoid negative effects of resist outgassing and hardening, and fabricate titanium microstructures of high purity for their use in transition edge sensors. Resist’s negativity allows to decrease duration of exposure and to reduce risk related to thermal drift of specimen holder.
Keywords: poly(ether sulfone), electron-beam lithography, negative resist, outgassing, titanium, superconducting microstructures.
Введение
Важной проблемой при создании сенсоров на краю сверхпроводникового перехода (СКП), работающих при температурах криорефрижераторов сорбционного типа (~ 0,3 К), является сохранение чистоты материала сенсора в процессе литографии. Это обусловлено высокой чувствительностью сверхпроводников, в частности, ниобия или титана, к примесям, попадающим в них в процессах осаждения или травления [1].
Создание таких сенсоров требует применения электронно-лучевой литографии, поскольку одним из параметров, повышающих чувствительность прибора, является малый объем сенсора [2]. При этом для создания литографической маски наиболее широко используется позитивный резист на основе полиметилметакрилата (ПММА) [3]. Существенным недостатком применения ПММА для резистных масок в процессе ионно-плазменного осаждения материала на подложку является его дегазация, приводящая к загрязнению материала сверхпроводника. Также, в процессе ионного травления, существует значительный риск задубливания маски из ПММА, в процессе удаления которой могут быть повреждены сформированные микроструктуры. Кроме того, использование масок из позитивного резиста ПММА для создания структур микронных и субмикронных размеров предполагает экспозицию электронным лучом большой площади с использованием инвертированного шаблона, что на порядок увеличивает время экспозиции и значительно увеличивает риск термодрейфа держателя образцов, который может привести к искажениям геометрии структур.
Таким образом, оптимальным для создания микроструктур для СКП является процесс, в котором маска изготовлена из негативного плазмостойкого резиста для электронно-лучевой литографии.
Исследования [4] показали, что наибольшей плазмостойкостью обладают полимеры, имеющие либо двойные связи, либо циклические структуры. Например, метод введения плазмостойких звеньев был применен в работе Lee et al. [5] для разработки фоторезиста. Полиэфирсульфон (PES) – полимер, относящийся к семейству полисульфонов, имеющий в каждом звене по две ароматические группы, может применяться в качестве негативного электронного резиста [6]. PES обладает высокой ударной прочностью, сопротивлением растяжению, стойкостью к УФ-излучению, воде (в том числе горячей) и агрессивным химическим средам. Сохраняет прочность и жесткость при экстремально низких и высоких температурах, а также при резких температурных перепадах.
Для изготовления резиста использовался полиэфирсульфон марки BASF Ultrason, растворенный в димметилацетамиде. Также диметилацетамид использовался в качестве проявителя (при комнатной температуре), при удалении резиста использовался ацетон, нагретый до 50°C.
Изготовление образцов
Были изготовлены образцы титановых микроструктур как в процессе жидкостного травления в буферном растворе фтороводородной кислоты (HF), так и в процессе ионного травления в плазме аргона.
Для получения образцов при помощи жидкостного травления были произведены следующие операции:
1. Чистка подложки в изопропаноле и диметилформамиде с тряской в ультразвуковой ванне.
2. Формирование ниобиевых подводящих линий и знаков совмещения.
3. Формирование палладиевых контактных площадок.
4. Чистка подложки.
5. Осаждение титана.
6. Формирование маски для травления из PES.
7. Травление титана в HF.
8. Удаление маски в ацетоне.
Фотография конечного результата технологических операций представлена на рисунке 1.
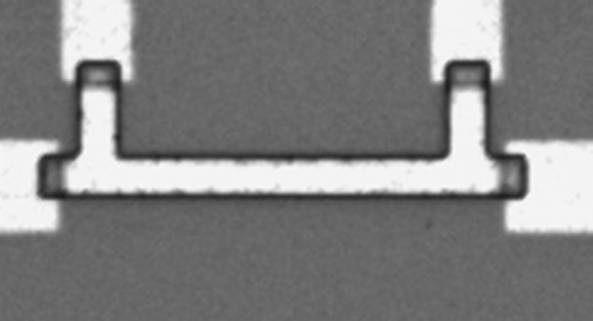
Рисунок 1. Фотография в оптическом микроскопе тестового титанового образца, полученного с помощью жидкостного травления через маску из PES.
Для изготовления образцов путем ионного травления в плазме аргона были произведены следующие операции:
1. Чистка подложки в изопропаноле и диметилформамиде с тряской в ультразвуковой ванне.
2. Осаждение титана.
3. Формирование маски для травления из PES (со знаками совмещения).
4. Травление титана в плазме аргона.
5. Удаление маски в ацетоне.
6. Формирование ниобиевых подводящих линий.
7. Формирование палладиевых контактных площадок.
8. Чистка подложки.
Образцы, изготовленные методом ионного травления через маску из PES, изображены на рисунке 2.
Кроме того, аналогичным образом были изготовлены образцы для исследования на профилометре.

Рисунок 2. Фотография в оптическом микроскопе тестового титанового образца полученного с помощью ионного травления через маску из PES.
Результаты
Как для образцов, полученных с использованием жидкостного травления в HF, так и для образцов, полученных с использованием ионного травления в плазме аргона, отмечается следующее.
Проэкспонированный полиэфирсульфон легко растворяется в стандартных разогретых органических растворителях (DMAc, DMSO), что выгодно отличает его от химически усиленных негативных электронных резистов, например Shipley SAL-601 [7]. Негативность маски для травления из PES позволяет на порядок уменьшить время засветки, а следовательно и всего процесса изготовления образцов. Кроме того, исключается возможность термодрейфа столика электронного микроскопа, что, в свою очередь повышает выход годных образцов.
Также, нерастворимость PES в растворителях ПММА – хлорбензоле и метилизобутилкетоне, позволяет использовать его для защиты сенсора при последующих литографических операциях.
При жидкостном травлении края титановых структур получились изрезанными и неровными из-за разной скорости травления вдоль границ зерен поликристаллической пленки. Тем не менее, результаты измерений Tc показали, что качество тонкопленочных титановых структур, полученных таким способом, превосходит качество структур, полученных методом взрывной литографии.
Ионное травление позволяет получить аналогичные структуры без искажений геометрии структур (рисунок 2). На рисунке 3, полученном при анализе поверхности на профилометре, можно увидеть, что поверхность пленки, находившаяся под резистом, значительно более гладкая, чем поверхность, подвергнутая ионному травлению. Ширина края значительно меньше, чем у образцов, изготовленных с помощью жидкостного травления, края ровные.

Рисунок 3. Изображение профиля ступеньки, полученной путем ионного травления пленки из титана через маску из PES, на профилометре KLA Tencor AlfaStep IQ.
Кроме того, резист из полиэфирсульфона не изменился под воздействием ионного травления, и его растворение было произведено в стандартном режиме в подогретом ацетоне. Это говорит о стойкости пленки из PES к ионному травлению.
Проведенные низкотемпературные измерения характеристик образцов показали, что критическая температура сверхпроводникового перехода для данных образцов составила Tc ~ 0,34 К, а ширина области парапроводимости составила ∆T ~ 20 мК.
Заключение
Для получения образцов сверхпроводниковых микроструктур из титана применены резистные маски из негативного электронного резиста полиэфирсульфона. Это позволило значительно сократить время экспозиции образцов, избежать загрязнения образцов примесями, появляющимися в стандартных процессах с применением резиста ПММА, избежать искажений геометрии при облучении электронами. Образцы, изготовленные с применением PES, обладают лучшими свойствами, нежели образцы, полученные с применением ПММА.
1. Dubos P., Charlat P., Crozes Th., Paniez P. and Pannetier B. A thermostable trilayer resist for niobium lift-off. //J. Vac. Sci. Technol. 2000 B 18, 122.
2. Выставкин А.Н., Коваленко А. Г., Кон И. А. К оценке чувствительности болометров, работающих на краю сверхпроводникового перехода // Радиотехника и электроника. ¬– 2007. – т. 52, № 4 – С. 224-228.
3. Rai-Choudhury P. Handbook of Microlithography, Micromachining, and Microfabrication.// SPIE, Bellingham, WA, 1997,Vol. 1, p. 139.
4. Gokan H., Esho S., Ohnishi Y. Dry Etch Resistance of Organic Materials // J. Electrochem. Soc., Solid-State Sci. Technology, 1983. V. 130. P. 143.
5. Lee J.-H., Ahn K.-D., Cho I. Novel multi-alicyclic polymers for enhancing plasma etch resistance in 193 nm lithography // Polymer. 2001. V. 42. № 4. P. 1757.
6. Ильин А.С., Кузьмин А.А., Коваленко А.Г. Использование полиэфирсульфона (PES) для электронно-лучевой литографии // Журнал радиоэлектроники: электронный журнал. 2011. №8. URL: http://jre.cplire.ru/jre/aug11/8/text.html
7. James W. Conway E-beam Lithography Resist Processing // http://snf.stanford.edu/Process/Lithography/ebeamres.html